
Trong việc đánh giá các quy trình in thạch bản wafer, độ dốc log hình ảnh chuẩn hóa (NILS) đưa ra % thay đổi về chiều rộng đối với % thay đổi nhất định về liều lượng [1,2]. Giá trị NILS danh nghĩa là 2 cho thấy sự thay đổi 10% về độ rộng đường truyền khi thay đổi 10% về liều lượng; % thay đổi về độ rộng đường truyền tỷ lệ nghịch với NILS. Trong bài viết trước [2], người ta đã chỉ ra rằng NILS phù hợp hơn với đặc điểm tối trên nền sáng so với cách khác. Mặt nạ dịch pha suy yếu (attPSM) giúp cải thiện NILS để đạt giá trị từ 2 trở lên, trong trường hợp mặt nạ nhị phân thông thường không thể không có liều lượng quá cao.
Việc tăng khả năng truyền của mặt nạ dịch pha suy giảm [3] sẽ cải thiện hơn nữa. Đường truyền cao hơn có hiệu quả làm cho các vùng tối tối hơn, làm tăng độ dốc log của hình ảnh.
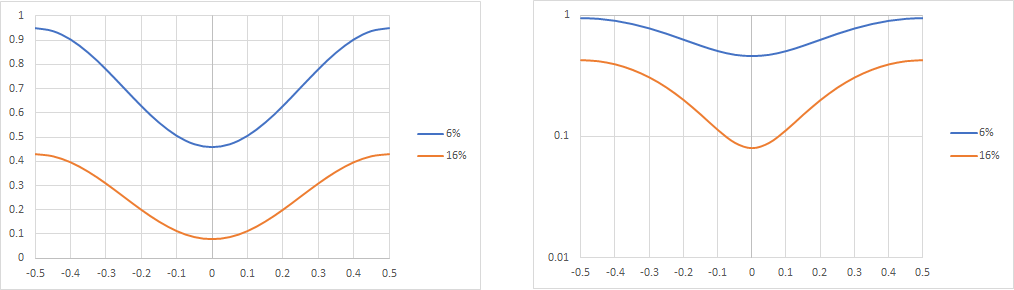
Hình 1. NILS được cải thiện để truyền mặt nạ dịch pha suy giảm cao hơn. Các hình ảnh được chụp dọc theo trục dài của mẫu hình chữ nhật dày đặc (1.3: 1) với ánh sáng lưỡng cực chéo. Biểu đồ bên phải sử dụng thang đo log thay vì thang đo tuyến tính cho trục y, biểu thị cường độ. Mức giảm rõ ràng hơn cho thấy NILS tốt hơn để truyền cao hơn (16% so với 6%).
Bên cạnh việc cải thiện NILS, độ nhạy lỗi mặt nạ và độ sâu tiêu cự cũng được cải thiện [3]. Việc cải thiện NILS đặc biệt quan trọng để cải thiện độ phân giải của hình dạng 2D như trong Hình 1 hoặc trong tiêu đề phía trên bài viết này. Đối với attPSM 12% của Ref. 3, đặc trưng hình vuông có chiều rộng 65% cường độ với độ chiếu sáng lưỡng cực chéo (đối với độ phân giải 2D chặt chẽ nhất: chiếu sáng lưỡng cực ở X + chiếu sáng lưỡng cực ở Y) chỉ cần đạt được NILS là 2.0 ở cả x và y. Đây là một cơ hội khác để cải thiện độ phân giải 2D cho DUV, đặc biệt là đối với việc tạo khuôn lõi cho kiểu tạo khuôn kép tự liên kết (SADP) [4].
dự án
[1] C. A. Mack, “Sử dụng độ dốc log hình ảnh được chuẩn hóa,” Chuyên gia in thạch bản, Thế giới vi thạch, Mùa đông 2001: http://lithoguru.com/scientist/litho_tutor/TUTOR32%20(Winter%2002).pdf
[2] F. Chen, “Mặt nạ chuyển pha để cải thiện NILS – Điểm chấp cho EUV?”, https://www.linkedin.com/pulse/phase-shifting-masks-nils-improvement-handicap-euv-frederick -chen
[3] T. Faure và cộng sự, “Phát triển công nghệ mặt nạ dịch pha truyền cao mới cho nút logic 10 nm,” Proc. SPIE 9984, 998402 (2016).
[4] H. Yaegashi và cộng sự, “Tổng quan: sự phát triển liên tục trong quy trình tạo mẫu kép,” Proc. SPIE 8325, 83250B (2012).
Cũng đọc:
Đánh giá sản lượng wafer EUV: 2019-2022
Kỹ thuật in thạch bản dành riêng cho ứng dụng: Định tuyến hai chiều bước sóng 28 nm
Chia sẻ bài đăng này qua:
- Phân phối nội dung và PR được hỗ trợ bởi SEO. Được khuếch đại ngay hôm nay.
- PlatoData.Network Vertical Generative Ai. Trao quyền cho chính mình. Truy cập Tại đây.
- PlatoAiStream. Thông minh Web3. Kiến thức khuếch đại. Truy cập Tại đây.
- Trung tâmESG. Ô tô / Xe điện, Than đá, công nghệ sạch, Năng lượng, Môi trường Hệ mặt trời, Quản lý chất thải. Truy cập Tại đây.
- BlockOffsets. Hiện đại hóa quyền sở hữu bù đắp môi trường. Truy cập Tại đây.
- nguồn: https://semiwiki.com/lithography/331512-nils-enhancement-with-higher-transmission-phase-shift-masks/
- :là
- :Ở đâu
- 1
- 1.3
- 10
- 2001
- 2012
- 2016
- 28
- 2D
- a
- ở trên
- chống lại
- AL
- dọc theo
- Ngoài ra
- an
- và
- Một
- LÀ
- khu vực
- xung quanh
- bài viết
- AS
- thẩm định, lượng định, đánh giá
- Trục
- lý lịch
- Hơn
- cả hai
- Tươi
- trường hợp
- thay đổi
- chen
- liên tục
- thông thường
- Trung tâm
- tối
- tối hơn
- ngu si
- chiều sâu
- Nhúng
- liều
- tăng gấp đôi
- E&T
- hiệu quả
- tăng cường
- lôi
- đặc biệt
- sự tiến hóa
- chuyên gia
- Đặc tính
- Hình
- Tập trung
- Trong
- xa hơn
- được
- cho
- đồ thị
- giúp đỡ
- Cao
- cao hơn
- Đánh
- http
- HTTPS
- hình ảnh
- hình ảnh
- quan trọng
- nâng cao
- cải thiện
- cải thiện
- cải thiện
- in
- Tăng
- chỉ
- thay vì
- IT
- chỉ
- đăng nhập
- logic
- dài
- LÀM CHO
- quản lý
- mặt nạ
- Mặt nạ
- max-width
- chi tiết
- Mới
- nút
- Rõ ràng
- of
- on
- Cơ hội
- or
- Nền tảng khác
- đầu ra
- đặc biệt
- Họa tiết
- giai đoạn
- Pitch
- plato
- Thông tin dữ liệu Plato
- PlatoDữ liệu
- Bài đăng
- trước
- mồi
- QUY TRÌNH
- quá trình
- Quy trình
- đạt
- Đọc
- đại diện
- Độ phân giải
- ngay
- Quy mô
- Độ nhạy
- hình dạng
- thay đổi
- thể hiện
- vuông
- như vậy
- T
- Lấy
- mất
- Công nghệ
- hơn
- việc này
- Sản phẩm
- Đồ thị
- điều này
- đến
- sử dụng
- giá trị
- Các giá trị
- thông qua
- vs
- là
- Đường..
- cái nào
- Mùa đông
- với
- không có
- thế giới
- X
- zephyrnet