
При оценке процессов литографии пластин нормализованный логарифмический наклон изображения (NILS) дает процентное изменение ширины для данного процентного изменения дозы [1,2]. Номинальное значение NILS, равное 2, указывает на 10%-ное изменение ширины линии при 10%-м изменении дозы; % изменения ширины линии обратно пропорционален NILS. В предыдущей статье [2] было показано, что NILS лучше подходит для темных объектов на ярком фоне, чем наоборот. Маски с ослабленным фазовым сдвигом (attPSM) помогают улучшить NILS до значений 2 или более в тех случаях, когда обычные бинарные маски не могут этого сделать без непомерно высокой дозы.
Увеличение передачи ослабленной маски фазового сдвига [3] способствует дальнейшему улучшению. Более высокое пропускание эффективно делает темные области темнее, что увеличивает логарифмический наклон изображения.
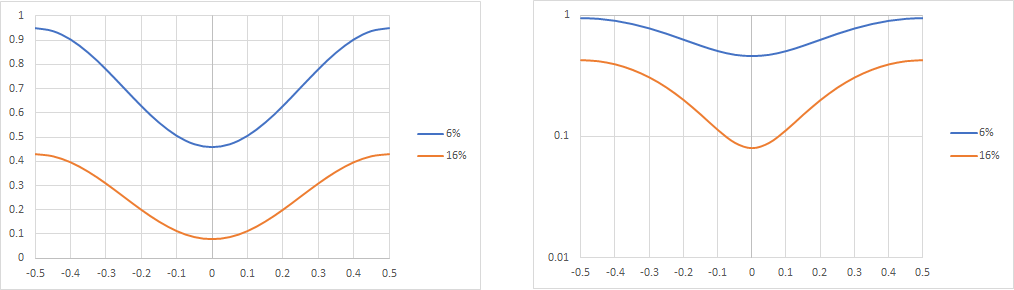
Рисунок 1. NILS улучшен для более высокой передачи ослабленной маски фазового сдвига. Изображения сделаны вдоль длинной оси плотной продолговатой (1.3:1) диаграммы с перекрестным дипольным освещением. На графике справа используется логарифмическая шкала вместо линейной шкалы для оси Y, представляющей интенсивность. Более очевидное падение указывает на лучший показатель NILS для более высокой передачи (16% против 6%).
Помимо улучшения NILS, также улучшаются чувствительность к ошибкам маски и глубина фокуса [3]. Улучшение NILS особенно важно для улучшения разрешения 2D-фигур, таких как рисунок 1 или заголовок над этой статьей. Для 12% attPSM Ref. 3, квадратный элемент с шириной 65% шага и кросс-дипольным освещением (для самого высокого 2D-разрешения: дипольное освещение по X + дипольное освещение по Y) едва достигает NILS 2.0 как по x, так и по y. Это еще одна возможность улучшить 2D-разрешение для DUV, особенно для формирования сердцевины для самовыравнивающегося двойного рисунка (SADP) [4].
Рекомендации
[1] К.А. Мак, «Использование нормализованного логарифмического наклона изображения», Эксперт по литографии, Мир микролитографии, зима 2001 г.: http://lithoguru.com/scientist/litho_tutor/TUTOR32%20(Winter%2002).pdf
[2] Ф. Чен, «Маски фазового сдвига для улучшения NILS – препятствие для EUV?», https://www.linkedin.com/pulse/phase-shifting-masks-nils-improvement-handicap-euv-frederick -чен
[3] Т. Фор и др., «Разработка новой технологии маски фазового сдвига с высокой пропускной способностью для логического узла 10 нм», Proc. ШПИЕ 9984, 998402 (2016).
[4] Х. Яегаси и др., «Обзор: непрерывная эволюция процесса двойного шаблонирования», Proc. ШПИЕ 8325, 83250Б (2012 г.).
Читайте также:
Оценка производства пластин EUV: 2019–2022 гг.
Литография для конкретного применения: двумерная трассировка с шагом 28 нм
Поделитесь этим постом через:
- SEO-контент и PR-распределение. Получите усиление сегодня.
- PlatoData.Network Вертикальный генеративный ИИ. Расширьте возможности себя. Доступ здесь.
- ПлатонАйСтрим. Интеллект Web3. Расширение знаний. Доступ здесь.
- ПлатонЭСГ. Автомобили / электромобили, Углерод, чистые технологии, Энергия, Окружающая среда, Солнечная, Управление отходами. Доступ здесь.
- Смещения блоков. Модернизация права собственности на экологические компенсации. Доступ здесь.
- Источник: https://semiwiki.com/lithography/331512-nils-enhancement-with-higher-transmission-phase-shift-masks/
- :является
- :куда
- 1
- 1.3
- 10
- 2001
- 2012
- 2016
- 28
- 2D
- a
- выше
- против
- AL
- вдоль
- причислены
- an
- и
- Другой
- МЫ
- области
- около
- гайд
- AS
- оценки;
- Ось
- фон
- Лучшая
- изоферменты печени
- Яркие
- случаев
- изменение
- чен
- (CIJ)
- обычный
- Основные
- темно
- темнее
- плотный
- глубина
- Опустите
- дозировать
- двойной
- Е & Т
- фактически
- усиление
- ошибка
- особенно
- эволюция
- эксперту
- Особенность
- фигура
- Фокус
- Что касается
- далее
- данный
- дает
- график
- помощь
- High
- высший
- Удар
- HTTP
- HTTPS
- изображение
- изображений
- важную
- улучшать
- улучшенный
- улучшение
- улучшение
- in
- Увеличивает
- указывает
- вместо
- IT
- всего
- журнал
- логика
- Длинное
- ДЕЛАЕТ
- управляет
- маска
- Маски
- макс-ширина
- БОЛЕЕ
- Новые
- узел
- Очевидный
- of
- on
- Возможность
- or
- Другое
- выходной
- особенно
- шаблон
- фаза
- Pitch
- Платон
- Платон Интеллектуальные данные
- ПлатонДанные
- После
- предыдущий
- грунтовка
- PROC
- процесс
- Процессы
- достигать
- Читать
- представляющий
- Постановления
- правую
- Шкала
- чувствительность
- формы
- сдвиг
- показанный
- площадь
- такие
- T
- приняты
- принимает
- Технологии
- чем
- который
- Ассоциация
- График
- этой
- в
- использования
- ценностное
- Наши ценности
- с помощью
- vs
- законопроект
- Путь..
- который
- Зима
- без
- Мир
- X
- зефирнет