
웨이퍼 리소그래피 공정 평가에서 정규화된 이미지 로그 기울기(NILS)는 주어진 선량 변화(%)에 대한 폭 변화(%)를 제공합니다[1,2]. 2의 명목 NILS 값은 10% 선량 변화에 대한 선폭의 10% 변화를 나타냅니다. 선폭의 % 변화는 NILS에 반비례합니다. 이전 기사 [2]에서는 NILS가 그 반대의 경우보다 밝은 배경에 어두운 기능을 적용하는 데 더 나은 것으로 나타났습니다. 감쇠 위상 편이 마스크(attPSM)는 기존 바이너리 마스크가 엄청나게 높은 선량 없이는 불가능한 경우 NILS를 2 이상의 값에 도달하도록 개선하는 데 도움이 됩니다.
감쇠된 위상 시프트 마스크[3]의 투과율을 높이면 성능이 더욱 향상됩니다. 투과율이 높을수록 어두운 영역이 더 어두워지고 이미지 로그 기울기가 증가합니다.
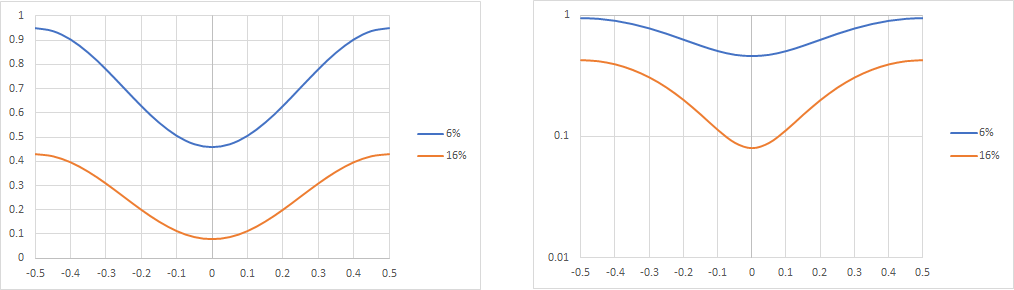
그림 1. NILS는 감쇠된 위상 편이 마스크의 더 높은 투과율을 위해 개선되었습니다. 이미지는 교차 쌍극자 조명을 사용하여 조밀한 직사각형(1.3:1) 패턴의 장축을 따라 촬영됩니다. 오른쪽 그래프는 강도를 나타내는 y축에 선형 스케일 대신 로그 스케일을 사용합니다. 더 뚜렷한 하락은 더 높은 투과율에 대해 더 나은 NILS를 나타냅니다(16% 대 6%).
NILS를 개선하는 것 외에도 마스크 오류 감도와 초점 심도도 개선되었습니다[3]. NILS를 개선하는 것은 그림 2이나 이 기사 위의 헤더와 같은 1D 모양의 해상도를 개선하는 데 특히 중요합니다. Ref.의 12% attPSM의 경우. 3에서, 교차 쌍극자 조명(가장 엄격한 65D 해상도의 경우: X의 쌍극자 조명 + Y의 쌍극자 조명)을 사용하여 피치의 2% 너비의 정사각형 형상은 x와 y 모두에서 NILS 2.0에 도달했습니다. 이는 특히 SADP(Self-Aligned Double Patterning)를 위한 코어 패터닝의 경우 DUV의 2D 해상도를 향상시킬 수 있는 또 다른 기회입니다[4].
참고자료
[1] C. A. Mack, "정규화된 이미지 로그 기울기 사용", 리소그래피 전문가, Microlithography World, 2001년 겨울: http://lithoguru.com/scientist/litho_tutor/TUTOR32%20(Winter%2002).pdf
[2] F. Chen, "NILS 개선을 위한 위상 변이 마스크 - EUV의 핸디캡?", https://www.linkedin.com/pulse/phase-shifting-masks-nils-improvement-handicap-euv-frederick -첸
[3] T. Faure 등, "10nm 로직 노드를 위한 새로운 고투과 위상 시프트 마스크 기술 개발", Proc. SPIE 9984, 998402(2016).
[4] H. Yaegashi 외, "개요: 이중 패터닝 프로세스의 지속적인 발전", Proc. SPIE 8325, 83250B(2012).
또한 읽기 :
애플리케이션별 리소그래피: 28nm 피치 XNUMX차원 라우팅
다음을 통해이 게시물 공유 :
- SEO 기반 콘텐츠 및 PR 배포. 오늘 증폭하십시오.
- PlatoData.Network 수직 생성 Ai. 자신에게 권한을 부여하십시오. 여기에서 액세스하십시오.
- PlatoAiStream. 웹3 인텔리전스. 지식 증폭. 여기에서 액세스하십시오.
- 플라톤ESG. 자동차 / EV, 탄소, 클린테크, 에너지, 환경, 태양광, 폐기물 관리. 여기에서 액세스하십시오.
- BlockOffsets. 환경 오프셋 소유권 현대화. 여기에서 액세스하십시오.
- 출처: https://semiwiki.com/lithography/331512-nils-enhancement-with-higher-transmission-phase-shift-masks/
- :이다
- :어디
- 1
- 1.3
- 10
- 2001
- 2012
- 2016
- 28
- 2D
- a
- 위의
- 반대
- AL
- 따라
- 또한
- an
- 및
- 다른
- 있군요
- 지역
- 약
- 기사
- AS
- 평가
- 축
- 배경
- 더 나은
- 두
- 빛나는
- 가지 경우
- 이전 단계로 돌아가기
- 첸
- 끊임없는
- 전통적인
- 핵심
- 어두운
- 더 어두운
- 밀집한
- 깊이
- 찍어
- 선량
- 더블
- E & T
- 효과적으로
- 상승
- 오류
- 특히
- 진화
- 전문가
- 특색
- 그림
- 초점
- 럭셔리
- 추가
- 주어진
- 제공
- 그래프
- 도움
- 높은
- 더 높은
- 히트
- HTTP
- HTTPS
- 영상
- 형상
- 중대한
- 개선
- 개선하는
- 개량
- 개선
- in
- 증가
- 표시
- 를 받아야 하는 미국 여행자
- IT
- 다만
- 링크드인
- 기록
- 논리
- 긴
- 제작
- 관리하다
- 마스크
- 마스크
- 최대 폭
- 배우기
- 신제품
- 노드
- 분명한
- of
- on
- 기회
- or
- 기타
- 출력
- 특별히
- 무늬
- 상
- 피치
- 플라톤
- 플라톤 데이터 인텔리전스
- 플라토데이터
- 게시하다
- 너무 이른
- 뇌관
- PROC
- 방법
- 프로세스
- 도달
- 읽기
- 대표
- 분해능
- 연락해주세요
- 규모
- 감도
- 모양
- 변화
- 표시
- 광장
- 이러한
- T
- 촬영
- 소요
- Technology
- 보다
- 그
- XNUMXD덴탈의
- 그래프
- 이
- 에
- 사용
- 가치
- 마케팅은:
- 를 통해
- vs
- 였다
- 방법..
- 어느
- 겨울
- 과
- 없이
- 세계
- X
- 제퍼 넷








