Realizarea recentă de către China a unui nod de turnătorie de clasă 7 nm folosind doar litografie DUV [1] ridică întrebarea cât de mult poate fi extinsă litografia DUV prin multipatterning. O publicație recentă la CSTIC 2023 indică faptul că grupurile chineze se uită în prezent la extinderea multipatterning-ului bazat pe DUV la 5 nm, mergând până acolo încât să ia în considerare utilizarea a 6 măști pentru un strat [2]. Compararea abordărilor bazate pe DUV și EUV care merg către 3nm duce la o concluzie interesantă.
Modelarea LELE
Cea mai de bază formă de multipatterning este așa-numita abordare „Litho-Etch-Litho-Etch” (LELE), care în esență face litografia de bază urmată de gravare de două ori. Acest lucru permite o înjumătățire a pasului, deoarece o a doua caracteristică este inserată între două prime caracteristici imprimate. Prin extensie, pot urma LE3 (3xLE) și LE4 (4xLE). Cu toate acestea, utilizarea acestor abordări pentru a ajunge la mai puțin de jumătate din pasul inițial nu mai este favorizată, odată cu apariția modelului distanțier auto-aliniat.
Model de distanțiere auto-aliniat
Modelarea distanțierului auto-aliniată are avantajul față de LELE de a nu necesita un pas suplimentar de litografie, economisind astfel costul suplimentar. Depunerea distanțierului și gravarea ulterioară, urmată de umplerea golurilor și gravarea ulterioară, înlocuiește stratul, coace, expune, coace, dezvoltă secvența litografică. Deși mult mai ieftin, este încă necesar un control precis al procesului, cum ar fi grosimea distanțierului și selectivitatea ratei de gravare. O aplicație unică de distanțare duce la dublarea caracteristicilor într-un anumit pas. Prin urmare, aceasta este adesea denumită modelare dublă auto-aliniată (SADP). Reaplicarea conduce la modelarea cvadruple auto-aliniată (SAQP), așa cum este de așteptat.
Modelarea subtractivă
În timp ce LELE și SADP adaugă în mod natural caracteristici unui model, uneori este necesar să eliminați părți ale acelor caracteristici pentru aspectul final. Tăiați măștile indicate zonele în care segmentele de linie trebuie îndepărtate. Acestea sunt denumite și locații de bloc atunci când gravarea de formare a liniilor este blocată. Masca inversă se numește mască de păstrare. Restricționarea unei întreruperi de linie la o singură lățime de linie are probleme de plasare dacă linia adiacentă poate fi și gravată. Când liniile alternative pot fi aranjate pentru a fi realizate din diferite materiale care urmează să fie gravate, rupturile de linie pot fi făcute cu toleranțe mai bune (Figura 1).
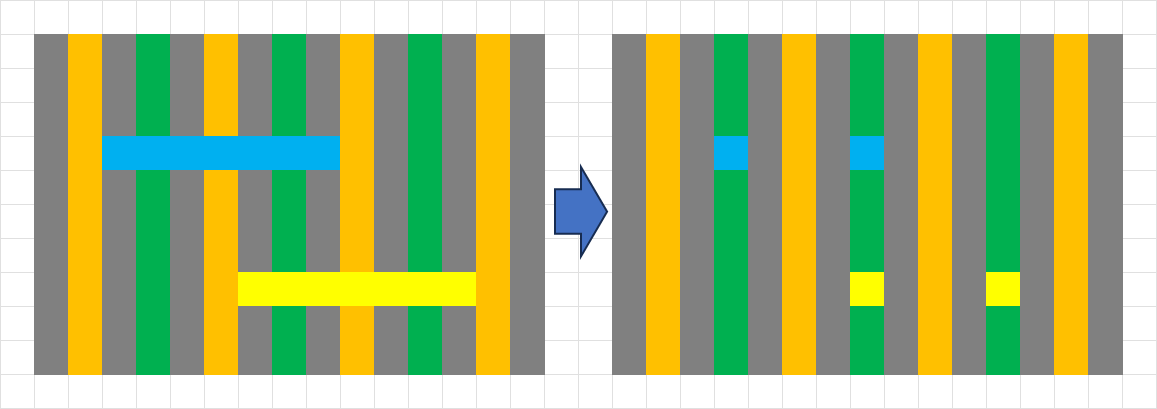
Figura 1. Blocul/tăierea auto-aliniată elimină numai secțiuni ale liniilor alternative.
Pentru o anumită linie de interconectare, distanța dintre rupturi este de așteptat să fie de cel puțin două pasi metalice. Astfel, sunt așteptate două măști pe linie atunci când pasul metalic este de la 1/4 la 1/2 din limita de rezoluție.

Figura 2. Sunt necesare două seturi de măști bloc/tăiate pentru cele două seturi de gravare.
Aranjament alternativ al liniilor
Aranjarea liniilor alternative este naturală prin LELE, SADP, SAQP sau un hibrid de LELE și SADP cunoscut sub numele de SALELE (self-aligned LELE) [3]. SALELE a fost deja considerată utilizarea implicită pentru EUV pentru cele mai strânse pasi metalice [2, 4].
Evaluarea costurilor DUV vs. EUV
Una dintre așteptările pentru multipatterning cu DUV a fost costul în creștere, comparativ cu EUV. Este timpul pentru o reevaluare actualizată. În primul rând, folosim cele mai recente (2021) estimări ale costurilor de modelare normalizate [5] (Figura 3).

Figura. 3 Costuri normalizate pentru modelare, din Referința 5.
În continuare, folosim stiluri reprezentative de modelare pentru DUV și EUV pentru diferitele noduri (Figura 4).

Figura 4. Costurile de modelare DUV vs. EUV vs. nod
Mai multe comentarii sunt în ordine:
- Pentru DUV de 7 nm, pasul de 40 nm este într-un punct în care singurele caracteristici care pot fi rezolvate sunt liniile, așa că aceste linii trebuie tăiate într-o expunere separată.
- Pentru 7nm EUV, este utilizată o tăietură separată a liniei, deoarece la pasul de 40 nm, rezoluția necesară (~20 nm) este mai mică decât funcția de împrăștiere a punctului a sistemului EUV (~25 nm). Un sistem High-NA EUV nu este, de asemenea, avantajos pentru acest pas, din cauza profunzimii de focalizare și a limitărilor de umplere a pupilei [6].
- Pentru DUV 3/5nm, LELE SADP este mai flexibil decât SAQP pentru pas sub-40 nm [7].
- Pentru 3/5nm EUV, forța motrice a utilizării LELE este comportamentul stocastic la <17 nm jumătate de pas și <20 nm lățime de linie izolată [8,9]. Pe măsură ce ne apropiem de dimensiunile de 10 nm, estomparea dependentă de doză de împrăștiere a electronilor [10-12] va deveni, de asemenea, prohibitivă. Rezoluția optică a sistemului, adică NA, nu mai este relevantă.
- Modelarea modelului nu este considerată o modalitate de a elimina tăieturile, deoarece ar face mult mai dificilă litografia de preformare (Figura 5). De asemenea, gravarea cu fascicul ionic în unghi a fost utilizată în general pentru a aplatiza topografia preexistentă, reducând înălțimea măștii de gravare [13].

Figura 5. Pentru modelarea modelului, modelul înainte de modelare este foarte neprietenitor.
În cea mai mare parte, putem considera direct că DUV LELE este mult mai ieftin decât EUV cu expunere unică (SE). De asemenea, DUV LE4 este mai ieftin decât modelul dublu EUV. Deși LELE necesită pași suplimentari față de SE, există și luarea în considerare a întreținerii sistemului EUV versus întreținerea sistemului DUV, precum și consumul de energie. DUV LELE utilizează jumătate din energie decât EUV SE, DUV SADP aproximativ 2/3 și chiar și DUV LE4 utilizează puțin sub 85% din energie pentru EUV SE [14].
Toate acestea servesc la evidențierea faptului că trecerea la noduri avansate necesită să se confrunte cu costuri în creștere, indiferent de alegerea DUV sau EUV.
Referinte
[1] https://www.techinsights.com/blog/techinsights-finds-smic-7nm-n2-huawei-mate-60-pro
[2] Q. Wu și colab., CSTIC 2023.
[3] Y. Drissi şi colab., Proc. SPIE 10962, 109620V (2019).
[4] R. Venkatesan şi colab., Proc. SPIE 12292, 1229202 (2022).
[5] S. Snyder și colab., 2021 EUVL Workshop, https://www.euvlitho.com/2021/P2.pdf
[6] F. Chen, When High NA is Not Better Than Low NA in EUV Lithography, 2023, https://www.youtube.com/watch?v=10K5i4QdLBU
[7] S. Sakhare et al., Proc. SPIE 9427, 94270O (2015).
[8] L. Meli și colab., J. Micro/Nanolith. MEMS MOEMS 18, 011006 (2019).
[9] D. De Simone și G. Vandenberghe, Proc. SPIE 10957, 109570Q (2019).
[10] A. Narasimhan şi colab., Proc. SPIE 9422, 942208 (2015).
[11] I. Bespalov și colab., ACS Appl. Mater. Interfețe 12, 9881 (2020).
[12] F. Chen, Modeling EUV Stochastic Defects With Secondary Electron Blur, https://www.linkedin.com/pulse/modeling-euv-stochastic-defects-secondary-electron-blur-chen
[13] M. Ulitschka și colab., J. Europ. Opta. Soc. – Rapid Pub. 17:1 (2021).
[14] LA. Ragnarsson şi colab., 2022 Electron Dev. Teh. Manuf., 82 (2022).
Acest articol a apărut pentru prima dată în LinkedIn Pulse: Extinderea multimodelului DUV spre 3nm
Citeste si:
Model stocastic pentru difuzia acidului în rezistențe amplificate chimic DUV
Avansarea proceselor semiconductoare cu materiale fotorezistente la UV extreme noi
Modelarea defectelor stocastice EUV cu estomparea electronilor secundare
Distribuie această postare prin:
- Distribuție de conținut bazat pe SEO și PR. Amplifică-te astăzi.
- PlatoData.Network Vertical Generative Ai. Împuterniciți-vă. Accesați Aici.
- PlatoAiStream. Web3 Intelligence. Cunoștințe amplificate. Accesați Aici.
- PlatoESG. carbon, CleanTech, Energie, Mediu inconjurator, Solar, Managementul deșeurilor. Accesați Aici.
- PlatoHealth. Biotehnologie și Inteligență pentru studii clinice. Accesați Aici.
- Sursa: https://semiwiki.com/lithography/336182-extension-of-duv-multipatterning-toward-3nm/
- :are
- :este
- :nu
- :Unde
- 1
- 10
- 11
- 12
- 13
- 14
- 17
- 20
- 2015
- 2019
- 2020
- 2021
- 2022
- 2023
- 40
- 7
- 8
- 9
- a
- Despre Noi
- realizare
- adăuga
- adiacent
- avansat
- Avantaj
- avantajos
- AL
- deja
- de asemenea
- Cu toate ca
- Amplificat
- an
- și
- a apărut
- aplicație
- abordare
- abordari
- SUNT
- domenii
- amenajat
- sosire
- articol
- AS
- At
- de bază
- BE
- Grindă
- deoarece
- deveni
- fost
- înainte
- Mai bine
- între
- Bloca
- blocat
- estompare
- atât
- Pauză
- pauze
- by
- denumit
- CAN
- mai ieftin
- chen
- chinez
- alegere
- comentarii
- compararea
- concluzie
- Lua în considerare
- considerare
- luate în considerare
- consum
- Control
- A costat
- Cheltuieli
- În prezent
- Tăiat
- reduceri
- Mod implicit
- adâncime
- dev
- dezvolta
- diferit
- dificil
- difuziune
- Dimensiuni
- direcționa
- distanţă
- face
- dubla
- dublare
- conducere
- e
- E&T
- elimina
- permite
- energie
- Consumul de energie
- În esență,
- estimări
- EUROPA
- Chiar
- aşteptări
- de aşteptat
- Expunere
- extensie
- suplimentar
- extremă
- cu care se confruntă
- departe
- Caracteristică
- DESCRIERE
- Figura
- umple
- final
- First
- flexibil
- Concentra
- urma
- a urmat
- Pentru
- Forţarea
- formă
- Turnătorie
- din
- funcţie
- în general
- obtinerea
- dat
- merge
- Grupului
- În creştere
- Jumătate
- dedublare
- Avea
- înălțime
- prin urmare
- Înalt
- Evidențiați
- Cum
- Totuși
- HTTPS
- Hibrid
- i
- if
- in
- indicată
- indică
- interesant
- interfeţe
- izolat
- probleme de
- IT
- doar
- A pastra
- cunoscut
- Ultimele
- strat
- Aspect
- Conduce
- cel mai puțin
- mai puțin
- LIMITĂ
- limitări
- Linie
- linii
- Locații
- mai lung
- cautati
- Jos
- făcut
- întreținere
- face
- masca
- Măști
- Materiale
- max-width
- Mai..
- metal
- model
- modelare
- mai mult
- cele mai multe
- în mişcare
- mult
- Natural
- necesar
- Nu.
- nod
- noduri
- roman
- of
- de multe ori
- ONE
- afară
- or
- comandă
- original
- peste
- parte
- piese
- Model
- pentru
- Smoală
- smoale
- plasare
- Plato
- Informații despre date Platon
- PlatoData
- Punct
- Post
- precis
- PROC
- proces
- procese
- Publicare
- puls
- întrebare
- R
- ridică
- rapid
- rată
- Citeste
- recent
- reducerea
- menționat
- Fără deosebire
- relativ
- scoate
- îndepărtat
- înlocui
- reprezentant
- necesar
- Necesită
- Rezoluţie
- hotărât
- restricționarea
- s
- economisire
- Al doilea
- secundar
- secțiuni
- segmente
- semiconductor
- distinct
- Secvenţă
- servește
- Seturi
- fasonarea
- întrucât
- singur
- So
- până acum
- uneori
- răspândire
- Pas
- paşi
- Încă
- stiluri
- ulterior
- astfel de
- sistem
- tech
- decât
- acea
- Acolo.
- astfel
- Acestea
- acest
- aceste
- Prin urmare
- timp
- la
- spre
- față de
- De două ori
- Două
- în
- actualizat
- utilizare
- utilizat
- utilizări
- folosind
- diverse
- foarte
- de
- vs
- Cale..
- we
- BINE
- cand
- care
- în timp ce
- voi
- cu
- în
- atelier
- ar
- wu
- youtube
- zephyrnet