
W ocenie procesów litografii waflowej znormalizowane nachylenie logarytmiczne obrazu (NILS) daje % zmianę szerokości dla danej % zmiany dawki [1,2]. Nominalna wartość NILS wynosząca 2 wskazuje 10% zmianę szerokości linii przy 10% zmianie dawki; % zmiana szerokości linii jest odwrotnie proporcjonalna do NILS. W poprzednim artykule [2] wykazano, że NILS jest lepszy w przypadku ciemnego obiektu na jasnym tle niż na odwrót. Atenuowane maski z przesunięciem fazowym (attPSM) pomagają poprawić NILS do wartości 2 lub więcej w przypadkach, gdy konwencjonalne maski binarne nie mogą obejść się bez wyjątkowo wysokiej dawki.
Zwiększenie transmisji tłumionej maski przesunięcia fazowego [3] oznacza dalszą poprawę. Wyższa transmisja skutecznie przyciemnia ciemne obszary, co zwiększa nachylenie logarytmiczne obrazu.
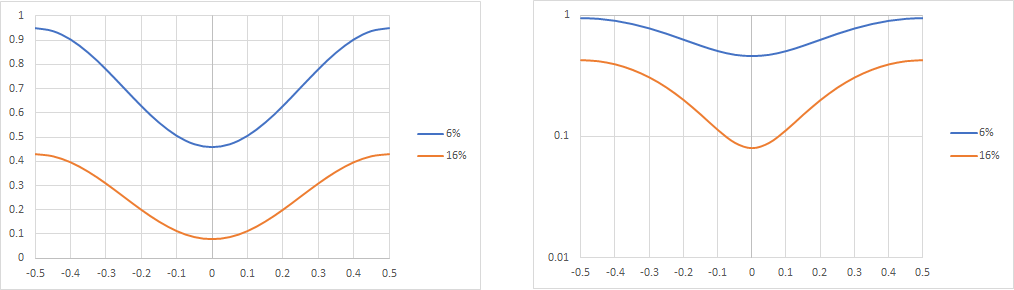
Rysunek 1. Ulepszono NILS w celu uzyskania wyższej transmisji tłumionej maski przesunięcia fazowego. Zdjęcia są robione wzdłuż długiej osi gęstego, podłużnego wzoru (1.3:1) z oświetleniem krzyżowo-dipolowym. Wykres po prawej stronie wykorzystuje skalę logarytmiczną zamiast skali liniowej dla osi Y, przedstawiającej intensywność. Bardziej oczywisty spadek wskazuje na lepszy NILS dla wyższej transmisji (16% vs 6%).
Oprócz poprawy NILS, poprawiono także czułość na błąd maski i głębię ostrości [3]. Poprawa NILS jest szczególnie ważna dla poprawy rozdzielczości kształtów 2D, jak na rysunku 1 lub w nagłówku powyżej tego artykułu. Dla 12% attPSM z ref. 3, kwadratowy element o szerokości 65% nachylenia z oświetleniem krzyżowo-dipolowym (dla najwęższej rozdzielczości 2D: oświetlenie dipolowe w X + oświetlenie dipolowe w Y) udaje się osiągnąć NILS wynoszący 2.0 zarówno w x, jak i y. Jest to kolejna szansa na poprawę rozdzielczości 2D dla DUV, szczególnie w przypadku tworzenia wzorów rdzenia w celu uzyskania samonastawnego podwójnego wzoru (SADP) [4].
Referencje
[1] CA Mack, „Using the Normalized Image Log-Slope”, The Lithography Expert, Microlithography World, zima 2001: http://lithoguru.com/scientist/litho_tutor/TUTOR32%20(Winter%2002).pdf
[2] F. Chen, „Maski przesunięcia fazowego dla poprawy NILS – handicap dla EUV?”, https://www.linkedin.com/pulse/phase-shifting-masks-nils-improvement-handicap-euv-frederick -chen
[3] T. Faure i in., „Rozwój nowej technologii maski przesunięcia fazowego o wysokiej transmisji dla węzła logicznego 10 nm”, Proc. SPIE 9984, 998402 (2016).
[4] H. Yaegashi i in., „Przegląd: ciągła ewolucja procesu podwójnego wzorca”, Proc. SPIE 8325, 83250B (2012).
Przeczytaj także:
Ocena produkcji płytek EUV: 2019–2022
Litografia specyficzna dla aplikacji: dwuwymiarowe trasowanie o skoku 28 nm
Udostępnij ten post przez:
- Dystrybucja treści i PR oparta na SEO. Uzyskaj wzmocnienie już dziś.
- PlatoData.Network Pionowe generatywne AI. Wzmocnij się. Dostęp tutaj.
- PlatoAiStream. Inteligencja Web3. Wiedza wzmocniona. Dostęp tutaj.
- PlatonESG. Motoryzacja / pojazdy elektryczne, Węgiel Czysta technologia, Energia, Środowisko, Słoneczny, Gospodarowanie odpadami. Dostęp tutaj.
- Przesunięcia bloków. Modernizacja własności offsetu środowiskowego. Dostęp tutaj.
- Źródło: https://semiwiki.com/lithography/331512-nils-enhancement-with-higher-transmission-phase-shift-masks/
- :Jest
- :Gdzie
- 1
- 1.3
- 10
- 2001
- 2012
- 2016
- 28
- 2D
- a
- powyżej
- przed
- AL
- wzdłuż
- również
- an
- i
- Inne
- SĄ
- obszary
- na około
- artykuł
- AS
- oszacowanie
- Oś
- tło
- Ulepsz Swój
- obie
- Jasny
- Etui
- zmiana
- chen
- ciągły
- Konwencjonalny
- rdzeń
- Ciemny
- ciemniejszy
- gęsty
- głębokość
- Zanurz
- Dawka
- Podwójna
- E i T
- faktycznie
- wzmocnienie
- błąd
- szczególnie
- ewolucja
- ekspert
- Cecha
- Postać
- Skupiać
- W razie zamówieenia projektu
- dalej
- dany
- daje
- wykres
- pomoc
- Wysoki
- wyższy
- Dobranie (Hit)
- http
- HTTPS
- obraz
- zdjęcia
- ważny
- podnieść
- ulepszony
- poprawa
- poprawy
- in
- Zwiększenia
- wskazuje
- zamiast
- IT
- właśnie
- log
- logika
- długo
- WYKONUJE
- zarządza
- maska
- Maski
- Maksymalna szerokość
- jeszcze
- Nowości
- węzeł
- oczywista
- of
- on
- Okazja
- or
- Inne
- wydajność
- szczególnie
- Wzór
- faza
- Smoła
- plato
- Analiza danych Platona
- PlatoDane
- Post
- poprzedni
- elementarz
- PROC
- wygląda tak
- procesów
- dosięgnąć
- Czytaj
- reprezentowanie
- Rozkład
- prawo
- Skala
- Wrażliwość
- kształty
- przesunięcie
- pokazane
- Kwadratowa
- taki
- T
- Zadania
- trwa
- Technologia
- niż
- że
- Połączenia
- Wykres
- to
- do
- zastosowania
- wartość
- Wartości
- przez
- vs
- była
- Droga..
- który
- w Zimie
- w
- bez
- świat
- X
- zefirnet