Termisk stress er et velkjent problem i avansert emballasje, sammen med utfordringene med mekanisk stress. Begge forverres av heterogen integrasjon, som ofte krever blandingsmaterialer med inkompatible termisk ekspansjonskoeffisienter (CTE).
Effekter dukker allerede opp og vil sannsynligvis bare bli verre ettersom pakketetthetene øker over 1,000 støt per brikke.
«Du kombinerer metaller som har en relativt høy CTE, så har du polymerer som har enda større CTE-stivhet, og så har du dielektrikum som har ekstremt lav CTE. Når du har satt alt sammen, er stress uunngåelig," sa Mario Gonzalez, vitenskapelig direktør og FoU-sjef for mekanisk og termisk modellering og karakterisering ved imec.
Slik belastning resulterer ofte i betydelig skjevhet eller tilt, som igjen fører til forhold som reduserer påliteligheten. "Du har å gjøre med forskjellige substratteknologier med flere lag," sa Chip Greely, visepresident for ingeniør ved Promex Industries. "Spesielt forskjellige kjernetykkelser i underlag begynner å skape mange klassiske mekaniske problemer, inkludert forvrengning, som har blitt et smertepunkt for noen av de større aktørene. Vi ber mange av kundene våre som har en system-i-pakke, heterogen integrert multi-chip-modul, om å gi skyggemoiré-dataene til underlagene deres, slik at vi kan se hvordan forvrengningen endres over reflow-temperaturen og ideelt sett finne dens refleksjonspunkt."
Denne stammen har ulike negative effekter, opplevd over mange dimensjonale skalaer, ifølge Gilad Barak, visepresident for avanserte nye teknologier ved Nova. "Ofte er bøying og vridning av funksjoner på nanostrukturnivå et resultat av den innebygde spenningen som er skapt, som finnes i noen DRAM- og front-end logiske nanoark," sa han. "Et annet eksempel er knyttet til områder i mikronskala der indusert belastning forhindrer fabrikasjon av avanserte halvlederstrukturer, som er typisk i 'holde-ute-soner' rundt gjennomgående silisium-vias (TSV). Til slutt kan storskalavirkningene av indusert belastning forårsake wafer-buing, noe som kompliserer waferhåndtering og fabrikasjon betydelig, noe som risikerer å sprekke selve waferen. Wafer-buing er spesielt sett under avsetning av tykke dielektriske lag, som er vanlig under fabrikasjon av 3D NAND-enheter."
Den gode nyheten er at industrien er veldig klar over disse og tilhørende problemer. Den dårlige nyheten er at det fortsatt mangler løsninger, selv om det er mange tilnærminger som for tiden utforskes.
"Det finnes ulike metoder for å redusere forvrengning, men ingen av dem er helt vellykket, og de kommer alltid med avveininger," sa Frank Chen, direktør for applikasjoner og produktadministrasjon hos Bruker Nano Surfaces & Metrology. "Problemene er ikke isolert til et snevert utvalg av applikasjoner. Hver gang du fester en dyse til et annet underlag, vil du få disse problemene.»
Alt dette betyr at inspeksjon og metrologi fortsatt må spille kritiske roller. Andre problemer, for eksempel hot spots, kan også forverres når flere brikker kombineres i heterogene pakker.
"Under testen vil forskjellige sjetonger varmes opp til forskjellige tider og forskjellige temperaturer, og skape mulige hot spots som må avkjøles ordentlig, sa Andrei Berar, seniordirektør for Test Business Development ved Amkor. "I tillegg til å lage spesifikke termisk aktive kontrollere - som matcher området til forskjellige brikker - er det betydelig innsats for å utvikle adaptive termiske kontrollere som kan "forutse" hot spots basert på vektorene levert av testprogrammet."
Slike kombinasjoner fører også til økende bruk av hybrid metrologi – ved å kombinere ulike teknikker for å komme raskt til roten av problemene.
Design, inspeksjon, testløsninger
Faktisk har det klassiske samspillet mellom design, inspeksjon og termomekanisk stress bare blitt mer komplekst med tusenvis av stadig mindre og mer skjøre forbindelser.
Ett resultat er en fornyet vekt på å skifte til venstre, for å forhåpentligvis "designe ut" CTE-problemene og påfølgende kaskadeeffekter som kan føre til overoppheting og mekanisk stress. Og for å øke sjansene for å forebygge, i tillegg til å finne kritiske defekter, er både simulering og inspeksjon nødvendig, ifølge Andras Vass-Varnai, leder for porteføljeutvikling i Electronics and Semiconductor Industry-segmentet. Siemens Digital Industries programvare.
"Termisk og strukturell ko-simulering ved bruk av beregningsbasert flytdynamikk (CFD), finite element-modellering (FEA), etc., i det tidlige designstadiet av pakken hjelper både med å forstå den forventede ytelsen til sammenstillingen og gir også et godt grunnlag for ' AI-drevet optimalisering ettersom mange av designvalgene kan parameteriseres,” forklarte Vass-Varnai. "Når den første prototypen er bygget, kan termisk transienttesting hjelpe til med å kartlegge den termiske ytelsen til komponenten. Hvis det er et misforhold mellom den forventede og den reelle termiske oppførselen, kan testdataene brukes til å ‘kalibrere’ materialegenskapene til pakkens digitale tvilling og oppdatere materialbibliotekene for høyere initial nøyaktighet av kommende design.»
Å finne den beste måten å teste bump-arrayer på, og å designe for test, er en økende utfordring. "Hva om det er et signal som går opp og ned?" spurte Rob Aitken, en Synopsys kar. "Det skaper et testproblem, for nå har du et signal som går til ingensteds og et annet signal som kommer fra ingensteds, og du må finne ut hvordan du skal teste disse tingene. Undersøker du dem? Men i så fall er det fysiske dimensjoner du må vedlikeholde, og da risikerer du mekanisk skade. Eller finner du en slags JTAG-lignende struktur? Men det reduserer da effektiviteten til disse koblingspunktene. Vi er i den enorme eksperimenteringsfasen der alle sier: «Kanskje dette vil fungere, kanskje det vil fungere.» Akkurat nå vil jeg ikke nødvendigvis satse på hva «det» er.»
Det er både indirekte og direkte testalternativer for defektundersøkelser, ifølge JCET. For eksempel er CSAM (Computed Scanning Acoustic Tomography) og 3D-røntgen indirekte, mens mekanisk tverrsnittsanalyse er et verktøy for direkte bevis. JCET har avansert utstyr for termisk karakterisering for å karakterisere material-/strukturproblemene som følge av mekaniske defekter.
Optisk inspeksjon er, som alltid, den raskeste tilnærmingen for inline-inspeksjon, men beste praksis er en hybrid tilnærming. "Den beste metoden for å oppdage kortslutninger/åpninger og marginale defekter ville være SPI (loddepasta-inspeksjon) til pre-reflow AOI (automatisert optisk inspeksjon) til post-reflow AOI til inline røntgen," rådet Timothy Skunes, visepresident for forskning og utvikling i Nordson Test & Inspection's CyberOptikk portefølje.
I tillegg kan andre modaliteter være nyttige, spesielt ved avanserte noder. For eksempel er en nylig tilnærming for å karakterisere belastning i halvlederenheter Raman Spectroscopy (RS). "RS er svært anvendelig for målinger på strukturen, og tilbyr raske målinger i størrelsesorden sekunder, og små punktstørrelser på få mikron for å tillate detaljerte målinger," sa Novas Barak. "Vanskeligheten med å måle belastningen på strukturer direkte før introduksjonen av Raman-spektroskopi som in-line metrologiverktøy i fabrikken førte til testing på mye senere stadier i fabrikasjonsprosessen."
Til syvende og sist, for grundig inspeksjon, er det ingen kutte hjørner. Budsjettberegninger kan kreve komparative beregninger, for eksempel startkostnaden for et nytt instrument kontra den løpende kostnaden for overdreven RMA. Og det er en ting til å vurdere - hvordan sikre at du kan stole på dataene dine.
«Skal du kaste det som sannsynligvis var bra materiale for å sikre at du ikke har noe problemmateriale i det du gir videre til sluttbrukeren? Hvem skal bære kostnadene for det?» advarte Mike McIntyre, direktør for programvareproduktadministrasjon ved På innovasjon, som anbefaler en statistisk database for nøyaktig komparativ vurdering når du utfører automatisert defektklassifisering.
Warpage
Et av de verste resultatene av stress er forvrengning. Det kan være overraskende at forvrengning kan være vanskelig å oppdage, men effekten er ikke alltid så åpenbar som den ser ut til. Forvrengning forårsaker små forskjeller i koplanaritet mellom brikke og underlag, noe som fører til at noen mikrobuler ikke kobles tilstrekkelig sammen med putene under, en feil som kalles ikke-våt.
"Vurder en avansert prosessor som er 50 til 60 mm, som et eksempel," sa Chen. "På grunn av den store størrelsen er den utfordrende å behandle uten noen form for forvrengning. Likevel, hvis dyse-festeverktøyet er innstilt i midten av prosessvinduet, kan det bestå inspeksjon og produseres med høy ytelse. Problemet er at toleransen kan være veldig smal. Så snart du har litt terningstilt på toppen av warpage, har du problemer som ikke er våte."
Enda verre, hvis dette skjer ved ujevnheter i området 50 µm (̴35 µm ujevn størrelse), kan du forestille deg problemene ettersom buddimensjonene krymper ytterligere. Det er allerede en bekymring for bilindustrien, ettersom den beveger seg mot sin neste generasjon i 2023 til 2024. Den kritiske overgangen vil være rundt 28nm-noden, sa Chen.


Fig. 1 Verktøy for festing av matriser har et veldig smalt prosessvindu for tilt når det er skjevhet. Kilde: Bruker
Ikke-våte
"Ikke-våte," er et bredt begrep som dekker flere problemer som kan oppstå med loddestøt, hvorav de fleste er frustrerende subtile. Fordi loddetinn ofte er i flytende tilstand, har prosessen med å påføre det blitt kalt "våt". Tynne koblinger kalles "ikke-våte", som blir mer av en utfordring ved mindre noder med tynnere forbindelser.
Ikke-våte stoffer slipper ofte unna typiske screeningsprosesser, for så å dukke opp senere som returnerte brikker (RMA). Grunnårsakene kan være termiske, mekaniske eller en kombinasjon, for eksempel termisk sykling i en bil som også kjører over ulendt terreng. Den kumulative effekten kan gi nok termisk-mekanisk stress til å bryte kontakten.
Det er flere kallenavn som beskriver spesifikke typer problemer. I stedet for den glatte søyleformen til en god forbindelse, i en "hode-i-pute"-defekt, ser det ut til at den ene ballen synker inn i den andre, som et hode på en pute.
"Den er fortsatt i kontakt, så den elektriske testen kan være bra, men du kan se at den er veldig skjør," sa Chen og pekte på røntgenbildet av en hode-i-pute. "Så snart du har litt termisk stress eller mekanisk stress, kan det gå i stykker helt. Selv om det er en kontakt som ikke er våt, fører den tynne forbindelsen til høy motstand, suboptimal ytelse, og vil sannsynligvis ikke vare lenge. En åpen ikke-våt vil ikke fungere i det hele tatt. I et typisk scenario med dysetilt er det en synlig overgang fra velformede ujevnheter til ikke-våte."
Det kritiske problemet er latente defekter - tilkoblinger som er funksjonelle nok til å bestå en elektrisk test, men som mislykkes i felten.
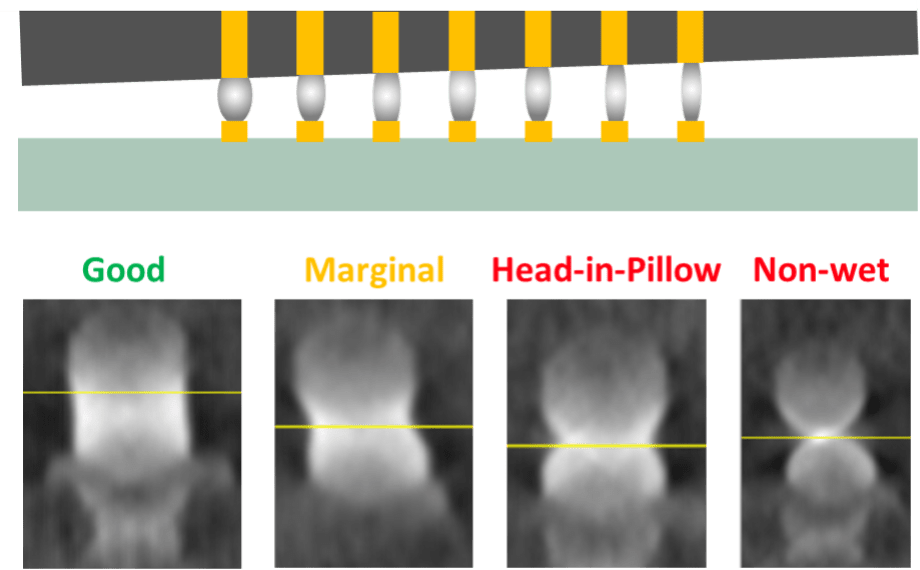
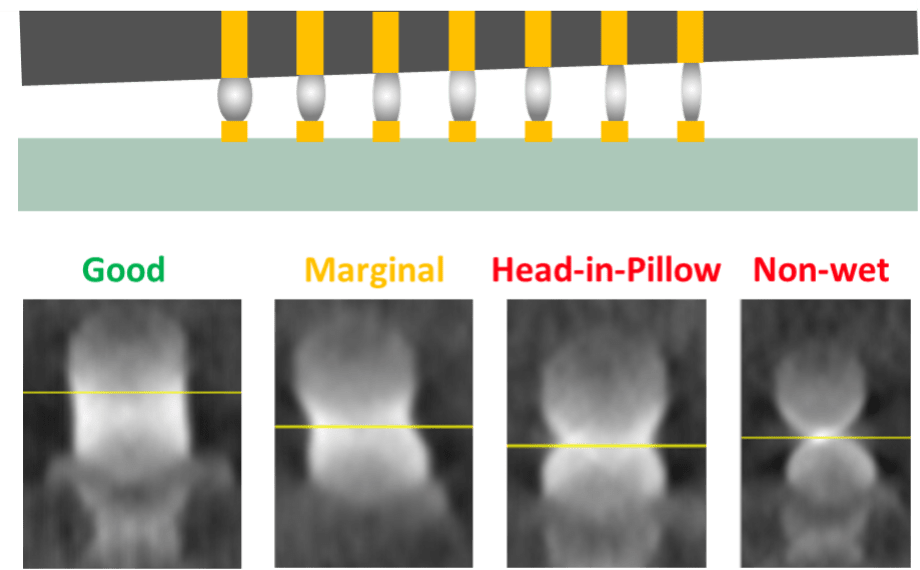
Fig. 2 Gradvis overgang fra gode ujevnheter til ikke-våte i nærvær av dysetilt. Kilde: Bruker
"Det er et stort problem akkurat nå med mange typer enheter på grunn av effekten av termisk stress," sa Chen. "En kunde hadde et produkt som besto e-testscreening og ble sendt ut. Dessverre hadde de mange RMA-er på grunn av feil som ikke var våte som utviklet seg etterpå.»
Noen selskaper tar tak i dette gjennom smertefullt kjedelige manuelle inspeksjoner. Dessverre er enhver menneskelig undersøkelse utsatt for tretthet hos operatøren, spesielt når undersøkere prøver å oppdage subtile feil under et skift på flere timer.
På den positive siden er det nå automatiserte tilnærminger til inspeksjon, for eksempel røntgenverktøy som kan brukes inline. "Det er en stor driver mot høyhastighets, helautomatisk inspeksjon for å oppnå <100 dppb, spesielt for bilindustrien," sa Chen.
Det blir mer komplisert derfra. "Bemerkelsesverdig er loddetinn, synderen bak mange ikke-våte, også gjenstand for elektromigrering," sa Tom Marinis, et hovedmedlem i laboratoriets tekniske stab hos Draper. "Hvis strømtettheten i en forbindelse mellom en brikke og substrat er for høy for en bestemt loddemetall over en periode, fordi smeltetemperaturen til loddet kan være relativt lav sammenlignet med driftstemperaturen til enheten, kan du få migrering av atomene og faktisk danner tomrom og åpner til slutt en forbindelse.»
Marinis advarte om at kommersielle modelleringsverktøy på enhet-PCB-nivå ikke er helt modne nok til å varsle om potensielle elektromigrasjonsproblemer, så det er viktig å fortsatt utføre en akselerert aldringstest.
konklusjonen
Til syvende og sist vil det å oppdage pålitelighetsproblemer fra latente defekter kreve høyere prøvetakingsmetrologi som er følsom for forskyvning, rotasjon, høyde, tilt og andre parametere. Det vil også kreve mer avhengighet av multi-fysisk modellering for å prøve å forutse og løse potensielle problemer før produksjon. Og ettersom halvleder- og bilindustrien fortsetter å blande seg, er det mye mer som står på spill enn bare RMA-er.
"Kostnadene ved feil vokser eksponentielt når latente defekter går fra enheter til moduler til biler som kan sette menneskers liv i fare," sa Chen. Dette er grunnen til at chipmakere skaper helhetlige løsninger som kombinerer design, inspeksjon og testing for bedre å fange opp latente feil.
- SEO-drevet innhold og PR-distribusjon. Bli forsterket i dag.
- Platoblokkkjede. Web3 Metaverse Intelligence. Kunnskap forsterket. Tilgang her.
- kilde: https://semiengineering.com/bump-reliability-is-challenged-by-latent-defects/
- 000
- 1
- 2023
- 2024
- 3d
- a
- akselerert
- Ifølge
- nøyaktighet
- nøyaktig
- Oppnå
- aktiv
- faktisk
- tillegg
- Ytterligere
- adressering
- avansert
- Aldring
- Varsle
- Alle
- tillater
- allerede
- Selv
- alltid
- analyse
- og
- En annen
- forutse
- aktuelt
- søknader
- påføring
- tilnærming
- tilnærminger
- AREA
- områder
- rundt
- Montering
- evaluering
- assosiert
- feste
- Automatisert
- automotive
- bilindustrien
- dårlig
- ball
- basert
- basis
- Bær
- fordi
- bli
- bli
- før du
- bak
- være
- under
- BEST
- Bet
- Bedre
- mellom
- Beyond
- Stor
- større
- Bit
- Break
- bred
- budsjett
- bygget
- innebygd
- virksomhet
- forretningsutvikling
- som heter
- Kan få
- bil
- biler
- saken
- Catch
- Årsak
- årsaker
- forårsaker
- sentrum
- CFD
- utfordre
- utfordret
- utfordringer
- utfordrende
- sjansene
- Endringer
- karakter
- chen
- chip
- chips
- valg
- Classic
- klassifisering
- kombinasjon
- kombinasjoner
- kombinere
- kombinert
- kombinere
- Kom
- kommersiell
- Felles
- Selskaper
- sammenlignet
- helt
- komplekse
- komplisert
- komponent
- Bekymring
- forhold
- Koble
- tilkobling
- Tilkoblinger
- Vurder
- kontakt
- fortsette
- Kjerne
- hjørner
- Kostnad
- kunne
- dekker
- skape
- opprettet
- skaper
- Opprette
- kritisk
- Gjeldende
- I dag
- kunde
- Kunder
- skjæring
- dato
- Database
- håndtering
- tetthet
- beskrive
- utforming
- design
- detaljert
- utvikle
- utviklet
- Utvikling
- enhet
- Enheter
- Die
- forskjeller
- forskjellig
- Vanskelighetsgrad
- digitalt
- digital tvilling
- dimensjoner
- direkte
- direkte
- Regissør
- gjør
- ikke
- ned
- draper
- sjåfør
- dubbet
- under
- dynamikk
- Tidlig
- effekt
- effekter
- effektivitet
- innsats
- Elektronikk
- vekt
- Ingeniørarbeid
- nok
- sikre
- utstyr
- feil
- spesielt
- etc
- Eter (ETH)
- Selv
- etter hvert
- alt
- eksempel
- utøvende
- utvidelse
- forventet
- erfaren
- forklarte
- utforsket
- eksponentielt
- ekstremt
- FAIL
- Failure
- raskeste
- tretthet
- Egenskaper
- kar
- Noen få
- felt
- Fiken
- Figur
- Endelig
- Finn
- finne
- Først
- flyten
- skjema
- funnet
- fra
- frustrerende
- funksjonelle
- videre
- generasjonen
- få
- Går
- skal
- god
- gradvis
- Økende
- Vokser
- Håndtering
- Hard
- hode
- høyde
- hjelpe
- hjelper
- Høy
- høyere
- svært
- helhetlig
- forhåpentligvis
- HOT
- Hvordan
- Hvordan
- HTTPS
- menneskelig
- Hybrid
- Konsekvenser
- viktig
- in
- Inkludert
- Øke
- økende
- bransjer
- industri
- innledende
- i stedet
- instrument
- integrering
- Introduksjon
- etterforskning
- isolert
- utstedelse
- saker
- IT
- selv
- Type
- laboratorium
- stor
- storskala
- større
- Siste
- lag
- lag
- føre
- ledende
- Fører
- Led
- Nivå
- bibliotekene
- Sannsynlig
- lenker
- Flytende
- Bor
- Lang
- Lot
- Lav
- vedlikeholde
- gjøre
- Making
- ledelse
- leder
- håndbok
- produsert
- mange
- kart
- Mario
- matchende
- materiale
- materialer
- moden
- max bredde
- midler
- målinger
- måling
- mekanisk
- medlem
- Metaller
- metode
- metoder
- Metrics
- Justervesenet
- kunne
- migrasjon
- mingling
- modellering
- moduler
- Moduler
- mer
- mest
- trekk
- flere
- nano
- nødvendigvis
- nødvendig
- negativ
- likevel
- Ny
- Ny teknologi
- nyheter
- neste
- node
- noder
- Åpenbare
- tilby
- ONE
- pågående
- åpen
- drift
- operatør
- optimalisering
- alternativer
- rekkefølge
- Annen
- pakke
- pakker
- emballasje
- Smerte
- parametere
- Spesielt
- spesielt
- bestått
- folks
- utføre
- ytelse
- perioden
- fase
- fysisk
- plasser
- plato
- Platon Data Intelligence
- PlatonData
- Spille
- spillere
- Point
- poeng
- Polymers
- portefølje
- positiv
- mulig
- potensiell
- praksis
- tilstedeværelse
- president
- hindre
- Principal
- Før
- sannsynligvis
- probe
- Problem
- problemer
- prosess
- Prosesser
- prosessor
- Produkt
- produktledelse
- Produksjon
- program
- bevis
- riktig
- egenskaper
- prototype
- gi
- forutsatt
- sette
- FoU
- område
- rask
- ekte
- nylig
- anbefaler
- redusere
- reduserer
- refleksjon
- relativt
- pålitelighet
- avhengighet
- fornyet
- krever
- Krever
- forskning
- forskning og utvikling
- resultere
- resulterende
- Resultater
- Risiko
- risikoer
- roller
- root
- Kjør
- Sa
- sier
- vekter
- skanning
- scenario
- screening
- sekunder
- synes
- segmentet
- utvalg
- halvledere
- senior
- sensitive
- flere
- Shadow
- Form
- skift
- SKIFTENDE
- levert
- Kort
- Vis
- Signal
- signifikant
- betydelig
- simulering
- Størrelse
- størrelser
- liten
- mindre
- So
- Software
- Solutions
- noen
- Snart
- kilde
- spesifikk
- Spektroskopi
- Spot
- Staff
- Scene
- stadier
- stake
- Begynn
- Tilstand
- statistisk
- Still
- stresset
- strukturell
- struktur
- emne
- vellykket
- slik
- overrask
- Teknisk
- teknikker
- Technologies
- test
- Testing
- De
- Området
- deres
- Der.
- termisk
- ting
- ting
- tusener
- Gjennom
- Kaster
- tid
- ganger
- til
- sammen
- toleranse
- også
- verktøy
- verktøy
- topp
- mot
- overgang
- Stol
- SVING
- typer
- typisk
- forstå
- kommende
- Oppdater
- bruke
- Bruker
- ulike
- enorme
- Vice President
- synlig
- velkjent
- Hva
- hvilken
- mens
- HVEM
- vil
- uten
- Arbeid
- verste
- ville
- røntgen
- rentene
- Din
- zephyrnet