Az egyre kisebb DRAM-cellaméretek keresése továbbra is aktív és folyamatban van. A DRAM cella mérete az előrejelzések szerint megközelíti a 0.0013 um2-t a D12 csomópont esetében. A mintázattal kapcsolatos kihívások jelentősek, akár DUV, akár EUV litográfia használatáról van szó. Az ASML különösen arról számolt be, hogy amikor a központok közötti értékek elérik a 40 nm-t, az egyszeri mintázat még EUV esetében sem javasolt [1]. Ebben a cikkben bemutatjuk, hogy a 12 nm-es DRAM-csomópont és azon túli kondenzátorok között a kondenzátorok középpontja várhatóan 40 nm alá csökken, ezért több mintázatot igényel.
DRAM cellaelrendezés tárolókondenzátorokhoz
A tárolókondenzátorok hatszögletű tömbben vannak elrendezve (1. ábra). Az aktív terület tervezési szabályát a bitsor és a szósor magassága határozza meg [2].
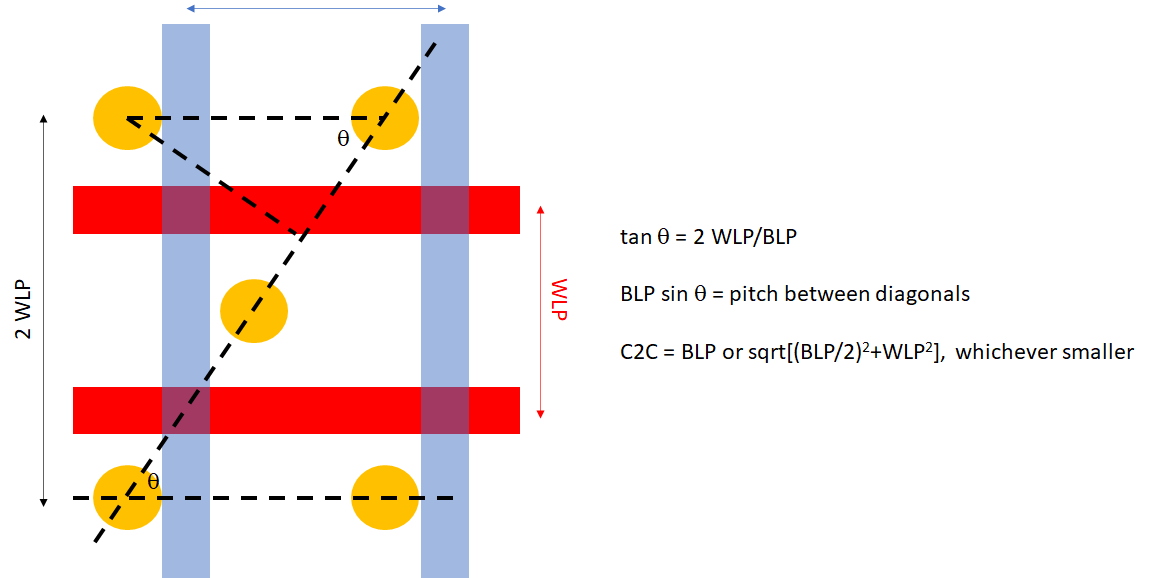
1. ábra Tárolócsomópontok (sárga) egy DRAM cellarácson. BLP = bitsor magassága, WLP = szósor magassága.
A 38 nm-es bites vonalosztás és a 33 nm-es szósorosztás 38 nm-es középpont-középpont-középponthoz, az átlók közötti távolság pedig 32.9 nm-hez vezet, 0.001254 um2 cellaméret és alig 12 nm-es aktív terület tervezési szabály esetén.
Egy 0.33 NA EUV rendszernél a hatszögletű tömb hexapólusos megvilágítást használna, ahol minden pólus háromsugaras interferenciamintát hoz létre (2. ábra). A négy kvadráns pólus más mintát hoz létre, mint a másik két vízszintes pólus. Ez két különálló dóziskomponenshez vezet, különálló sztochasztikával. Ezeket hozzáadjuk a végső, összetett mintához.

2. ábra. A DRAM-tárolási minta hexapólusos megvilágítása 4 kvadráns pólusból (szürke) és két vízszintes pólusból (sárga) áll. A megvilágítás irányától függően az így létrejövő háromsugaras interferenciamintázat meghatározott tájolású.
A jellemző szélén lévő jelentős elnyelt fotonlövés zaj miatt a mintaelhelyezési hibára gyakorolt sztochasztikus hatás jelentős, amint azt a Ref. 1, könnyen meghaladva az 1 nm-es átfedési specifikációt. Az alacsonyabb felszívódott dózis nyilvánvalóan rosszabbnak tűnik (3. ábra).

3. ábra: A központi oszlop sztochasztikus elhelyezési hibája (csak X) 38 nm x 66 nm-es egységcellában (szósor távolság = 33 nm), a várható hexapólus megvilágítás mellett 0.33 NA EUV rendszerben. Itt 25 különböző esetből álló sorozat látható két felszívódott dózisra.
Ha 0.55 NA-ra megyünk, az erősen csökkenti a fókuszmélységet. A 0.55-ös NA 15 nm-es defókuszhoz vezet, ami >50 fokos fáziseltolódáshoz vezet a legbelső és a legkülső diffrakciós sorrend között (4. ábra), ami jelentősen csökkenti a kép kontrasztját az elhalványulás miatt [3].
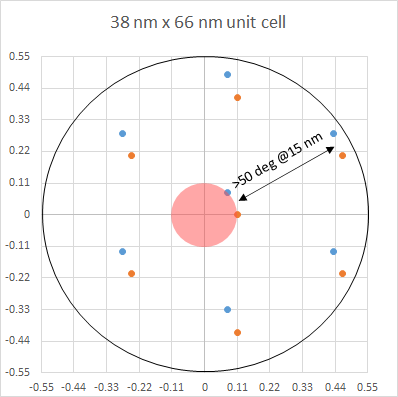
4. ábra: 15 nm-es defókuszálás egy 0.55 NA EUV rendszeren >50 fokos fáziseltolódáshoz vezet a legbelső és a legkülső diffrakciós sorrend között.
Így valószínű, hogy a tárolási csomópont mintázatát két keresztezett vonalmintából kell kialakítani (5. ábra). Minden keresztezett vonalminta létrehozható EUV egyszeri expozícióval vagy DUV SAQP-vel (önálló négyes mintázat). Mindkét lehetőség egymaszkos folyamat. A SAQP folyamat kiforrottabb (mivel régen megelőzte az EUV-t), és mentes az EUV másodlagos elektronsztochasztikus aggályaitól [4], ezért előnyben kell részesíteni. Ennek ellenére az SAQP esetében a távtartó vonalakat jól szabályozni kell mind az elhelyezés, mind a vonalszélesség érdessége szempontjából [5].

5. ábra A tárolási csomópont mintázat két keresztezett vonalminta metszéséből alakítható ki.
A vonal-típusú SAQP helyett egy 2-D spacer méhsejt-mintázatot is bemutatott a Samsung [6], egyetlen maszkot használva kiindulási méhsejt mintázattal, két kezdővonal-mintázatú maszk helyett.
Míg a fenti eset a 38 nm-es bites vonalosztást és a 33 nm-es szósorosztást vette figyelembe, ez vonatkozik arra az esetre is, amikor a hexagonális szimmetria miatt a hangmagasság felcserélődik (33 nm-es bitvonal- és 38 nm-es szósor-osztás).
Referenciák
[1] W. Gao és munkatársai, Proc. SPIE 11323, 113231L (2020).
[2] F. Chen, Trigonometric Relationship among DRAM Cell Pitches, https://www.youtube.com/watch?v=Oq6b-6iw6Zk
[3] JH. Franke, TA Brunner, E. Hendrickx, J. Micro/Nanopattern. Mater. Metrol. 21, 030501 (2022).
[4] F. Chen, A Secondary Electron Blur Randomness as the Origin of EUV Stochastic Defects, https://www.linkedin.com/pulse/secondary-electron-blur-randomness-origin-euv-stochastic-chen/
[5] N. Bae és munkatársai, Proc. SPIE 11615, 116150B (2021).
[6] JM Park et al., IEDM 2015.
Ez a cikk először a LinkedIn Pulse-ban jelent meg: Alkalmazás-specifikus litográfia: 0.0013 um2 alatti DRAM tárolócsomópont-mintázat
Oszd meg ezt a bejegyzést ezen keresztül:
- SEO által támogatott tartalom és PR terjesztés. Erősödjön még ma.
- Platoblockchain. Web3 metaverzum intelligencia. Felerősített tudás. Hozzáférés itt.
- Forrás: https://semiwiki.com/lithography/323357-application-specific-lithography-sub-0-0013-um2-dram-storage-node-patterning/
- 1
- 2020
- 2021
- 2022
- 9
- a
- felett
- aktív
- hozzáadott
- Hozzáteszi
- már
- között
- és a
- megjelent
- Alkalmazás
- alkalmazás specifikus
- megközelítés
- TERÜLET
- elrendezve
- Sor
- cikkben
- lent
- között
- Túl
- Bit
- elhomályosít
- eset
- központi
- kihívások
- chen
- alkatrészek
- aggodalmak
- figyelembe vett
- figyelembe véve
- kontraszt
- Crossed
- igazolták
- attól
- mélység
- Design
- eltökélt
- különböző
- irány
- minden
- könnyen
- él
- hatás
- hiba
- Még
- EVER
- várható
- Exponálás
- Funkció
- Ábra
- utolsó
- vezetéknév
- Összpontosít
- alakult
- Ingyenes
- ból ből
- GAO
- Go
- Rács
- tekintettel
- itt
- Vízszintes
- HTTPS
- kép
- in
- helyette
- útkereszteződés
- kérdés
- IT
- elrendezés
- vezet
- vezető
- vezetékek
- Valószínű
- vonal
- vonalak
- Hosszú
- maszk
- maszkok
- érett
- max-width
- több
- igények
- csomópont
- csomópontok
- Zaj
- folyamatban lévő
- Opciók
- rendelés
- Eredet
- Más
- Park
- különös
- Mintás
- minták
- fázis
- Pillér
- Hangmagasság
- helyek
- Plató
- Platón adatintelligencia
- PlatoData
- állás
- előnyben részesített
- PROC
- folyamat
- Folyamatok
- gyárt
- tervezett
- impulzus
- véletlenszerűség
- elérte
- ajánlott
- Csökkent
- csökkenti
- kapcsolat
- Számolt
- eredményez
- kapott
- Szabály
- Samsung
- másodlagos
- Series of
- váltás
- kellene
- előadás
- mutatott
- jelentős
- egyetlen
- Méret
- méretek
- kisebb
- So
- különleges
- Kezdve
- Még mindig
- tárolás
- lényeges
- rendszer
- feltételek
- A
- ebből adódóan
- nak nek
- alatt
- egység
- használ
- kihasználva
- Értékek
- keresztül
- W
- vajon
- ami
- lesz
- szó
- lenne
- X
- youtube
- zephyrnet









