
در ارزیابی فرآیندهای لیتوگرافی ویفر، شیب log-slope تصویر نرمال شده (NILS) درصد تغییر عرض را برای یک درصد تغییر معین در دوز نشان می دهد [1,2،2]. مقدار اسمی NILS 10 نشان دهنده 10% تغییر در پهنای خط برای تغییر 2% در دوز است. درصد تغییر در پهنای خط با NILS نسبت معکوس دارد. در مقاله قبلی [2]، نشان داده شد که NILS برای یک ویژگی تیره در پس زمینه روشن بهتر از برعکس است. ماسکهای تغییر فاز ضعیف (attPSMs) به بهبود NILS برای رسیدن به مقادیر XNUMX یا بیشتر کمک میکنند، در مواردی که ماسکهای باینری معمولی بدون دوز بسیار بالا نمیتوانند.
افزایش انتقال ماسک تغییر فاز ضعیف شده [3] باعث بهبود بیشتر می شود. انتقال بالاتر به طور موثر مناطق تاریک را تیرهتر میکند، که شیب ثبت تصویر را افزایش میدهد.
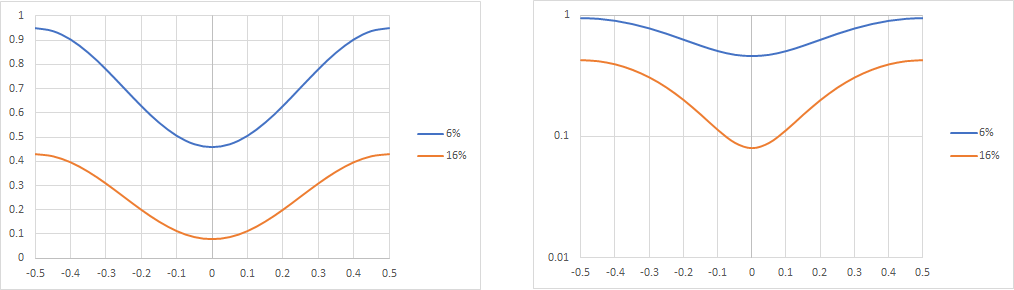
شکل 1. NILS برای انتقال بالاتر ماسک تغییر فاز ضعیف بهبود یافته است. تصاویر در امتداد محور طولانی یک الگوی مستطیلی متراکم (1.3:1) با نور دوقطبی متقاطع گرفته شدهاند. نمودار سمت راست از مقیاس log به جای مقیاس خطی برای محور y استفاده می کند که شدت را نشان می دهد. شیب واضح تر نشان دهنده NILS بهتر برای انتقال بالاتر است (16% در مقابل 6%).
علاوه بر بهبود NILS، حساسیت خطای ماسک و عمق فوکوس نیز بهبود یافته است [3]. بهبود NILS به ویژه برای بهبود وضوح اشکال دوبعدی مانند شکل 2 یا سربرگ بالای این مقاله مهم است. برای attPSM 1% Ref. 12، یک ویژگی مربعی پهنای 3 درصد با نور دوقطبی متقاطع (برای دقیقترین وضوح 65 بعدی: روشنایی دوقطبی در X + روشنایی دوقطبی در Y) فقط میتواند به NILS 2 در هر دو x و y برسد. این فرصت دیگری برای بهبود وضوح دوبعدی برای DUV است، به ویژه برای الگوسازی هسته برای الگوبرداری دوگانه خود تراز (SADP) [2.0].
منابع
[1] CA Mack، "Using the Normalized Image Log-Slope"، The Lithography Expert، Microlithography World، زمستان 2001: http://lithoguru.com/scientist/litho_tutor/TUTOR32%20(Winter%2002).pdf
[2] F. Chen، "ماسک های تغییر فاز برای بهبود NILS - نقصی برای EUV؟"، https://www.linkedin.com/pulse/phase-shifting-masks-nils-improvement-handicap-euv-frederick -چن
[3] T. Faure و همکاران، "توسعه یک فناوری جدید ماسک انتقال فاز انتقال بالا برای گره منطقی 10 نانومتری،" Proc. SPIE 9984, 998402 (2016).
[4] H. Yaegashi و همکاران، "نمای کلی: تکامل مستمر در فرآیند الگوبرداری دوگانه"، Proc. SPIE 8325, 83250B (2012).
همچنین خواندن:
ارزیابی خروجی ویفر EUV: 2019-2022
لیتوگرافی مخصوص کاربرد: مسیریابی دوبعدی گام ۲۸ نانومتری
اشتراک گذاری این پست از طریق:
- محتوای مبتنی بر SEO و توزیع روابط عمومی. امروز تقویت شوید.
- PlatoData.Network Vertical Generative Ai. به خودت قدرت بده دسترسی به اینجا.
- PlatoAiStream. هوش وب 3 دانش تقویت شده دسترسی به اینجا.
- PlatoESG. خودرو / خودروهای الکتریکی، کربن ، CleanTech، انرژی، محیط، خورشیدی، مدیریت پسماند دسترسی به اینجا.
- BlockOffsets. نوسازی مالکیت افست زیست محیطی. دسترسی به اینجا.
- منبع: https://semiwiki.com/lithography/331512-nils-enhancement-with-higher-transmission-phase-shift-masks/
- :است
- :جایی که
- 1
- 1.3
- 10
- 2001
- 2012
- 2016
- 28
- 2D
- a
- بالاتر
- در برابر
- AL
- در امتداد
- همچنین
- an
- و
- دیگر
- هستند
- مناطق
- دور و بر
- مقاله
- AS
- ارزیابی
- محور
- زمینه
- بهتر
- هر دو
- روشن
- موارد
- تغییر دادن
- چن
- مداوم
- معمولی
- هسته
- تاریک
- تیره تر
- متراکم
- عمق
- غوطه
- مقدار
- دو برابر
- E&T
- به طور موثر
- تقویت
- خطا
- به خصوص
- تکامل
- کارشناس
- ویژگی
- شکل
- تمرکز
- برای
- بیشتر
- داده
- می دهد
- گراف
- کمک
- زیاد
- بالاتر
- اصابت
- HTTP
- HTTPS
- تصویر
- تصاویر
- مهم
- بهبود
- بهبود یافته
- بهبود
- بهبود
- in
- افزایش
- نشان می دهد
- در عوض
- IT
- تنها
- لینک
- ورود به سیستم
- منطق
- طولانی
- باعث می شود
- مدیریت می کند
- ماسک
- ماسک
- حداکثر عرض
- بیش
- جدید
- گره
- واضح
- of
- on
- فرصت
- or
- دیگر
- تولید
- ویژه
- الگو
- فاز
- قیر
- افلاطون
- هوش داده افلاطون
- PlatoData
- پست
- قبلی
- آغازگر
- PROC
- روند
- فرآیندهای
- رسیدن به
- خواندن
- نمایندگی
- وضوح
- راست
- مقیاس
- حساسیت
- اشکال
- تغییر
- نشان داده شده
- مربع
- چنین
- T
- صورت گرفته
- طول می کشد
- پیشرفته
- نسبت به
- که
- La
- نمودار
- این
- به
- استفاده
- ارزش
- ارزشها
- از طريق
- vs
- بود
- مسیر..
- که
- زمستان
- با
- بدون
- جهان
- X
- زفیرنت