Das Streben nach immer kleineren DRAM-Zellengrößen ist immer noch aktiv und im Gange. Die DRAM-Zellengröße wird für den D0.0013-Knoten auf annähernd 2 um12 projiziert. Die Herausforderungen bei der Strukturierung sind erheblich, unabhängig davon, ob die Verwendung von DUV- oder EUV-Lithographie in Betracht gezogen wird. ASML berichtete insbesondere, dass bei Mitte-zu-Mitte-Werten von 40 nm eine Einzelstrukturierung nicht einmal für EUV empfohlen würde [1]. In diesem Artikel werden wir zeigen, dass für den 12-nm-DRAM-Knoten und darüber hinaus erwartet wird, dass der Mitte-zu-Mitte-Kondensator unter 40 nm sinkt, weshalb Multipatterning erforderlich ist.
DRAM-Zellenlayout für Speicherkondensatoren
Speicherkondensatoren sind in einem hexagonalen Array angeordnet (Abbildung 1). Die Gestaltungsregel des aktiven Bereichs wird durch den Bitleitungsabstand und den Wortleitungsabstand [2] bestimmt.
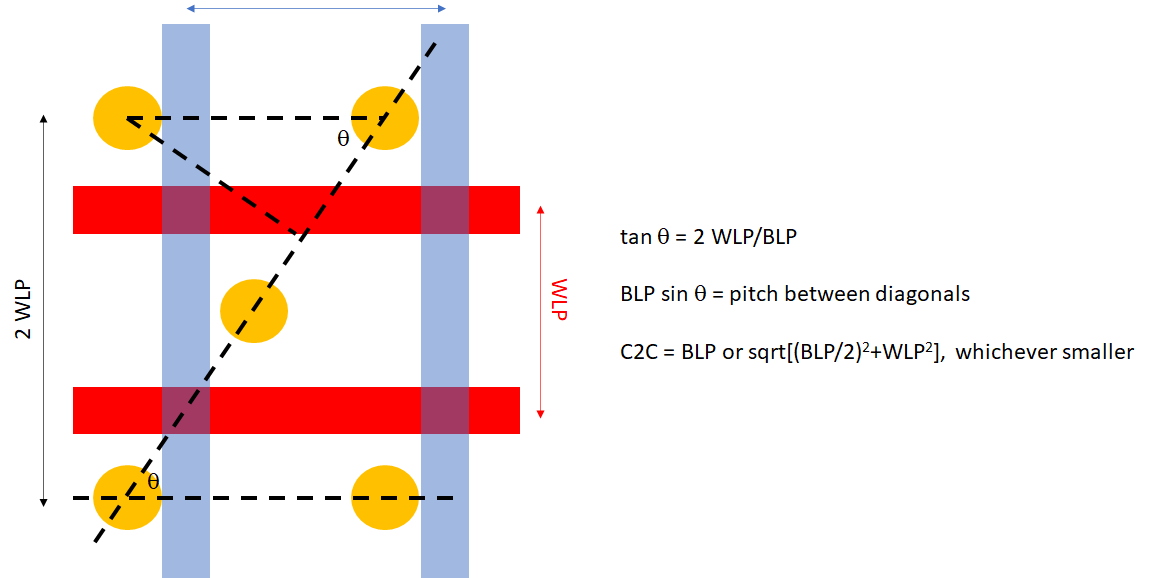
Abbildung 1. Speicherknoten (gelb) auf einem DRAM-Zellenraster. BLP = Bitleitungsabstand, WLP = Wortleitungsabstand.
Ein Bitleitungsabstand von 38 nm und ein Wortleitungsabstand von 33 nm würden zu einem Abstand von Mitte zu Mitte von 38 nm und einem Abstand von 32.9 nm zwischen den Diagonalen führen, bei einer Zellengröße von 0.001254 um2 und knapp unter 12 nm Entwurfsregel für aktive Bereiche.
Für ein EUV-System mit 0.33 NA würde das hexagonale Array eine Hexapol-Beleuchtung verwenden, wobei jeder Pol ein Dreistrahl-Interferenzmuster erzeugt (Abbildung 2). Die vier Quadrantenpole erzeugen ein anderes Muster als die anderen beiden horizontalen Pole. Dies führt zu zwei getrennten Dosiskomponenten mit getrennter Stochastik. Diese werden im endgültigen, zusammengesetzten Muster hinzugefügt.

Abbildung 2. Hexapol-Beleuchtung für DRAM-Speichermuster besteht aus 4 Quadranten-Polen (grau) und zwei horizontalen Polen (gelb). Je nach Beleuchtungsrichtung hat das resultierende dreistrahlige Interferenzmuster eine bestimmte Orientierung.
Aufgrund des erheblichen absorbierten Photonenschussrauschens an der Merkmalskante ist der stochastische Effekt auf den Musterplatzierungsfehler signifikant, wie bereits in Ref. 1 offenbart. 1 und übertrifft leicht eine 3-nm-Overlay-Spezifikation. Die niedrigere absorbierte Dosis scheint offensichtlich schlechter zu sein (Abbildung XNUMX).

Abbildung 3. Stochastischer Platzierungsfehler (nur X) der zentralen Säule in einer Einheitszelle von 38 nm x 66 nm (Wortleitungsabstand = 33 nm) mit der erwarteten Hexapolbeleuchtung in einem EUV-System mit 0.33 NA. Hier ist eine Reihe von 25 verschiedenen Fällen für zwei absorbierte Dosen gezeigt.
Wenn Sie auf 0.55 NA gehen, kommt das Problem einer stark reduzierten Schärfentiefe hinzu. Eine NA von 0.55 würde zu einer Defokussierung von 15 nm führen, was zu einer Phasenverschiebung von >50 Grad zwischen der innersten und der äußersten Beugungsordnung führt (Abbildung 4), was den Bildkontrast durch Ausbleichen stark reduziert [3].
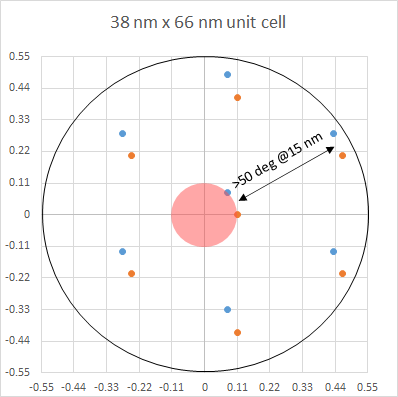
Abbildung 4. Eine Defokussierung von 15 nm auf einem EUV-System mit 0.55 NA führt zu einer Phasenverschiebung von >50 Grad zwischen der innersten und der äußersten Beugungsordnung.
Daher ist es wahrscheinlich, dass das Speicherknotenmuster aus zwei gekreuzten Linienmustern gebildet werden muss (Abbildung 5). Jedes gekreuzte Linienmuster kann durch eine EUV-Einzelbelichtung oder durch DUV SAQP (self-aligned Quadruple Patterning) gebildet werden. Beide Optionen sind Einzelmaskenprozesse. Der SAQP-Prozess ist ausgereifter (er ist EUV lange vorausgegangen) und frei von den stochastischen Bedenken hinsichtlich Sekundärelektronen bei EUV [4], daher sollte er bevorzugt werden. Dennoch müssen für den SAQP-Fall die Abstandslinien sowohl hinsichtlich der Platzierung als auch der Linienbreitenrauheit gut kontrolliert werden [5].

Abbildung 5. Das Speicherknotenmuster kann durch den Schnittpunkt zweier gekreuzter Linienmuster gebildet werden.
Anstelle von SAQP vom Linientyp wurde von Samsung [2] auch ein 6-D-Spacer-Wabenmuster demonstriert, das eine einzelne Maske mit einem anfänglichen Wabenmuster anstelle von zwei Masken mit anfänglichen Linienmustern verwendet.
Während der obige Fall einen 38-nm-Bitleitungsabstand und einen 33-nm-Wortleitungsabstand betrachtete, gilt er aufgrund der hexagonalen Symmetrie auch für den Fall, in dem die Abstände vertauscht sind (33-nm-Bitleitungsabstand und 38-nm-Wortleitungsabstand).
Bibliographie
[1] W. Gao et al., Proc. SPIE 11323, 113231L (2020).
[2] F. Chen, Trigonometrische Beziehung zwischen DRAM-Zellenabständen, https://www.youtube.com/watch?v=Oq6b-6iw6Zk
[3] JH. Franke, TA Brunner, E. Hendrickx, J. Micro/Nanopattern. Mater. Metrol. 21, 030501 (2022).
[4] F. Chen, Sekundärelektronenunschärfe-Zufälligkeit als Ursprung stochastischer EUV-Defekte, https://www.linkedin.com/pulse/secondary-electron-blur-randomness-origin-euv-stochastic-chen/
[5] N. Bae et al., Proc. SPIE 11615, 116150B (2021).
[6] JM Park et al., IEDM 2015.
Dieser Artikel erschien zuerst in LinkedIn Pulse: Anwendungsspezifische Lithographie: Sub-0.0013 um2 DRAM-Speicherknotenstrukturierung
Teile diesen Beitrag über:
- SEO-gestützte Content- und PR-Distribution. Holen Sie sich noch heute Verstärkung.
- Platoblockkette. Web3-Metaverse-Intelligenz. Wissen verstärkt. Hier zugreifen.
- Quelle: https://semiwiki.com/lithography/323357-application-specific-lithography-sub-0-0013-um2-dram-storage-node-patterning/
- 1
- 2020
- 2021
- 2022
- 9
- a
- oben
- aktiv
- hinzugefügt
- Fügt
- bereits
- unter
- und
- erschienen
- Anwendung
- anwendungsspezifisch
- Ansatz
- Bereich
- vereinbart worden
- Feld
- Artikel
- unten
- zwischen
- Beyond
- Bit
- verwischen
- Häuser
- Hauptgeschäftsstelle
- Herausforderungen
- chen
- Komponenten
- Bedenken
- betrachtet
- Berücksichtigung
- Kontrast
- Crossed
- weisen nach, dass
- Abhängig
- Tiefe
- Design
- entschlossen
- anders
- Richtung
- jeder
- leicht
- Edge
- bewirken
- Fehler
- Sogar
- ÜBERHAUPT
- erwartet
- Belichtung
- Merkmal
- Abbildung
- Finale
- Vorname
- Setzen Sie mit Achtsamkeit
- gebildet
- Frei
- für
- GAO
- Go
- Gitter
- mit
- hier
- Horizontale
- HTTPS
- Image
- in
- beantragen müssen
- Überschneidung
- Problem
- IT
- Layout
- führen
- führenden
- umwandeln
- wahrscheinlich
- Line
- Linien
- Lang
- Maske"
- Masken
- reifen
- max-width
- mehr
- Bedürfnisse
- Knoten
- Fiber Node
- Lärm
- laufend
- Optionen
- Bestellungen
- Origin
- Andere
- Park
- besondere
- Schnittmuster
- Muster
- Phase
- Säule
- Tonhöhe (Pitch)
- Stellplätze
- Plato
- Datenintelligenz von Plato
- PlatoData
- Post
- bevorzugt
- PROC
- Prozessdefinierung
- anpassen
- produziert
- projektiert
- Puls
- Zufälligkeit
- erreicht
- empfohlen
- Reduziert
- reduziert
- Beziehung
- Berichtet
- Folge
- was zu
- Regel
- Samsung
- Sekundär-
- Modellreihe
- verschieben
- sollte
- erklären
- gezeigt
- signifikant
- Single
- Größe
- Größen
- kleinere
- So
- spezifisch
- Beginnen Sie
- Immer noch
- Lagerung
- wesentlich
- System
- AGB
- Das
- deswegen
- zu
- für
- Einheit
- -
- Verwendung
- Werte
- W
- ob
- welche
- werden wir
- Word
- würde
- X
- Youtube
- Zephyrnet









