新闻: 供应商
17,2023
位于美国密歇根州德克斯特的 k-Space Associates Inc——成立于 1992 年,生产用于微电子、光电和光伏设备研究和制造的薄膜计量仪器和软件——推出了 kSA XRF x 射线荧光薄膜计量工具,用于测量太薄而无法进行可靠光学测量的材料的薄膜厚度。
kSA XRF 使用 X 射线源、检测器和专有软件来测量 X 射线发射光谱,然后用于实时计算薄膜厚度。 它根据客户独特的涂层配方和测量需求测量合适的原子种类。 该技术已被证明可以测量玻璃面板、晶圆和基座上的半导体和介电层,适用于太阳能、电力和其他薄膜设备。
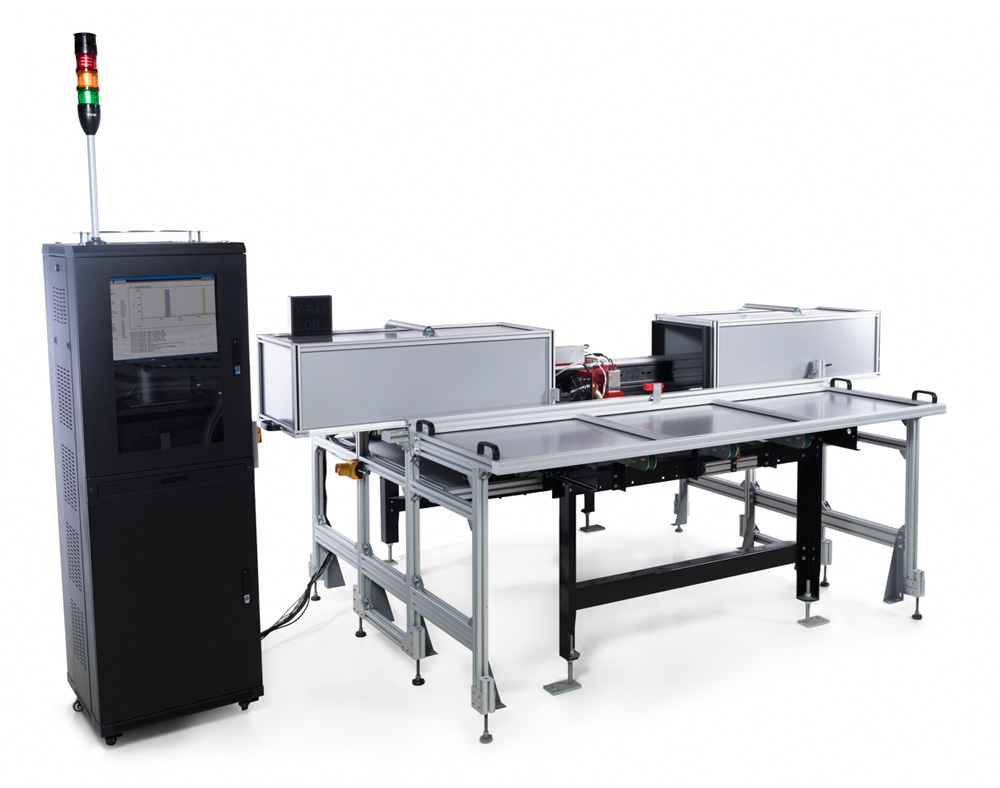
图片:kSA XRF,可配置为独立的台式设置或通过传送带进行在线检测和制造过程控制(如此处所示)。
“我们开发了 kSA XRF,同时帮助我们的一位现有客户测量无法使用传统光学方法测量的介电涂层,”首席执行官 Darryl Barlett 说。 “XRF 测量 100nm 以下的介电涂层,可供玻璃面板、太阳能电池板、MOCVD [金属有机化学气相沉积] 载体和其他产品的制造商使用,”他补充道。 “与现有工具相比,它是一种更高级且更具可扩展性的选择,并且可以轻松安装到输送线中。”
kSA XRF 可以配置为独立的台式设置或通过传送带进行在线检测和制造过程控制。
“kSA XRF 允许用户在生产过程中表征和监测他们的薄膜涂层,从而提高产量并降低成本,”Barlett 指出。
- SEO 支持的内容和 PR 分发。 今天得到放大。
- 柏拉图区块链。 Web3 元宇宙智能。 知识放大。 访问这里。
- Sumber: https://www.semiconductor-today.com/news_items/2023/jan/kspace-170123.shtml