追求更小的 DRAM 单元尺寸仍然很活跃并且正在进行中。 对于 D0.0013 节点,DRAM 单元尺寸预计接近 2 um12。 无论考虑使用 DUV 还是 EUV 光刻,图案化挑战都是重大的。 特别是,ASML 报告说,当中心到中心值达到 40 nm 时,即使对于 EUV [1],也不推荐使用单一图案化。 在本文中,我们将展示对于 12 纳米及更高节点的 DRAM 节点,电容器中心到中心预计将低于 40 纳米,因此需要多重图案化。
存储电容器的 DRAM 单元布局
存储电容器排列成六边形阵列(图 1)。 有源区设计规则由位线间距和字线间距决定[2]。
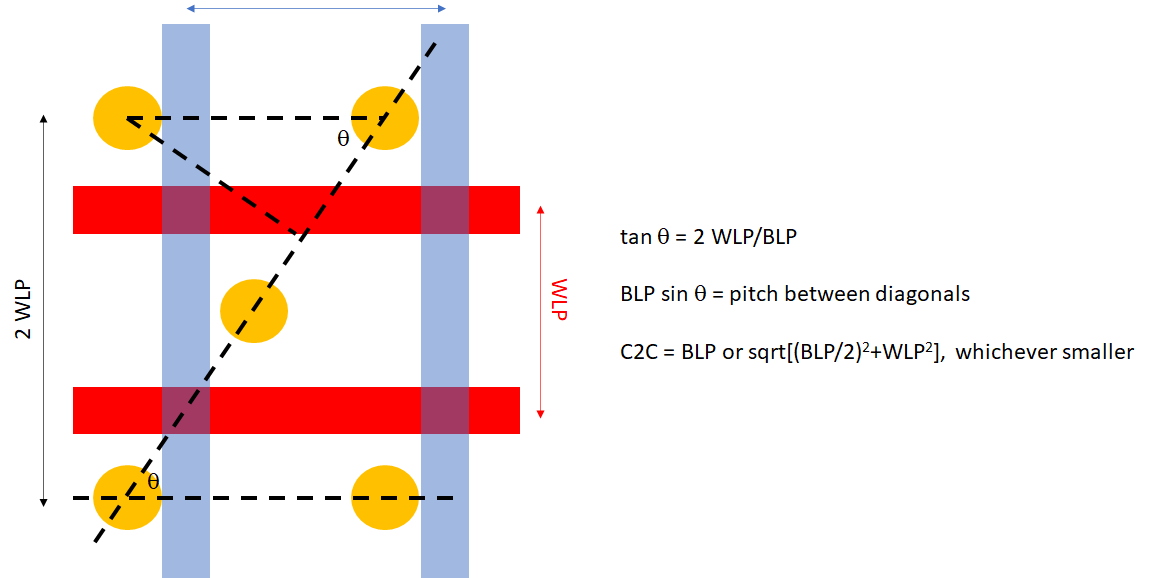
图 1. DRAM 单元网格上的存储节点(黄色)。 BLP=位线间距,WLP=字线间距。
对于 38 um33 的单元尺寸和略低于 38 nm 的有源区设计规则,32.9 nm 的位线间距和 0.001254 nm 的字线间距将导致 2 nm 的中心到中心和 12 nm 的对角线间距。
对于 0.33 NA EUV 系统,六边形阵列将使用六极照明,其中每个极产生三光束干涉图案(图 2)。 四个象限极产生与其他两个水平极不同的模式。 这导致具有独立随机性的两个独立剂量分量。 这些被添加到最终的复合模式中。

图 2. DRAM 存储模式的六极照明由 4 个象限极(灰色)和两个水平极(黄色)组成。 根据照明方向,生成的三光束干涉图案具有特定方向。
由于特征边缘处大量吸收的光子散粒噪声,图案放置误差的随机效应非常显着,正如参考文献中已经公开的那样。 1,很容易超过 1 nm 的覆盖规格。 较低的吸收剂量似乎明显更差(图 3)。

图 3. 38 nm x 66 nm 晶胞(字线间距 = 33 nm)中中心柱的随机放置误差(仅 X),具有 0.33 NA EUV 系统中的预期六极照明。 这里显示了两个吸收剂量的一系列 25 个不同实例。
转到 0.55 NA 会增加焦点深度严重降低的问题。 NA 为 0.55 会导致 15 nm 散焦,导致最内层和最外层衍射级之间的相移 >50 度(图 4),这会由于褪色 [3] 而严重降低图像对比度。
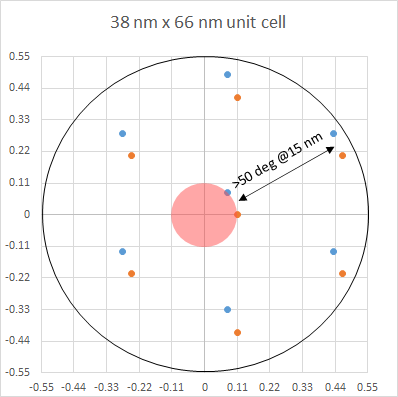
图 4. 15 NA EUV 系统上的 0.55 nm 散焦导致最内层和最外层衍射级之间的相移 >50 度。
因此,存储节点图案很可能需要由两个交叉线图案形成(图 5)。 每个交叉线图案可以通过 EUV 单次曝光或 DUV SAQP(自对准四重图案)形成。 两种选择都是单掩模工艺。 SAQP 工艺更成熟(早于 EUV)并且没有 EUV [4] 的二次电子随机问题,因此它应该是首选。 尽管如此,对于 SAQP 情况,间隔线必须在布局和线宽粗糙度方面得到很好的控制 [5]。

图 5. 存储节点图案可以由两个交叉线图案的交叉点形成。
三星 [2] 还展示了一种二维间隔蜂窝图案,而不是线型 SAQP,它使用具有起始蜂窝图案的单个掩膜,而不是具有起始线图案的两个掩膜。
虽然上述情况考虑了 38 nm 位线间距和 33 nm 字线间距,但由于六边形对称性,它也适用于交换间距的情况(33 nm 位线间距和 38 nm 字线间距)。
参考资料
[1] W. Gao 等人,Proc。 SPIE 11323, 113231L (2020)。
[2] F. Chen,DRAM 单元间距之间的三角关系,https://www.youtube.com/watch?v=Oq6b-6iw6Zk
[3] 杰赫. Franke, TA Brunner, E. Hendrickx, J. Micro/Nanopattern。 母校。 地铁。 21, 030501 (2022)。
[4] F. Chen,作为 EUV 随机缺陷起源的二次电子模糊随机性,https://www.linkedin.com/pulse/secondary-electron-blur-randomness-origin-euv-stochastic-chen/
[5] N. Bae 等人,Proc。 SPIE 11615, 116150B (2021)。
[6] JM Park 等人,IEDM 2015。
本文首发于 LinkedIn Pulse: 特定应用光刻:低于 0.0013 um2 DRAM 存储节点图案化
通过以下方式分享此帖子:
- SEO 支持的内容和 PR 分发。 今天得到放大。
- 柏拉图区块链。 Web3 元宇宙智能。 知识放大。 访问这里。
- Sumber: https://semiwiki.com/lithography/323357-application-specific-lithography-sub-0-0013-um2-dram-storage-node-patterning/
- 1
- 2020
- 2021
- 2022
- 9
- a
- 以上
- 要积极。
- 添加
- 添加
- 已经
- 其中
- 和
- 出现
- 应用领域
- 特定应用
- 的途径
- 国家 / 地区
- 安排
- 排列
- 刊文
- 如下。
- 之间
- 超越
- 位
- 模糊
- 案件
- 中央
- 挑战
- 陈
- 组件
- 关注
- 考虑
- 考虑
- 对比
- 交叉
- 证明
- 根据
- 深度
- 设计
- 决心
- 不同
- 方向
- 每
- 容易
- 边缘
- 效果
- 错误
- 甚至
- EVER
- 预期
- 曝光
- 专栏
- 数字
- 最后
- 姓氏:
- 专注焦点
- 形成
- Free
- 止
- GAO
- Go
- 格
- 有
- 此处
- 横
- HTTPS
- 图片
- in
- 代替
- 路口
- 问题
- IT
- 布局
- 铅
- 领导
- 信息
- 容易
- Line
- 线
- 长
- 面膜
- 面膜
- 成熟
- 最大宽度
- 更多
- 需要
- 节点
- 节点
- 噪声
- 正在进行
- 附加选项
- 订单
- 起始地
- 其他名称
- 地形公园
- 特别
- 模式
- 模式
- 相
- 支柱
- 沥青
- 球场
- 柏拉图
- 柏拉图数据智能
- 柏拉图数据
- 帖子
- 首选
- PROC
- 过程
- 过程
- 生产
- 预计
- 脉冲
- 随机性
- 达到
- 建议
- 减少
- 减少
- 关系
- 报道
- 导致
- 导致
- 第
- Samsung
- 次
- 系列
- 转移
- 应该
- 显示
- 如图
- 显著
- 单
- 尺寸
- 尺寸
- 小
- So
- 具体的
- 开始
- 仍
- 存储
- 大量
- 系统
- 条款
- 因此
- 至
- 下
- 单元
- 使用
- 利用
- 价值观
- 通过
- W
- 是否
- 这
- 将
- Word
- 将
- X
- YouTube的
- 和风网









