Her zamankinden daha küçük DRAM hücre boyutları arayışı halen aktif ve devam etmektedir. DRAM hücre boyutunun, D0.0013 düğümü için 2 um12'ye yaklaşması öngörülmektedir. DUV veya EUV litografi kullanımı dikkate alındığında, modelleme zorlukları önemlidir. Özellikle ASML, merkezden merkeze değerler 40 nm'ye ulaştığında, EUV için bile tek modellemenin önerilmeyeceğini bildirdi [1]. Bu yazıda, 12nm DRAM düğümü ve ötesi için kapasitör merkezden merkeze 40 nm'nin altına düşmesinin beklendiğini ve bu nedenle çoklu modelleme gerektirdiğini göstereceğiz.
Depolama Kapasitörleri için DRAM hücre düzeni
Depolama kapasitörleri altıgen bir dizide düzenlenmiştir (Şekil 1). Aktif alan tasarım kuralı, bit satırı aralığı ve kelime satırı aralığı [2] tarafından belirlenir.
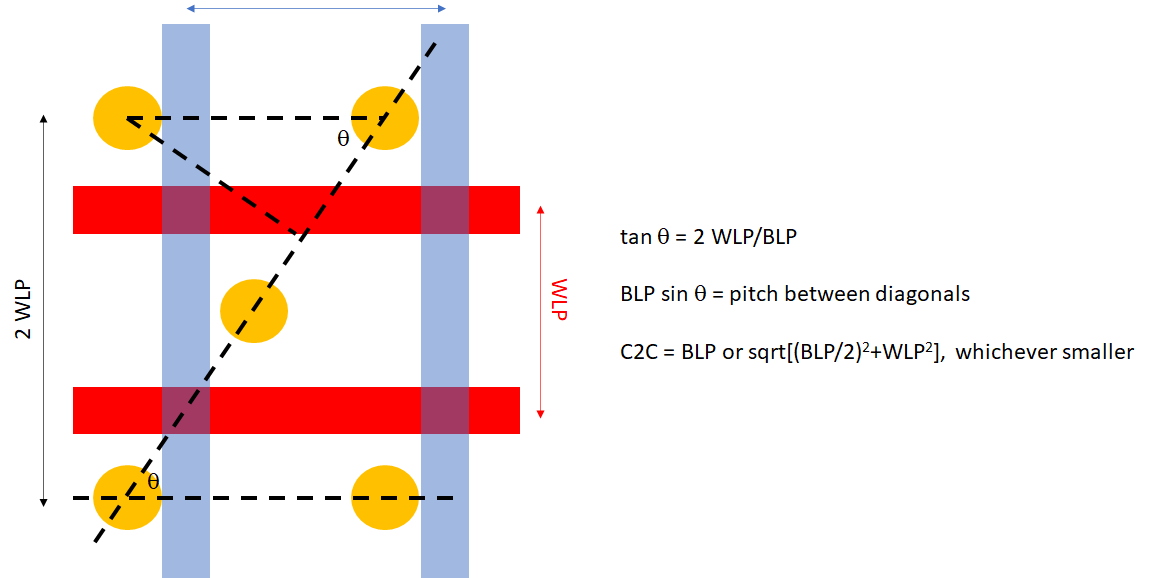
Şekil 1. DRAM hücre ızgarasındaki depolama düğümleri (sarı). BLP=bit satır aralığı, WLP=kelime satırı aralığı.
38 nm bit çizgi aralığı ve 33 nm kelime satırı aralığı, 38 um32.9 hücre boyutu ve 0.001254 nm aktif alan tasarım kuralının hemen altında, merkezden merkeze 2 nm'lik bir mesafeye ve köşegenler arasında 12 nm'lik bir perdeye yol açacaktır.
0.33 NA EUV sistemi için, altıgen dizi, her kutbun üç ışınlı bir girişim deseni ürettiği bir altı kutuplu aydınlatma kullanır (Şekil 2). Dört çeyrek kutup, diğer iki yatay kutuptan farklı bir model oluşturur. Bu, ayrı stokastiklere sahip iki ayrı doz bileşenine yol açar. Bunlar nihai, bileşik modele eklenir.

Şekil 2. DRAM depolama modeli için altı kutuplu aydınlatma, 4 çeyrek kutup (gri) ve iki yatay kutuptan (sarı) oluşur. Aydınlatma yönüne bağlı olarak, ortaya çıkan üç ışınlı girişim deseninin belirli bir yönü vardır.
Özellik kenarında önemli ölçüde emilen foton atış gürültüsü nedeniyle, model yerleştirme hatası üzerindeki stokastik etki, Ref. 1, 1 nm bindirme spesifikasyonunu kolayca aşar. Absorbe edilen daha düşük doz açıkça daha kötü görünmektedir (Şekil 3).

Şekil 3. 38 NA EUV sisteminde beklenen altı kutuplu aydınlatma ile 66 nm x 33 nm birim hücrede (kelime satırı aralığı = 0.33 nm) merkezi sütunun stokastik yerleştirme hatası (yalnızca X). Burada iki absorbe doz için 25 farklı örnek gösterilmektedir.
0.55 NA'ya gitmek, ciddi şekilde azaltılmış odak derinliği sorununu ekler. 0.55'lik bir NA, en içteki ve en dıştaki kırınım sıraları arasında >15 derecelik faz kaymasına yol açan 50 nm'lik bir odak dışılığa neden olur (Şekil 4), bu da solmaya bağlı görüntü kontrastını ciddi şekilde azaltır [3].
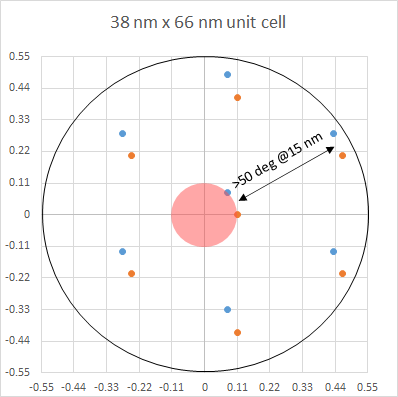
Şekil 4. 15 NA EUV sisteminde 0.55 nm odak dışı bırakma, en içteki ve en dıştaki kırınım düzenleri arasında >50 derecelik bir faz kaymasına yol açar.
Bu nedenle, depolama düğümü modelinin iki çapraz çizgi modelinden oluşturulması gerekebilir (Şekil 5). Her çapraz çizgi deseni, bir EUV tekli pozlama veya DUV SAQP (kendi kendine hizalanmış dörtlü desen oluşturma) ile oluşturulabilir. Her iki seçenek de tek maskeli işlemlerdir. SAQP süreci daha olgundur (EUV'den uzun süre önce gelir) ve EUV'nin [4] ikincil elektron stokastik kaygılarından bağımsızdır, bu nedenle tercih edilmelidir. Yine de, SAQP durumu için, boşluk çizgileri hem yerleştirme hem de çizgi genişliği pürüzlülüğü açısından iyi kontrol edilmelidir [5].

Şekil 5. Depolama düğümü modeli, iki çapraz çizgi modelinin kesişmesiyle oluşturulabilir.
Çizgi tipi SAQP yerine, Samsung [2] tarafından, başlangıç çizgisi desenlerine sahip iki maske yerine başlangıç petek desenine sahip tek bir maske kullanılarak bir 6-B ara parça petek modellemesi gösterildi.
Yukarıdaki durum 38 nm bit satır aralığı ve 33 nm kelime satırı aralığı olarak kabul edilirken, altıgen simetri nedeniyle perdelerin değiştirildiği (33 nm bit satır aralığı ve 38 nm kelime satırı aralığı) durum için de geçerlidir.
Referanslar
[1] W. Gao ve diğ., Proc. SPIE 11323, 113231L (2020).
[2] F. Chen, DRAM Hücre Perdeleri Arasındaki Trigonometrik İlişki, https://www.youtube.com/watch?v=Oq6b-6iw6Zk
[3] Franke, TA Brunner, E. Hendrickx, J. Micro/Nanopattern. Anne. Metrol. 21, 030501 (2022).
[4] F. Chen, EUV Stokastik Kusurlarının Kökeni Olarak İkincil Elektron Bulanıklığı Rastgeleliği, https://www.linkedin.com/pulse/secondary-electron-blur-randomness-origin-euv-stochastic-chen/
[5] N. Bae ve diğ., Proc. SPIE 11615, 116150B (2021).
[6] JM Park ve diğerleri, IEDM 2015.
Bu makale ilk olarak LinkedIn Pulse'ta yayınlandı: Uygulamaya Özel Litografi: 0.0013 um2'nin altında DRAM Depolama Düğümü Modelleme
Bu gönderiyi şu yolla paylaş:
- SEO Destekli İçerik ve Halkla İlişkiler Dağıtımı. Bugün Gücünüzü Artırın.
- Plato blok zinciri. Web3 Metaverse Zekası. Bilgi Güçlendirildi. Buradan Erişin.
- Kaynak: https://semiwiki.com/lithography/323357-application-specific-lithography-sub-0-0013-um2-dram-storage-node-patterning/
- 1
- 2020
- 2021
- 2022
- 9
- a
- yukarıdaki
- aktif
- katma
- Ekler
- zaten
- arasında
- ve
- çıktı
- Uygulama
- uygulamaya özel
- yaklaşım
- ALAN
- düzenlenmiş
- Dizi
- göre
- altında
- arasında
- Ötesinde
- Bit
- bulanıklık
- dava
- merkezi
- zorluklar
- chen
- bileşenler
- Endişeler
- kabul
- düşünen
- kontrast
- Çapraz
- gösterdi
- bağlı
- derinlik
- Dizayn
- kararlı
- farklı
- yön
- her
- kolayca
- kenar
- Efekt
- hata
- Hatta
- hİÇ
- beklenen
- Maruz kalma
- Özellikler(Hazırlık aşamasında)
- şekil
- son
- Ad
- odak
- oluşturulan
- Ücretsiz
- itibaren
- GAO
- Go
- Grid
- sahip olan
- okuyun
- Yatay
- HTTPS
- görüntü
- in
- yerine
- kavşak
- konu
- IT
- Düzen
- öncülük etmek
- önemli
- İlanlar
- Muhtemelen
- çizgi
- hatları
- Uzun
- maske
- Maskeler
- olgun
- maksimum genişlik
- Daha
- ihtiyaçlar
- düğüm
- düğümler
- Gürültü
- devam
- Opsiyonlar
- emir
- Origin
- Diğer
- Park
- belirli
- model
- desen
- faz
- Pillar
- Zift
- sahalar
- Platon
- Plato Veri Zekası
- PlatoVeri
- Çivi
- tercihli
- PROC
- süreç
- Süreçler
- üretmek
- tahmin
- nabız
- rasgelelik
- ulaştı
- Tavsiye edilen
- Indirimli
- azaltır
- ilişki
- Bildirilen
- sonuç
- Ortaya çıkan
- Kural
- Samsung
- ikincil
- Dizi
- çalışma
- meli
- şov
- gösterilen
- önemli
- tek
- beden
- boyutları
- daha küçük
- So
- özel
- XNUMX dakika içinde!
- Yine
- hafızası
- önemli
- sistem
- şartlar
- The
- bu nedenle
- için
- altında
- birim
- kullanım
- Kullanılması
- Değerler
- üzerinden
- W
- olup olmadığını
- hangi
- irade
- Word
- olur
- X
- Youtube
- zefirnet









