การแสวงหาขนาดเซลล์ DRAM ที่เล็กลงยังคงดำเนินอยู่และดำเนินต่อไป ขนาดเซลล์ DRAM คาดว่าจะเข้าใกล้ 0.0013 um2 สำหรับโหนด D12 ความท้าทายในการสร้างลวดลายมีความสำคัญไม่ว่าจะพิจารณาถึงการใช้การพิมพ์หิน DUV หรือ EUV โดยเฉพาะอย่างยิ่ง ASML รายงานว่าเมื่อค่าจากศูนย์กลางถึงศูนย์กลางถึง 40 นาโนเมตร จะไม่แนะนำให้ใช้รูปแบบเดียวแม้แต่กับ EUV [1] ในบทความนี้ เราจะแสดงให้เห็นว่าสำหรับโหนด DRAM ขนาด 12 นาโนเมตรและหลังจากนั้น ตัวเก็บประจุจากศูนย์กลางถึงศูนย์กลางคาดว่าจะต่ำกว่า 40 นาโนเมตร ดังนั้นจึงต้องใช้รูปแบบหลายลวดลาย
รูปแบบเซลล์ DRAM สำหรับตัวเก็บประจุ
ตัวเก็บประจุจัดเก็บถูกจัดเรียงเป็นอาร์เรย์หกเหลี่ยม (รูปที่ 1) กฎการออกแบบพื้นที่แอ็คทีฟถูกกำหนดโดยระดับบิตไลน์และระดับเวิร์ดไลน์ [2]
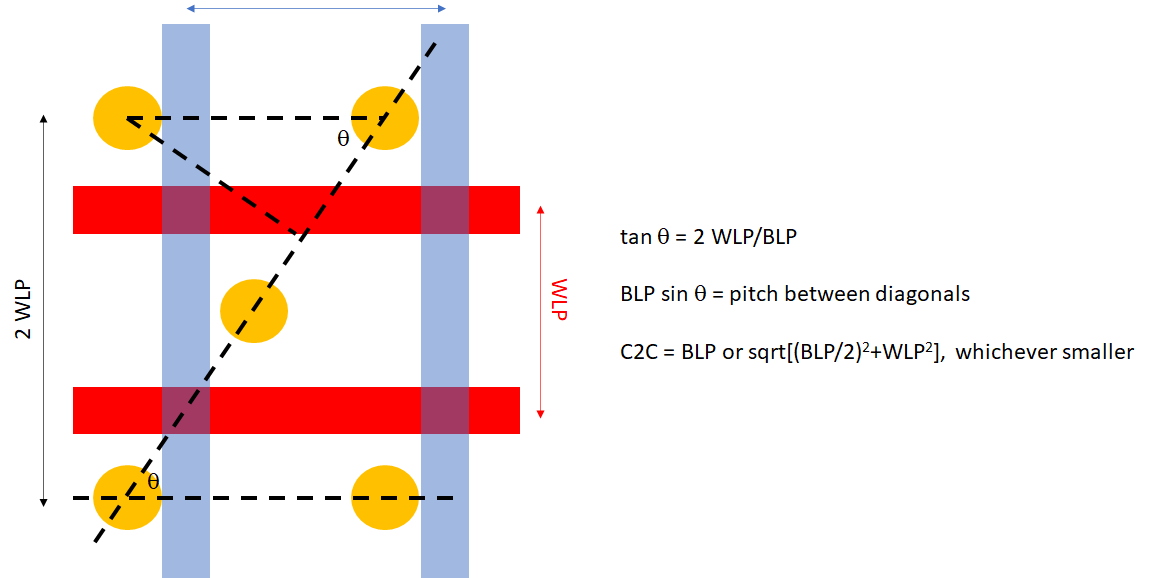
รูปที่ 1. โหนดหน่วยเก็บข้อมูล (สีเหลือง) บนตารางเซลล์ DRAM BLP = ระดับเสียงของเส้นบิต, WLP = ระดับเสียงของคำ
ระยะพิทช์ของเส้นบิต 38 นาโนเมตรและระยะพิทช์ของเส้นคำ 33 นาโนเมตรจะนำไปสู่จุดกึ่งกลางถึงกึ่งกลางที่ 38 นาโนเมตรและระยะพิทช์ 32.9 นาโนเมตรระหว่างเส้นทแยงมุม สำหรับขนาดเซลล์ 0.001254 um2 และต่ำกว่ากฎการออกแบบพื้นที่แอ็คทีฟ 12 นาโนเมตร
สำหรับระบบ 0.33 NA EUV อาร์เรย์หกเหลี่ยมจะใช้การส่องสว่างแบบหกเหลี่ยม โดยที่แต่ละขั้วจะสร้างรูปแบบการรบกวนแบบสามลำแสง (รูปที่ 2) เสาสี่แฉกสร้างรูปแบบที่แตกต่างจากเสาแนวนอนอีกสองเสา สิ่งนี้นำไปสู่ส่วนประกอบของขนาดยาที่แยกจากกันโดยมีสโทแคสติกแยกกัน สิ่งเหล่านี้ถูกเพิ่มเข้ามาในรูปแบบผสมขั้นสุดท้าย

รูปที่ 2 ไฟส่องสว่างแบบ Hexapole สำหรับรูปแบบการจัดเก็บข้อมูล DRAM ประกอบด้วย 4 ขั้ว (สีเทา) และ XNUMX ขั้วในแนวนอน (สีเหลือง) รูปแบบการแทรกสอดของลำแสงสามลำที่ได้จะมีทิศทางเฉพาะ ทั้งนี้ขึ้นอยู่กับทิศทางการส่องสว่าง
เนื่องจากสัญญาณรบกวนจากการยิงโฟตอนที่ถูกดูดกลืนอย่างมากที่ขอบของคุณลักษณะ ผลกระทบแบบสุ่มต่อข้อผิดพลาดในการจัดวางรูปแบบจึงมีความสำคัญ ดังที่ได้เปิดเผยไว้แล้วในการอ้างอิง 1 เกินสเป็คโอเวอร์เลย์ 1 นาโนเมตรอย่างง่ายดาย ปริมาณการดูดซึมที่ต่ำกว่าดูเหมือนจะแย่ลงอย่างเห็นได้ชัด (รูปที่ 3)

รูปที่ 3 ข้อผิดพลาดในการจัดวางสุ่ม (เฉพาะ X) ของเสากลางในเซลล์หน่วยขนาด 38 นาโนเมตร x 66 นาโนเมตร (ระยะห่างของเส้นคำ = 33 นาโนเมตร) โดยคาดว่าจะมีการส่องสว่างแบบหกเหลี่ยมในระบบ 0.33 NA EUV ในที่นี้มีการแสดงตัวอย่างที่แตกต่างกัน 25 รายการสำหรับปริมาณที่ดูดซึมสองครั้ง
ไปที่ 0.55 NA เพิ่มปัญหาของความลึกของโฟกัสที่ลดลงอย่างมาก ค่า NA 0.55 จะส่งผลให้เกิดการเบลอ 15 นาโนเมตร ซึ่งนำไปสู่การเปลี่ยนเฟส >50 องศาระหว่างคำสั่งการเลี้ยวเบนด้านในสุดและด้านนอกสุด (รูปที่ 4) ซึ่งทำให้คอนทราสต์ของภาพลดลงอย่างมากเนื่องจากการซีดจาง [3]
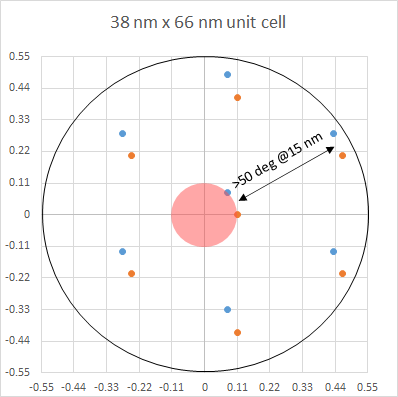
รูปที่ 4 ระยะพร่ามัว 15 นาโนเมตรบนระบบ 0.55 NA EUV ทำให้เกิดการเลื่อนเฟส >50 องศาระหว่างคำสั่งการเลี้ยวเบนด้านในสุดและด้านนอกสุด
ดังนั้นจึงเป็นไปได้ว่ารูปแบบโหนดหน่วยเก็บข้อมูลจำเป็นต้องเกิดขึ้นจากรูปแบบเส้นสองเส้นที่ตัดกัน (รูปที่ 5) รูปแบบเส้นที่ตัดกันแต่ละรูปแบบสามารถเกิดขึ้นได้จากการเปิดรับแสงครั้งเดียวของ EUV หรือโดย DUV SAQP (การสร้างรูปแบบสี่เท่าในแนวเดียวกัน) ตัวเลือกทั้งสองเป็นกระบวนการมาสก์เดียว กระบวนการ SAQP นั้นสมบูรณ์กว่า (มี EUV นำหน้ามานาน) และปราศจากความกังวลสุ่มอิเล็กตรอนทุติยภูมิของ EUV [4] ดังนั้นจึงควรเป็นที่ต้องการ อย่างไรก็ตาม สำหรับกรณี SAQP เส้นสเปเซอร์จะต้องมีการควบคุมอย่างดีทั้งในแง่ของตำแหน่งและความขรุขระของเส้น [5]

รูปที่ 5 รูปแบบโหนดหน่วยเก็บข้อมูลสามารถเกิดขึ้นได้จากจุดตัดของรูปแบบเส้นสองเส้นที่ตัดกัน
แทนที่จะใช้ SAQP แบบเส้น ซัมซุงยังแสดงรูปแบบรังผึ้งสเปเซอร์แบบ 2 มิติ [6] โดยใช้มาสก์เดียวที่มีรูปแบบรังผึ้งเริ่มต้น แทนที่จะใช้มาสก์สองตัวที่มีรูปแบบเส้นเริ่มต้น
ในขณะที่กรณีข้างต้นพิจารณาระยะพิตช์บรรทัดบิต 38 นาโนเมตรและพิตช์บรรทัดคำ 33 นาโนเมตร มันก็ใช้กับกรณีที่สลับพิตช์ (พิตช์บรรทัดบิต 33 นาโนเมตรและพิตช์บรรทัดคำ 38 นาโนเมตร) เนื่องจากสมมาตรหกเหลี่ยม
อ้างอิง
[1] W. Gao et al., Proc. SPIE 11323, 113231L (2020)
[2] F. Chen, ความสัมพันธ์ตรีโกณมิติระหว่าง DRAM Cell Pitches, https://www.youtube.com/watch?v=Oq6b-6iw6Zk
[3] จฮ. Franke, TA Brunner, E. Hendrickx, J. Micro/Nanopattern แม่ เมโทรล. 21, 030501 (2022).
[4] F. Chen, ความสุ่มของอิเล็กตรอนเบลอทุติยภูมิเป็นต้นกำเนิดของ EUV Stochastic Defects, https://www.linkedin.com/pulse/secondary-electron-blur-randomness-origin-euv-stochastic-chen/
[5] N. Bae et al., Proc. SPIE 11615, 116150B (2021)
[6] JM Park et al., IEDM 2015.
บทความนี้ปรากฏครั้งแรกใน LinkedIn Pulse: การพิมพ์หินเฉพาะแอปพลิเคชัน: Sub-0.0013 um2 DRAM Storage Node Patterning
แชร์โพสต์นี้ผ่าน:
- เนื้อหาที่ขับเคลื่อนด้วย SEO และการเผยแพร่ประชาสัมพันธ์ รับการขยายวันนี้
- เพลโตบล็อคเชน Web3 Metaverse ข่าวกรอง ขยายความรู้. เข้าถึงได้ที่นี่.
- ที่มา: https://semiwiki.com/lithography/323357-application-specific-lithography-sub-0-0013-um2-dram-storage-node-patterning/
- 1
- 2020
- 2021
- 2022
- 9
- a
- ข้างบน
- คล่องแคล่ว
- ที่เพิ่ม
- เพิ่ม
- แล้ว
- ในหมู่
- และ
- ปรากฏ
- การใช้งาน
- เฉพาะแอปพลิเคชัน
- เข้าใกล้
- AREA
- จัด
- แถว
- บทความ
- ด้านล่าง
- ระหว่าง
- เกิน
- บิต
- เบลอ
- กรณี
- ส่วนกลาง
- ความท้าทาย
- เฉิน
- ส่วนประกอบ
- ความกังวลเกี่ยวกับ
- ถือว่า
- พิจารณา
- ตรงกันข้าม
- ข้าม
- แสดงให้เห็นถึง
- ทั้งนี้ขึ้นอยู่กับ
- ความลึก
- ออกแบบ
- แน่นอน
- ต่าง
- ทิศทาง
- แต่ละ
- อย่างง่ายดาย
- ขอบ
- ผล
- ความผิดพลาด
- แม้
- เคย
- ที่คาดหวัง
- การเปิดรับ
- ลักษณะ
- รูป
- สุดท้าย
- ชื่อจริง
- โฟกัส
- ที่เกิดขึ้น
- ฟรี
- ราคาเริ่มต้นที่
- GAO
- Go
- ตะแกรง
- มี
- โปรดคลิกที่นี่เพื่ออ่านรายละเอียดเพิ่มเติม
- ตามแนวนอน
- HTTPS
- ภาพ
- in
- แทน
- การตัด
- ปัญหา
- IT
- แบบ
- นำ
- ชั้นนำ
- นำไปสู่
- น่าจะ
- Line
- เส้น
- นาน
- หน้ากาก
- มาสก์
- เป็นผู้ใหญ่
- ความกว้างสูงสุด
- ข้อมูลเพิ่มเติม
- ความต้องการ
- ปม
- โหนด
- สัญญาณรบกวน
- ต่อเนื่อง
- Options
- คำสั่งซื้อ
- ที่มา
- อื่นๆ
- สวนสาธารณะ
- ในสิ่งที่สนใจ
- แบบแผน
- รูปแบบ
- ระยะ
- เสา
- ขว้าง
- โหมโรง
- เพลโต
- เพลโตดาต้าอินเทลลิเจนซ์
- เพลโตดาต้า
- โพสต์
- ที่ต้องการ
- PROC
- กระบวนการ
- กระบวนการ
- ก่อ
- ที่คาดการณ์
- ชีพจร
- สุ่ม
- ถึง
- แนะนำ
- ลดลง
- ลด
- ความสัมพันธ์
- รายงาน
- ผล
- ส่งผลให้
- กฎ
- ซัมซุง
- รอง
- ชุด
- เปลี่ยน
- น่า
- โชว์
- แสดง
- สำคัญ
- เดียว
- ขนาด
- ขนาด
- มีขนาดเล็กกว่า
- So
- โดยเฉพาะ
- ที่เริ่มต้น
- ยังคง
- การเก็บรักษา
- เป็นกอบเป็นกำ
- ระบบ
- เงื่อนไขการใช้บริการ
- พื้นที่
- ดังนั้น
- ไปยัง
- ภายใต้
- หน่วย
- ใช้
- การใช้ประโยชน์
- ความคุ้มค่า
- ผ่านทาง
- W
- ว่า
- ที่
- จะ
- คำ
- จะ
- X
- YouTube
- ลมทะเล









