Na IEDM 2023 Naoto Horiguchi przedstawił CFET i integrację Middle of Line. Miałem okazję porozmawiać z Naoto na temat tej pracy, a niniejszy opis opiera się na jego prezentacji na IEDM i naszej dyskusji. Zawsze lubię rozmawiać z Naoto. Jest on jednym z liderów w rozwoju technologii logicznych, wyjaśnia technologię w łatwy do zrozumienia sposób, jest responsywny i łatwy w obsłudze.
Dlaczego potrzebujemy CFET
Ponieważ skalowanie CMOS przeszło ze skalowania opartego wyłącznie na skoku do skalowania opartego na skoku i skalowaniu na podstawie ścieżki, konieczne stało się usuwanie populacji żeberek, patrz rysunek 1. Każde zmniejszenie liczby żeber zmniejsza wydajność.
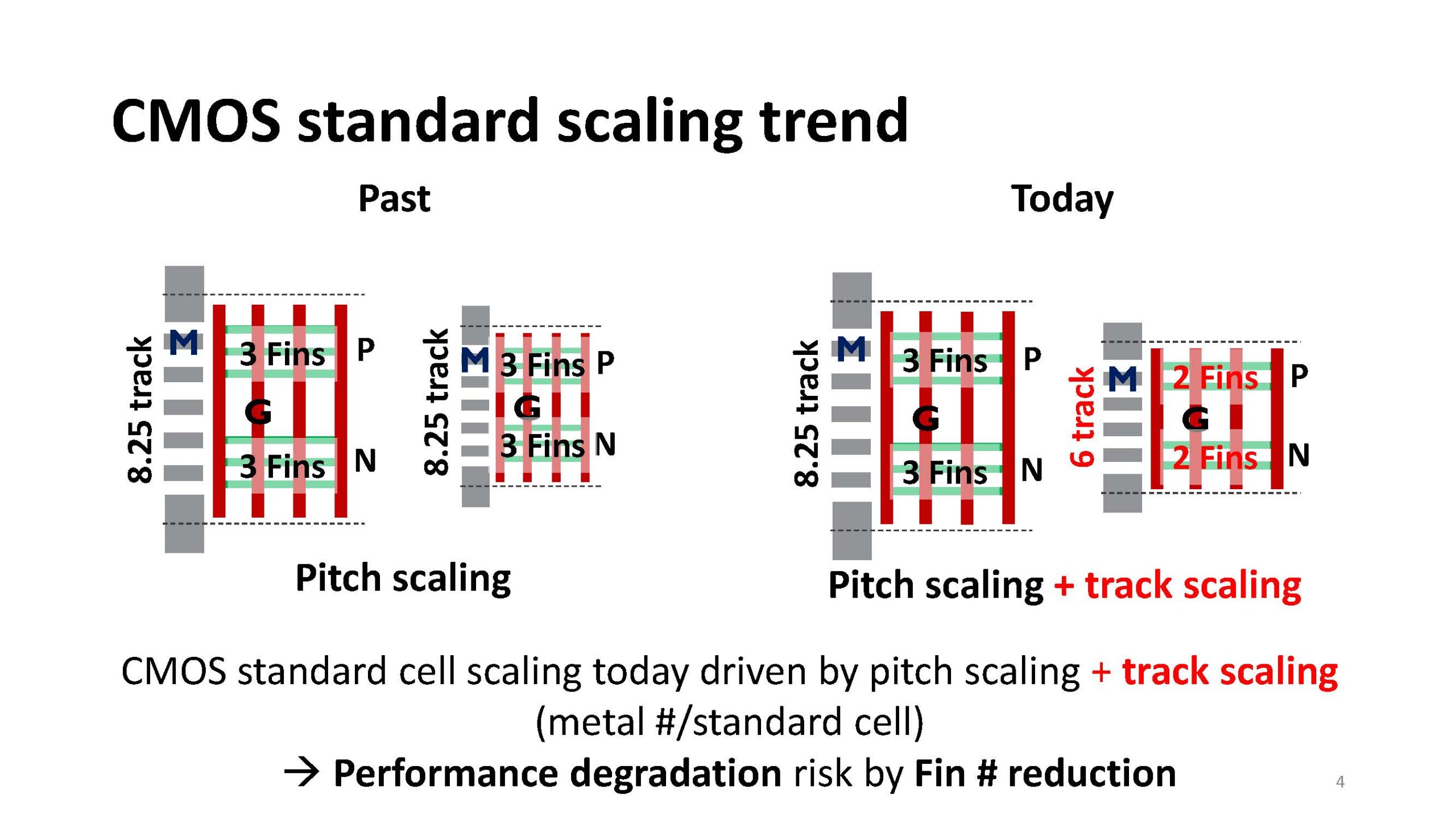
Przechodząc z FinFEts na stosy HWydajność poziomych nanoarkuszów (HNS) można poprawić/odzyskać poprzez szersze stosy nanoarkuszów i ułożenie wielu nanoarkuszów w pionie, patrz rysunek 2.
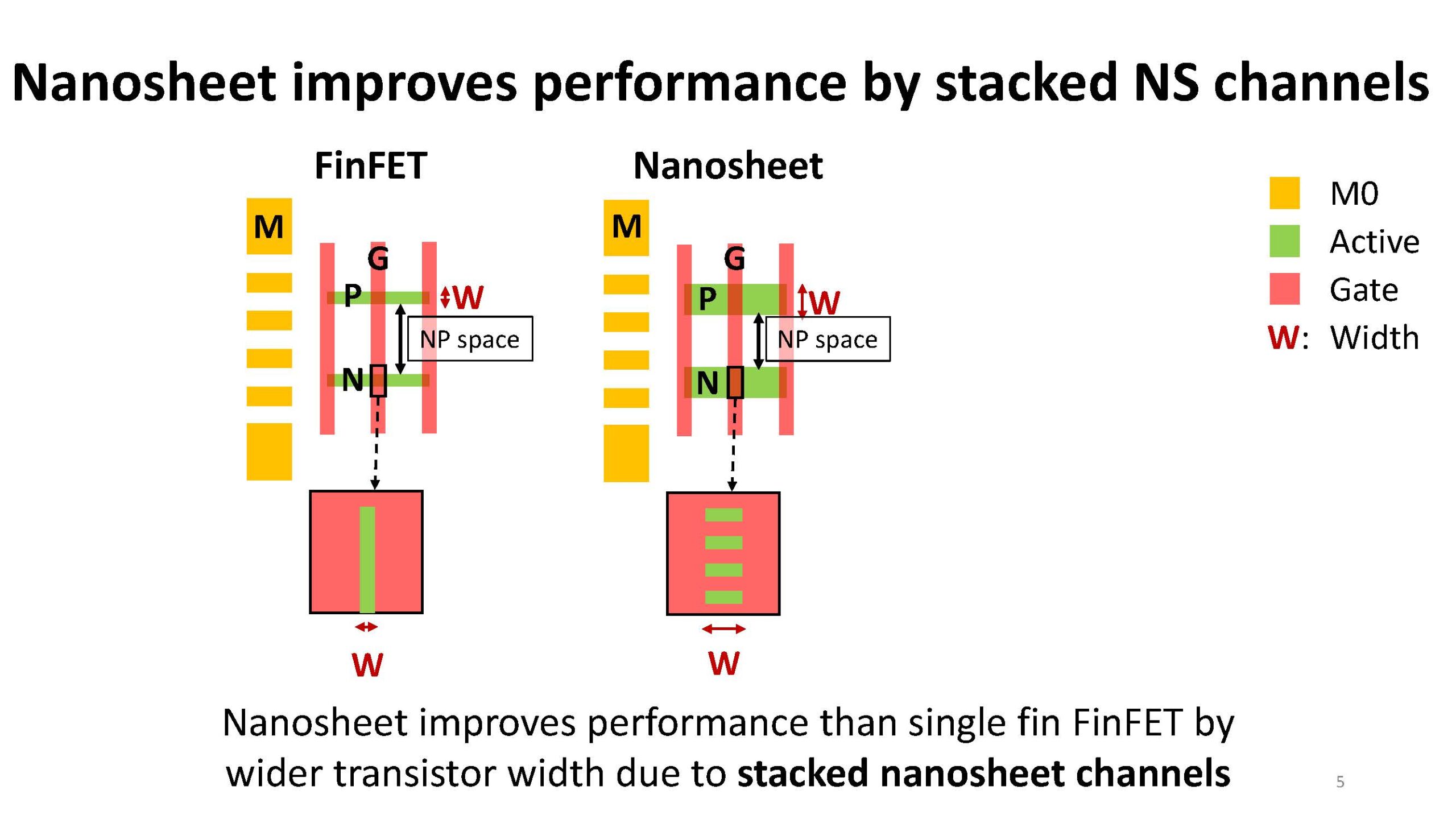
Ale jak widzieliśmy w przypadku skalowania nanoarkuszów FinFET ostatecznie prowadzi do zmniejszonej wydajności, patrz rysunek 3.
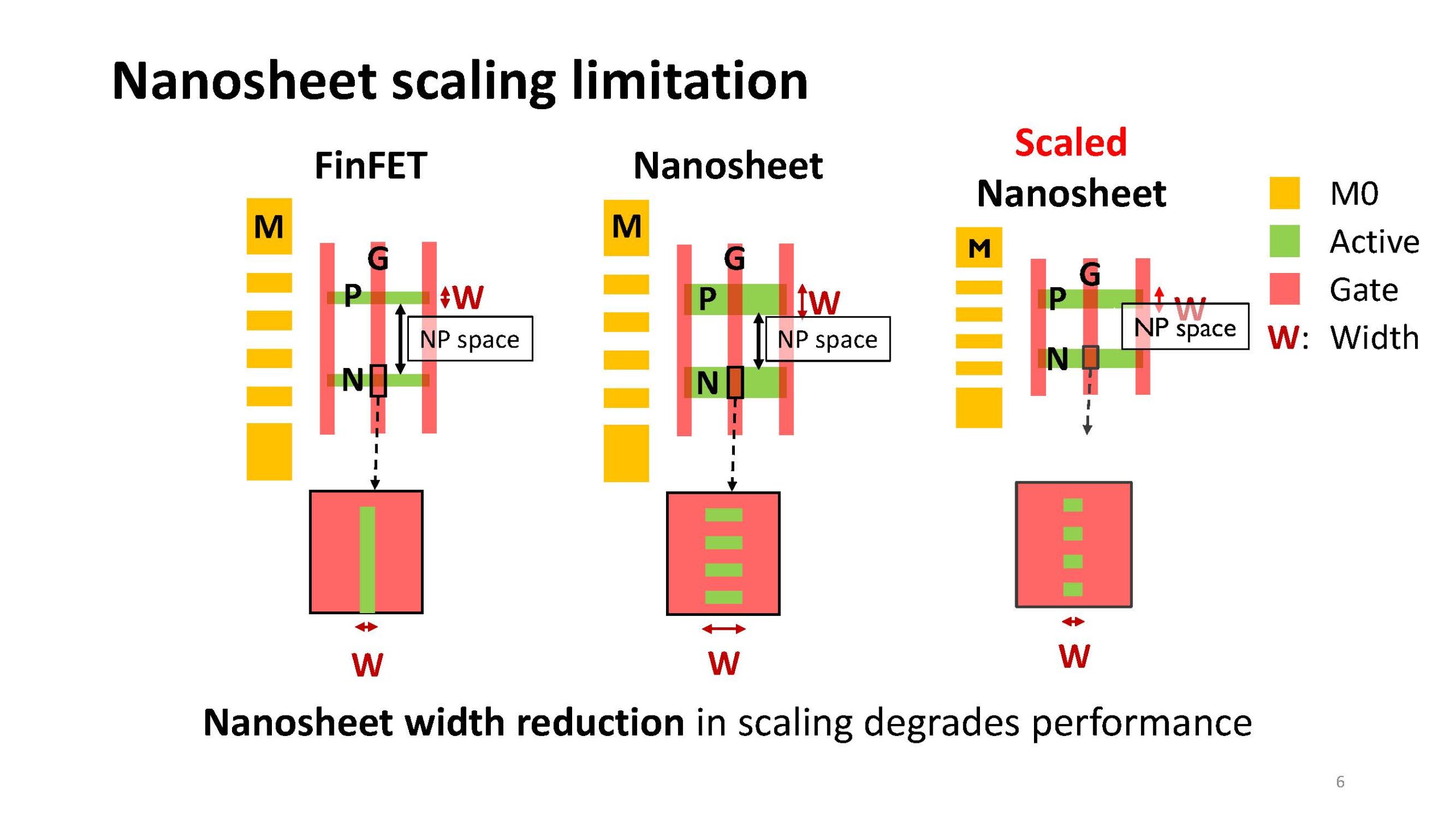
CFET (komplementarne FET) łączą nFET i pFET, patrz rysunek 4.
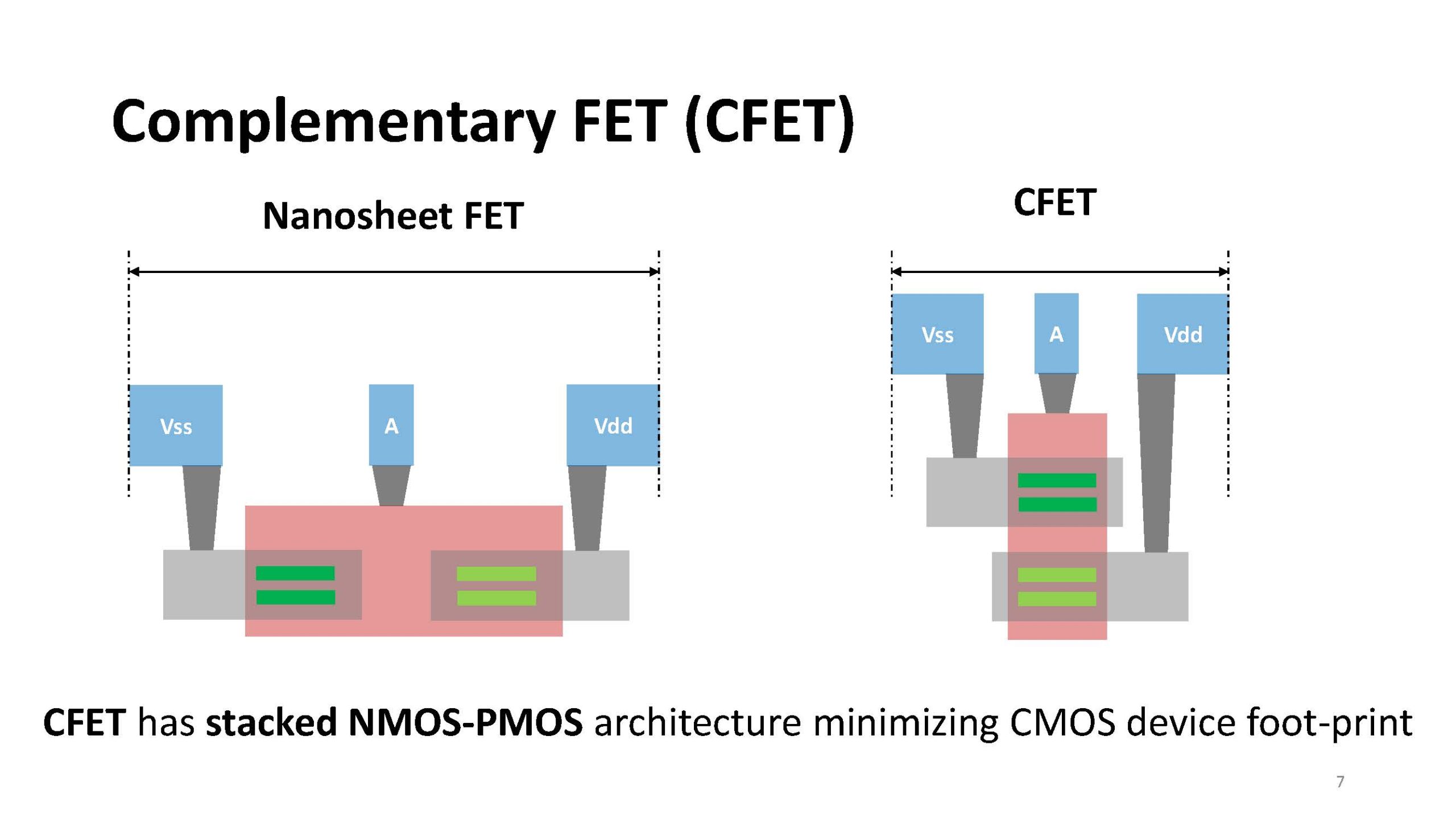
CFET po raz kolejny resetują ograniczenia skalowania, ponieważ nFET i pFET są ułożone w stos, a odstępy np między urządzeniami stają się pionowe, a nie poziome, co umożliwia szersze arkusze, patrz rysunek 5.
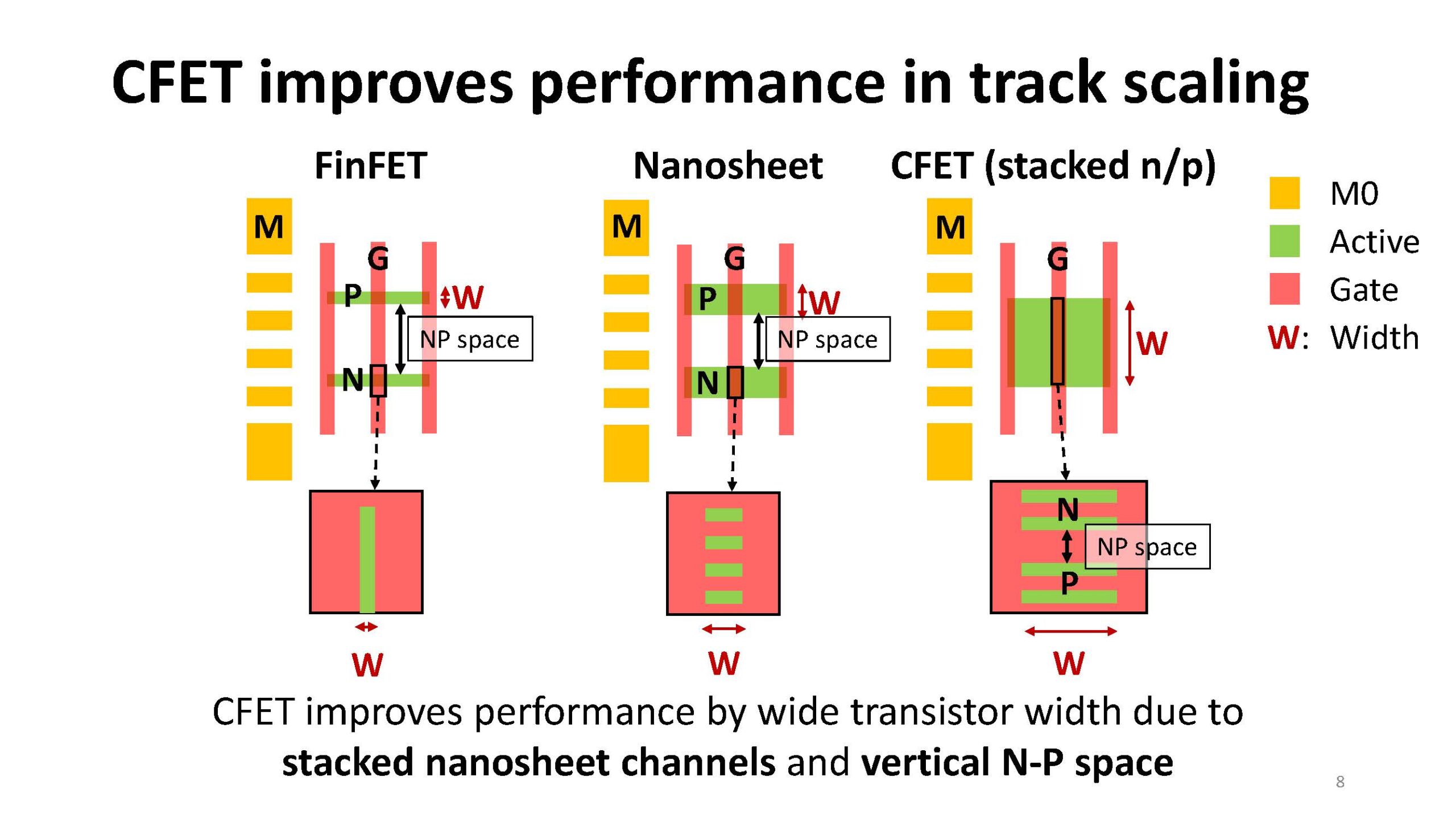
Rysunek 6 przedstawia porównanie wydajności HNS i CFET z wysokością komórki, podkreślając przewagę CFET.
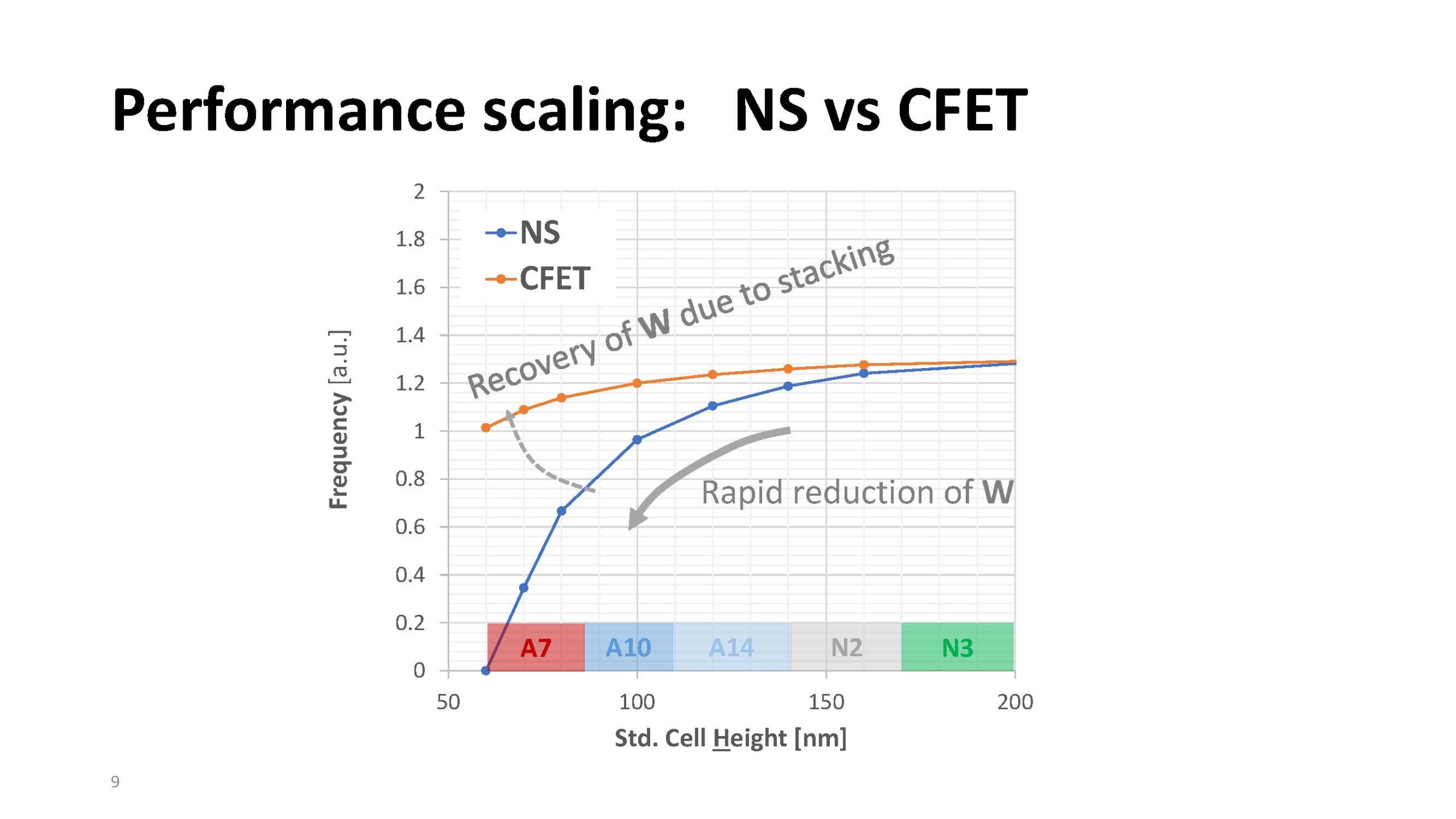
Monolityczny kontra sekwencyjny CFET
Istnieją dwa zasadniczo różne podejścia do wytwarzania CFET. W przepływie monolitycznym CFET są wytwarzane na płytce w ciągłym przebiegu procesu. W przepływie sekwencyjnym dolne urządzenie jest wytwarzane na jednej płytce, następnie druga płytka jest łączona z pierwszą płytką, a górne urządzenie jest wytwarzane na drugiej płytce.
W przepływie sekwencyjnym pomiędzy dwoma urządzeniami występuje dielektryk wiążący, patrz rysunek 7.
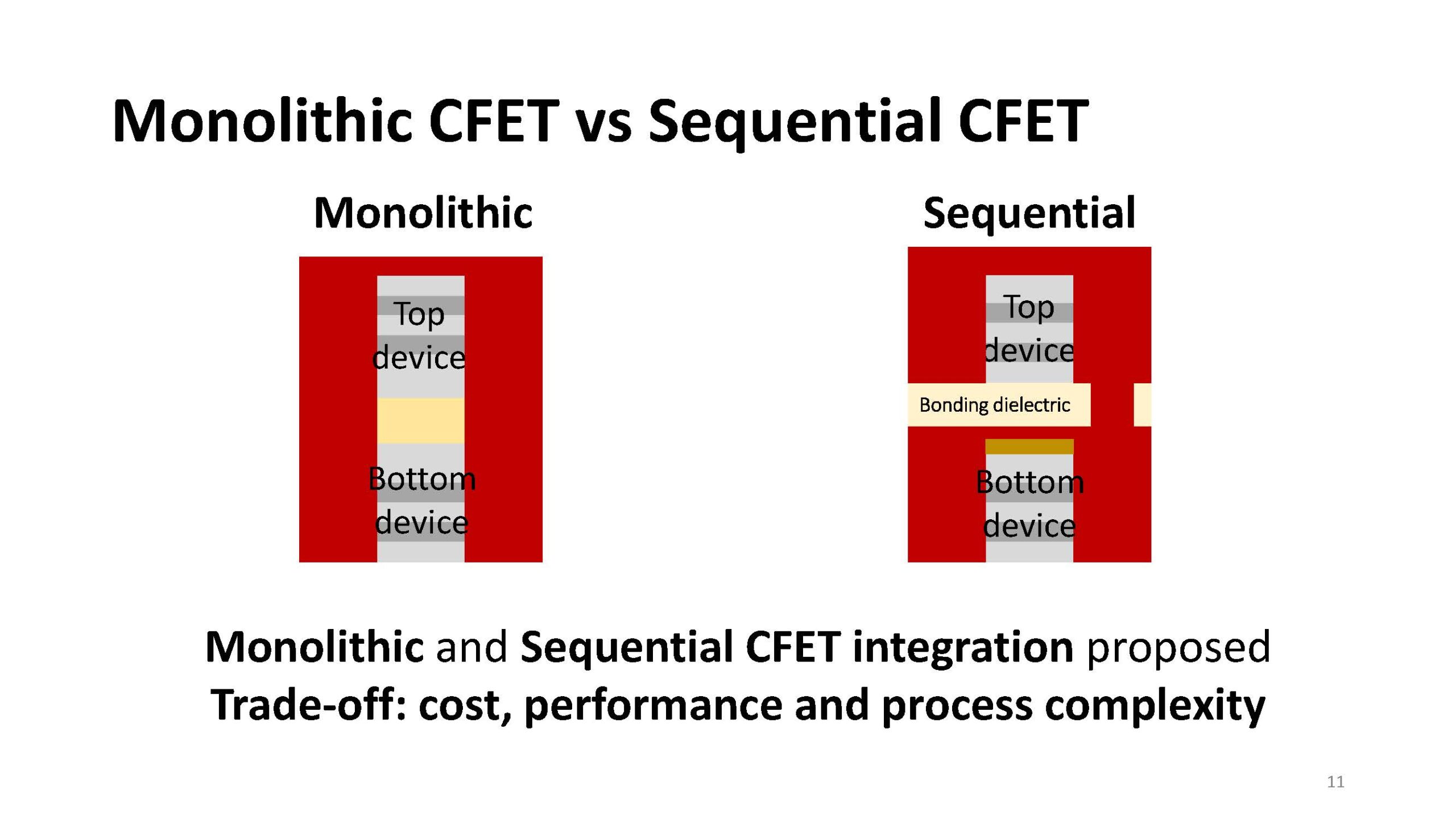
Ze względu na dielektryk wiążący konstrukcja jest wyższa i ma większy spadek pojemności, patrz rysunek 8.
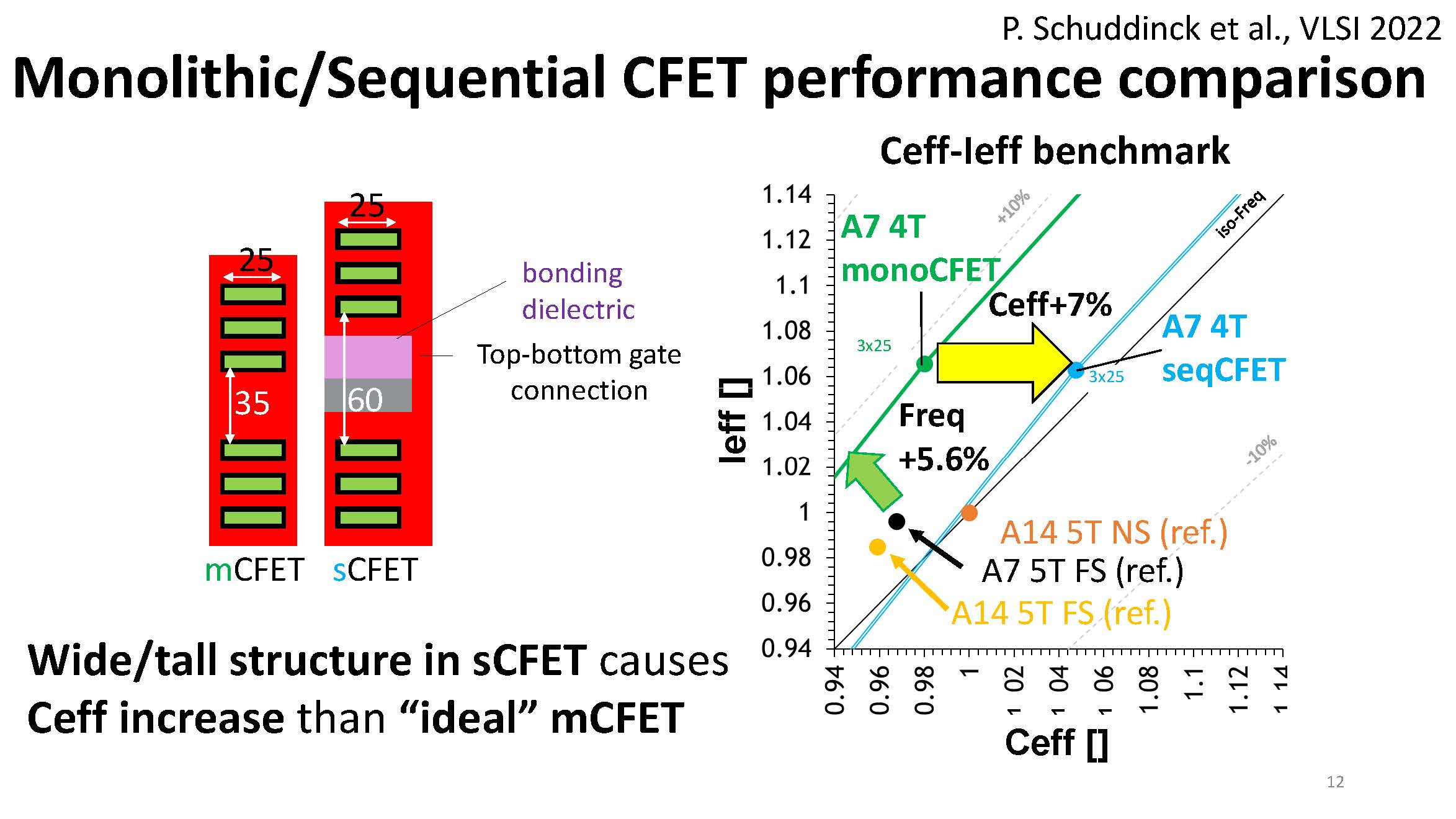
Sekwencyjne CFET są droższe w produkcji niż monolityczne CFET, a poza tym i pogorszeniem wydajności wydaje się, że przemysł koncentruje się na monolitycznych CFET.
Monolityczne przetwarzanie CFET
Monolityczny proces CFET przedstawiono na rysunku 9.
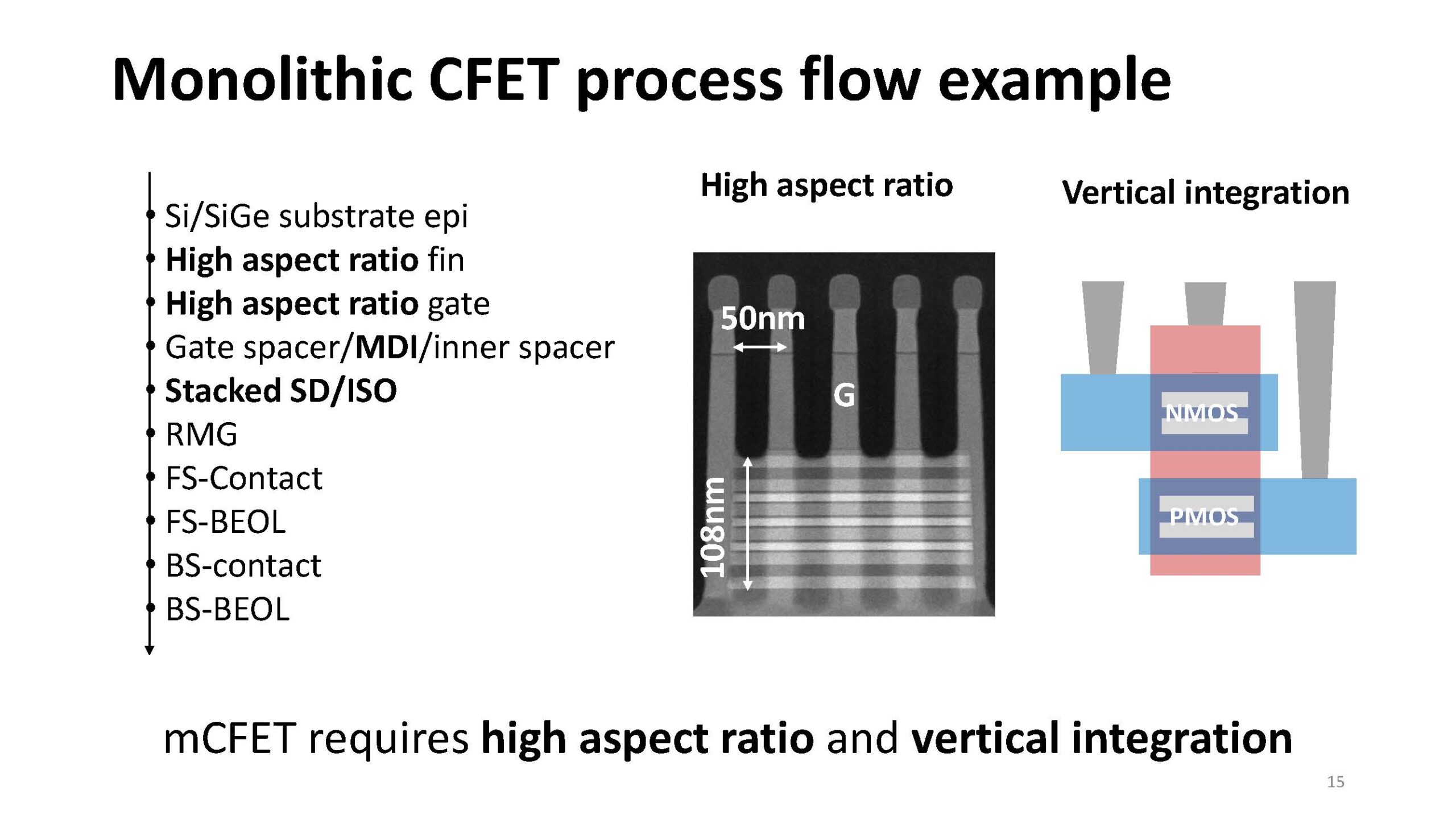
Kroki zaznaczone pogrubioną czcionką są szczególnie trudne:
- Poziome stosy nanoarkuszów (płetwy) mają już wysoki współczynnik kształtu, więc aby utworzyć CFET, należy ułożyć stosy nFET i pFET jeden na drugim, tworząc stosunkowo grubą warstwę pomiędzy ponad dwukrotnie większą wysokością.
- Formacja bramy ma również wysoki współczynnik kształtu, jak opisano w poprzednim punkcie.
- Źródło/dreny epitaksjalne muszą być odizolowane od siebie w pionie.
- Nie zostało to wyraźnie zaznaczone, dolne źródło/dren urządzenia jest wytwarzane, a następnie górne źródło/dren urządzenia. Obróbkę cieplną górnego urządzenia i kolejne etapy należy przeprowadzić w wystarczająco niskich temperaturach, aby nie uszkodzić dolnego urządzenia.
Szczególnie interesującą częścią tej prezentacji była część dotycząca izolacji środkowej dielektryka (MDI). Nie widziałem wcześniej tego problemu. MDI potwierdza wewnętrzną przekładkę i wzór materiału roboczego (WFM).
Rysunek 10 ilustruje wpływ MDI na tworzenie się wewnętrznej przekładki (lewa strona) i wzór WFM (prawa strona).
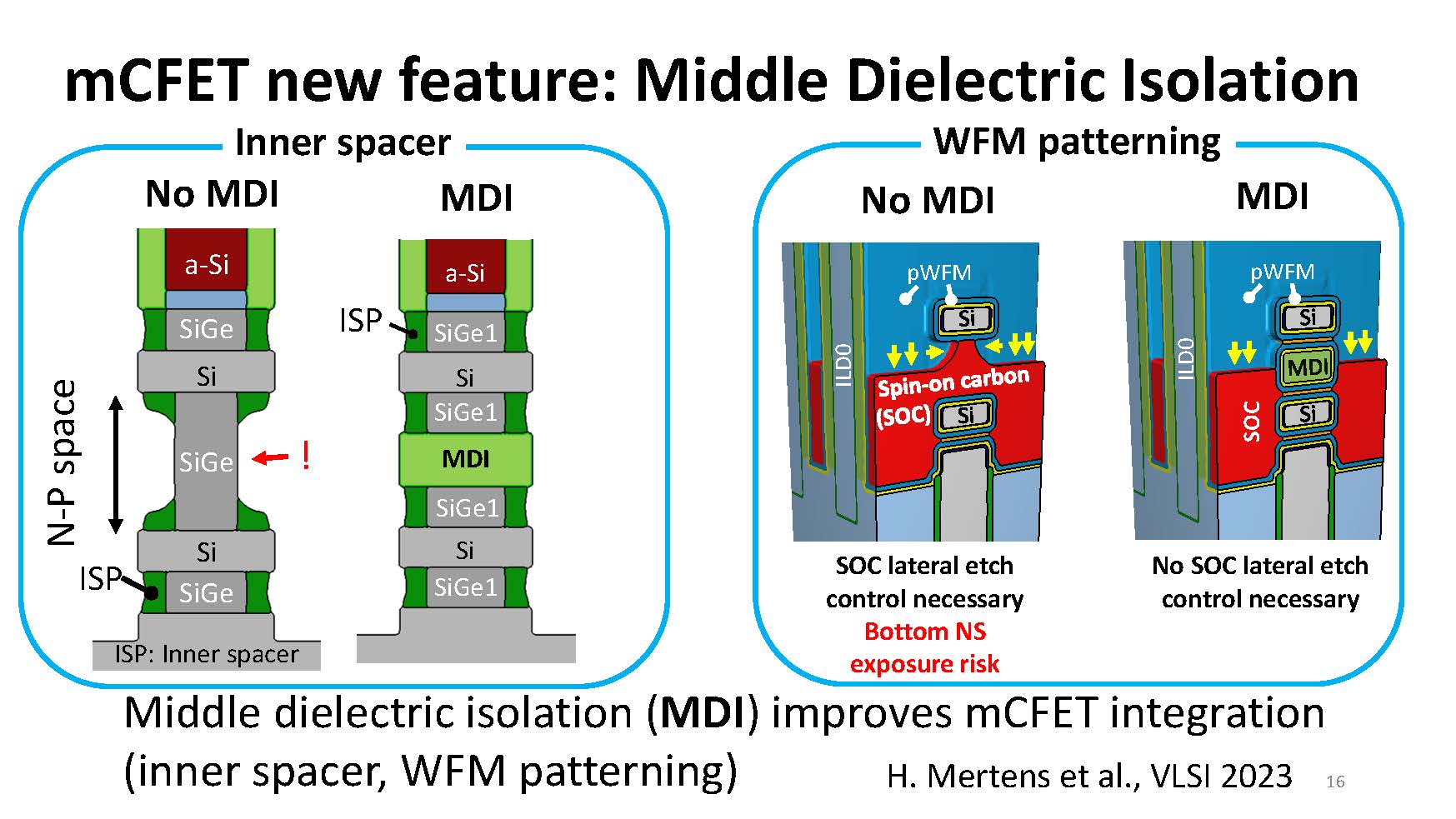
Rysunek 11 ilustruje przebieg integracji MDI.

Całkując MDI, można zwiększyć pionowe odstępy między nFET i pFET bez wpływu na tworzenie wewnętrznego elementu dystansującego.
Jak wspomniano wcześniej, wytwarzane jest dolne źródło/odpływ urządzenia, a następnie wytwarzane jest górne źródło/odpływ urządzenia. Po uformowaniu dolnego źródła/drenu, osadza się dielektryk izolacyjny i ponownie go trawi, aby odsłonić górne urządzenie dla powstania epitaksjalnego źródła/drenu. Wytrawianie izolacji należy kontrolować za pomocą wysokości MDI, patrz rysunek 12.
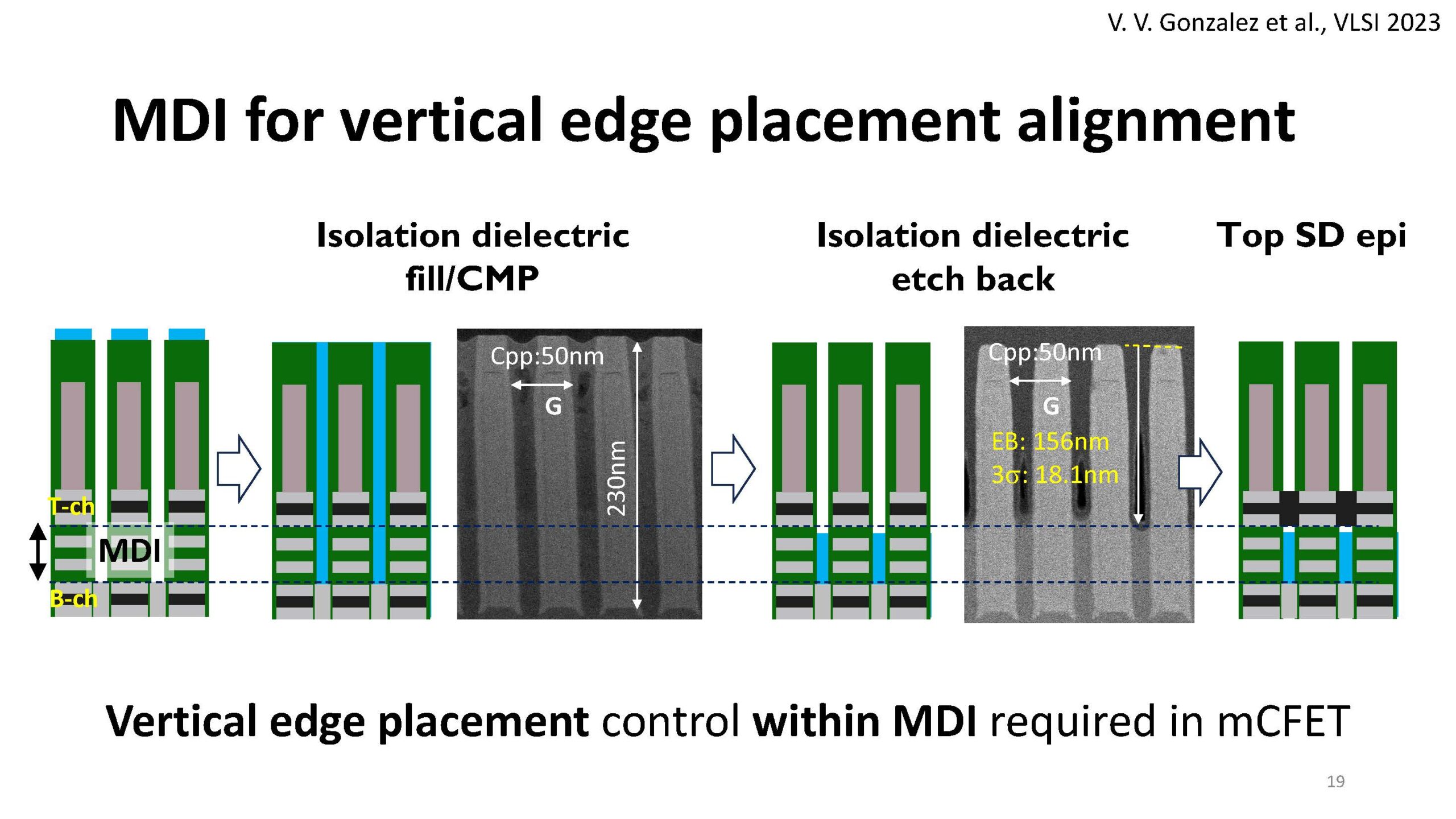
Aby zminimalizować degradację termiczną wydajności urządzenia, nowe opcje WFM z obróbką dipolową i bez procesów wyżarzania i tworzenia międzywarstw w niskiej temperaturze, patrz rysunek 13.
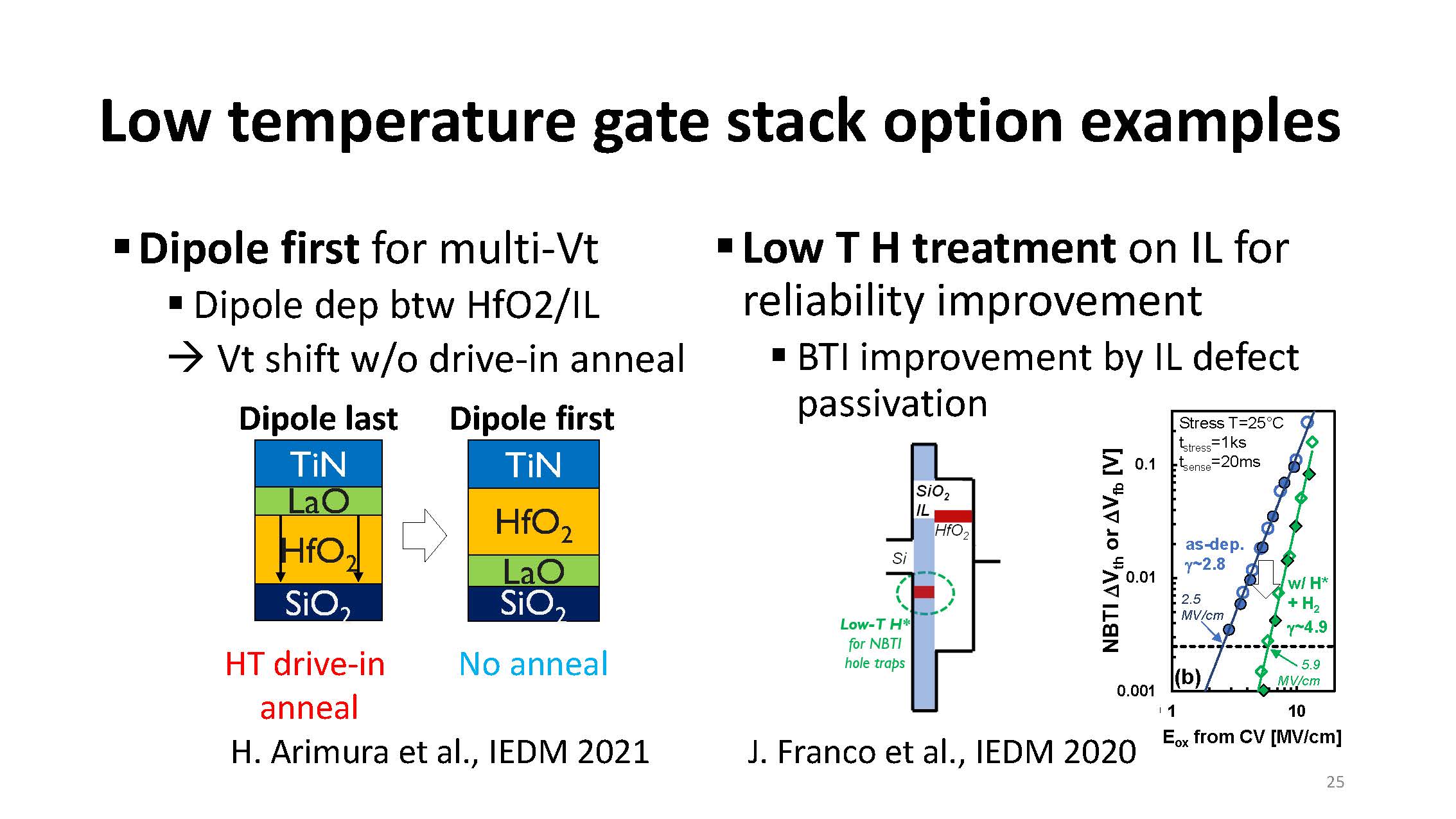
Do tworzenia kontaktu potrzebne są także niskotemperaturowe źródła/odpływy i niskotemperaturowe krzemki, patrz rysunek 14.

Krzemek niskotemperaturowy będzie szczególnie ważny w przypadku bezpośredniego kontaktu tylnej części z dolnym urządzeniem. Interkonekt CFET wymaga styków z dolnym i górnym urządzeniem, a wraz z pojawieniem się tylnego zasilania, górne urządzenie będzie połączone ze stosem wzajemnych połączeń z przodu, a dolne urządzenie będzie połączone z tyłu. Molibden (Mo) i niob (Nb) są obiecujące dla pFET, a skand (Sc) jest obiecujący dla nFET, chociaż Sc jest trudny do osadzenia w ALD.
Połączenie tylne i środkowe linii
Tak jak pisałem o tym wcześniej tutaj Oczekuje się, że sieć Back Side Power Delivery Network (BSPDN) zostanie wprowadzona w tym roku przez firmę Intel, firmę Samsung i TSMC w 2026 r. Podział połączeń wzajemnych na złącza sygnałowe z przodu i złącza zasilania z tyłu zmniejsza spadek podczerwieni (utratę mocy) o rząd wielkości, patrz rysunek 15.
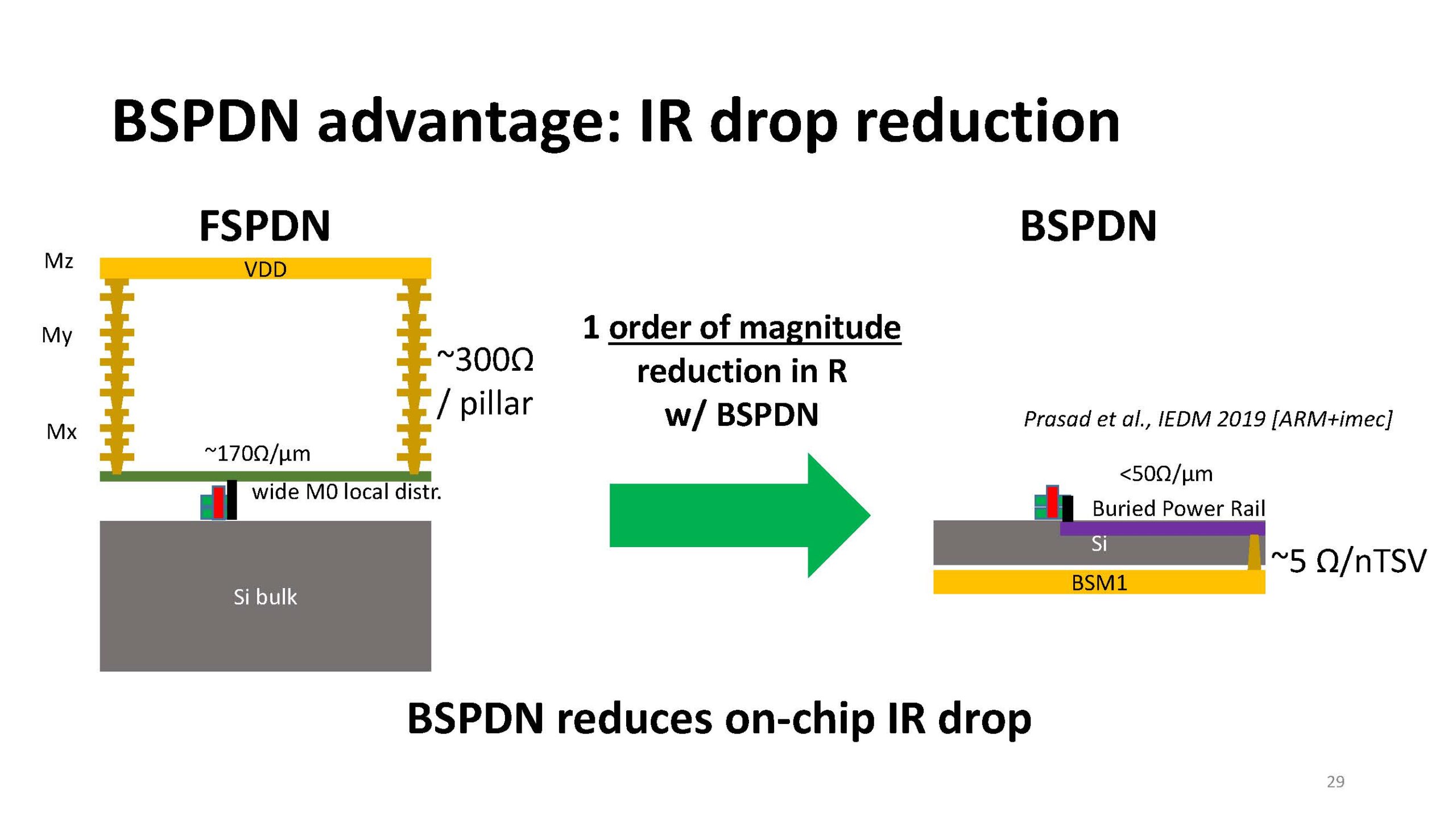
BSPDN poprawia także skalowanie ścieżek, umożliwiając redukcję komórki 6-ścieżkowej do 5-ścieżkowej, patrz rysunek 16.
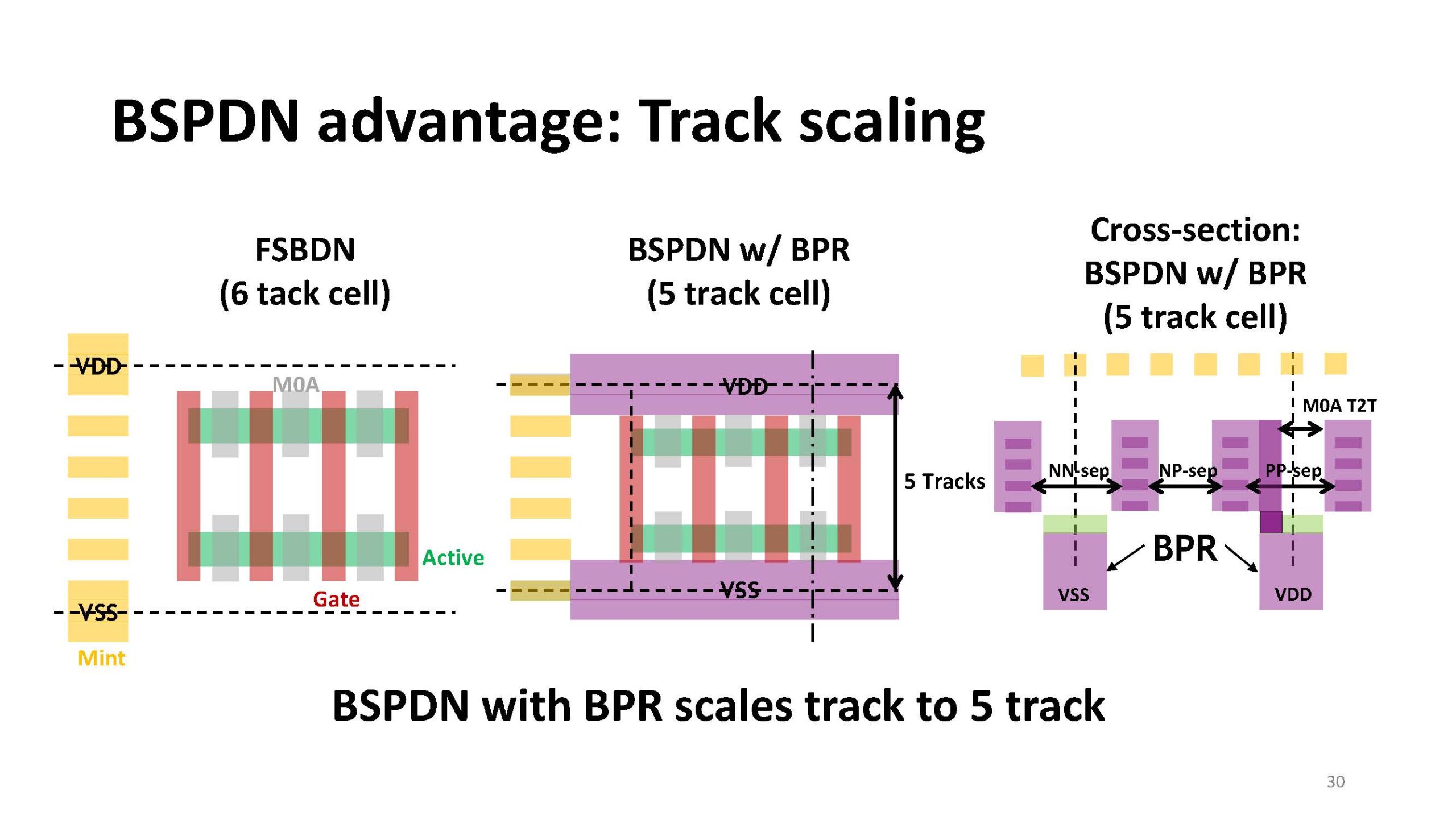
Integracja BSPDN z CFET może zapewnić redukcję mocy o 20% do 40% w porównaniu z nanoarkuszami ułożonymi poziomo (HNS), patrz rysunek 17.

Aby wyjść poza komórkę 5-ścieżkową i przekształcić ją w komórkę 4-ścieżkową, należy pokonać wyzwania związane z wzajemnymi połączeniami, patrz rysunek 18.

Układ pionowo-poziomo-pionowy z dodatkowymi warstwami środka linii (MOL) umożliwia tworzenie komórek 4-ścieżkowych, patrz rysunek 19.
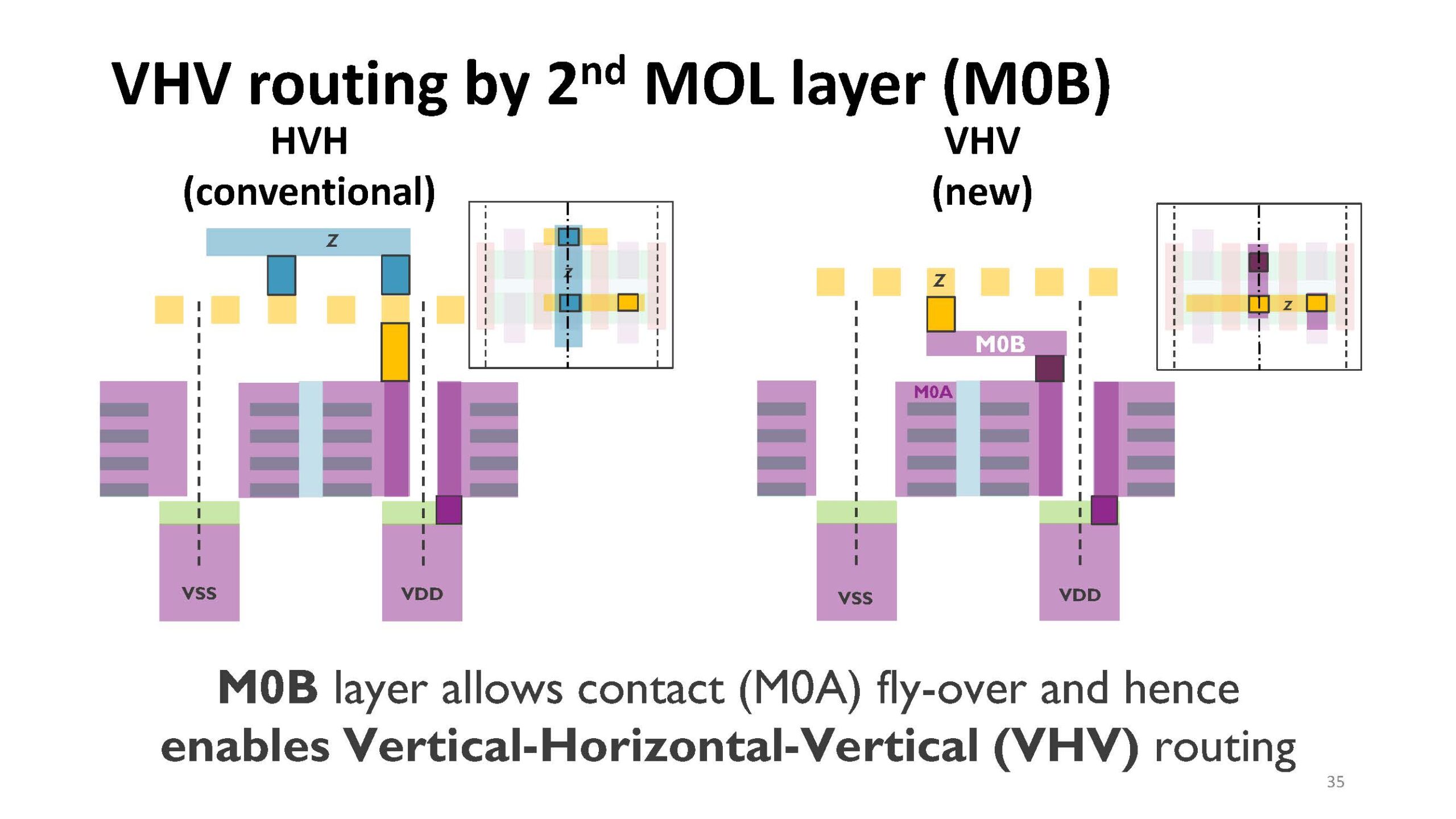
O pracy Imeca w tym obszarze pisałem już wcześniej tutaj więc nie będę powtarzał tej informacji.
Zapytałem Naoto, czego potrzeba, aby przejść poza komórkę 4-ścieżkową do komórki 3-ścieżkowej, odpowiedział, że Imec pracuje teraz nad tą optymalizacją i że może wymagać dodatkowych warstw MOL i ewentualnie połączenia od góry do dołu obok urządzenie, które miałoby wpływ na standardowy układ komórek.
Zapytałem także Naoto, kiedy jego zdaniem możemy spodziewać się wdrożenia CFET, i odpowiedział, że prawdopodobnie będzie to generacja logiki A10 lub generacja A7.
Autorzy zauważają, że Intel, Samsung i TSMC opublikowały w tym roku prace dotyczące CFET na IEDM, a zarówno Intel, jak i TSMC posiadają mapy opcji technologicznych pokazujące, że FinFET ustępują miejsca HNS, a następnie CFET.
Wnioski
Imec w dalszym ciągu wykazuje doskonały postęp w rozwoju CFET jako opcji nowej generacji, po HNS. W pracy opisano wszystkie opcje integracji urządzeń oraz opcje BSPDN i MOL.
Przeczytaj także:
IEDM 2023 – Modelowanie emisji dwutlenku węgla w fabryce płytek 300 mm
Aktualizacja ASML SEMICON West 2023
Udostępnij ten post przez:
- Dystrybucja treści i PR oparta na SEO. Uzyskaj wzmocnienie już dziś.
- PlatoData.Network Pionowe generatywne AI. Wzmocnij się. Dostęp tutaj.
- PlatoAiStream. Inteligencja Web3. Wiedza wzmocniona. Dostęp tutaj.
- PlatonESG. Węgiel Czysta technologia, Energia, Środowisko, Słoneczny, Gospodarowanie odpadami. Dostęp tutaj.
- Platon Zdrowie. Inteligencja w zakresie biotechnologii i badań klinicznych. Dostęp tutaj.
- Źródło: https://semiwiki.com/semiconductor-services/340811-iedm-2023-imec-cfet/
- :ma
- :Jest
- :nie
- $W GÓRĘ
- 06
- 07
- 08
- 09
- 1
- 10
- 11
- 12
- 13
- 14
- 15%
- 16
- 17
- 19
- 2023
- 2026
- 25
- 26
- 29
- 30
- 32
- 35%
- 7
- 8
- 9
- a
- O nas
- dodatek
- Dodatkowy
- Korzyść
- nadejście
- Po
- ponownie
- Wszystkie kategorie
- już
- również
- Chociaż
- zawsze
- an
- i
- pojawia się
- awanse
- SĄ
- POWIERZCHNIA
- AS
- aspekt
- At
- z powrotem
- na podstawie
- BE
- bo
- stają się
- staje się
- być
- zanim
- pomiędzy
- Poza
- obie
- Dolny
- by
- wezwanie
- nazywa
- CAN
- węgiel
- komórka
- Komórki
- wyzwania
- wyzwanie
- szansa
- porównanie
- uzupełniający
- połączenie
- połączenia
- Ograniczenia
- skontaktuj się
- łączność
- ciągły
- ciągły
- kontrolowanych
- dostawa
- kaucja
- zdeponowany
- opisane
- oprogramowania
- urządzenie
- urządzenia
- różne
- kierować
- dyskusja
- do
- zrobić
- podwojenie
- Spadek
- każdy
- łatwo
- krawędź
- efekt
- umożliwiać
- Umożliwia
- cieszyć się
- dość
- ostatecznie
- doskonała
- spodziewany
- drogi
- Objaśnia
- wyraźnie
- FET
- Postać
- płetwa
- finał
- FINS
- i terminów, a
- pływ
- koncentruje
- obserwuj
- W razie zamówieenia projektu
- formacja
- od
- z przodu
- funkcjonować
- zasadniczo
- brama
- generacja
- Dający
- Go
- Wzrost
- miał
- Ciężko
- Have
- he
- wysokość
- Wysoki
- wyższy
- podświetlanie
- jego
- Poziomy
- HTTPS
- Huawei
- i
- ilustruje
- Rezultat
- wpływ
- realizowane
- ważny
- ulepszony
- poprawia
- in
- wzrosła
- przemysł
- Informacja
- wewnętrzny
- zamiast
- Integracja
- integracja
- Intel
- ciekawy
- najnowszych
- przedstawiać
- odosobniony
- izolacja
- problem
- IT
- jpg
- warstwa
- nioski
- układ
- Przywódcy
- Wyprowadzenia
- lewo
- Linia
- logika
- od
- niski
- robić
- Mapy
- kolega
- materiał
- Maksymalna szerokość
- Może..
- wzmiankowany
- Środkowy
- może
- zminimalizować
- modelowanie
- MOL
- Monolityczny
- jeszcze
- przeniesienie
- wielokrotność
- musi
- niezbędny
- Potrzebować
- potrzebne
- sieć
- Nowości
- Następny
- Nie
- noty
- już dziś
- numer
- of
- on
- pewnego razu
- ONE
- optymalizacja
- Option
- Opcje
- or
- zamówienie
- Inne
- ludzkiej,
- na zewnątrz
- Przezwyciężać
- strona
- część
- szczególnie
- jest gwarancją najlepszej jakości, które mogą dostarczyć Ci Twoje monitory,
- Smoła
- umieszczenie
- plato
- Analiza danych Platona
- PlatoDane
- plus
- punkt
- możliwie
- Post
- power
- teraźniejszość
- presentation
- przedstawione
- prezenty
- poprzedni
- poprzednio
- Pro
- wygląda tak
- procesów
- przetwarzanie
- Postęp
- obiecujący
- dowodzi
- zapewniać
- opublikowany
- czysto
- stosunek
- Czytaj
- zmniejszyć
- Zredukowany
- zmniejsza
- redukcja
- stosunkowo
- powtarzać
- wymagać
- Wymaga
- czuły
- prawo
- Routing
- Powiedział
- Samsung
- SC
- skalowaniem
- druga
- widzieć
- widziany
- pokazać
- seans
- bok
- Signal
- So
- mówić
- stos
- ułożone w stos
- układanie w stosy
- Półki na książki
- standard
- Cel
- Struktura
- kolejny
- Wspierający
- Brać
- rozmawiać
- Technologia
- Rozwój technologii
- niż
- że
- Połączenia
- następnie
- termiczny
- to
- w tym roku
- myśl
- czas
- do
- Top
- śledzić
- przeniesiony
- TSMC
- drugiej
- Aktualizacja
- Przeciw
- pionowy
- pionowo
- przez
- vs
- była
- Droga..
- we
- DOBRZE
- Zachód
- Co
- jeśli chodzi o komunikację i motywację
- szerszy
- będzie
- w
- bez
- Praca
- pracujący
- by
- napisać
- napisany
- rok
- ty
- zefirnet