La poursuite de tailles de cellules DRAM toujours plus petites est toujours active et en cours. La taille des cellules DRAM devrait approcher 0.0013 um2 pour le nœud D12. Les défis de la structuration sont importants, que l'on considère l'utilisation de la lithographie DUV ou EUV. En particulier, ASML a signalé que lorsque les valeurs de centre à centre atteignaient 40 nm, la structuration unique ne serait pas recommandée même pour EUV [1]. Dans cet article, nous montrerons que pour le nœud DRAM 12 nm et au-delà, le centre à centre du condensateur devrait descendre en dessous de 40 nm, nécessitant donc un multipatterning.
Disposition des cellules DRAM pour les condensateurs de stockage
Les condensateurs de stockage sont disposés dans un réseau hexagonal (Figure 1). La règle de conception de la zone active est déterminée par le pas de la ligne de bit et le pas de la ligne de mot [2].
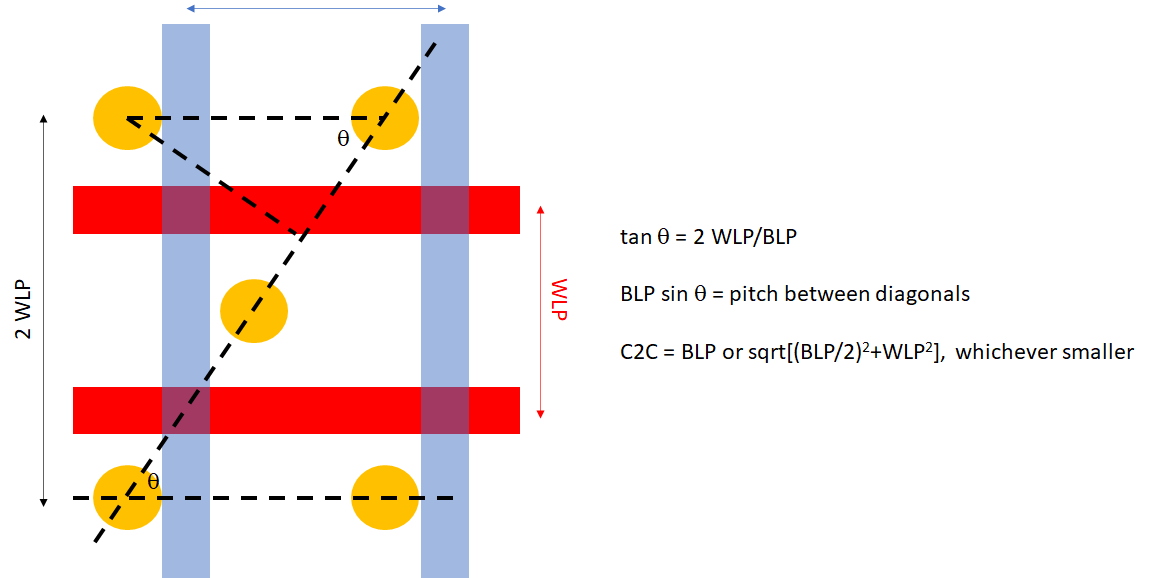
Figure 1. Nœuds de stockage (jaunes) sur une grille de cellules DRAM. BLP = pas de ligne de bit, WLP = pas de ligne de mot.
Un pas de ligne de bit de 38 nm et un pas de ligne de mot de 33 nm conduiraient à un centre à centre de 38 nm et un pas de 32.9 nm entre les diagonales, pour une taille de cellule de 0.001254 um2 et un peu moins de 12 nm règle de conception de zone active.
Pour un système EUV de 0.33 NA, le réseau hexagonal utiliserait un éclairage hexapolaire, où chaque pôle produit un motif d'interférence à trois faisceaux (Figure 2). Les quatre pôles quadrants produisent un motif différent de celui des deux autres pôles horizontaux. Cela conduit à deux composantes de dose distinctes avec des stochastiques distincts. Ceux-ci sont ajoutés dans le modèle composite final.

Figure 2. L'éclairage hexapolaire pour le modèle de stockage DRAM se compose de 4 pôles quadrants (gris) et de deux pôles horizontaux (jaune). En fonction de la direction d'éclairage, le motif d'interférence à trois faisceaux résultant a une orientation spécifique.
En raison du bruit de tir de photons absorbé substantiel au bord de la caractéristique, l'effet stochastique sur l'erreur de placement du motif est significatif, comme déjà décrit dans la réf. 1, dépassant facilement une spécification de superposition de 1 nm. La plus faible dose absorbée semble être évidemment pire (Figure 3).

Figure 3. Erreur de placement stochastique (X uniquement) du pilier central dans une cellule unitaire de 38 nm x 66 nm (espacement de la ligne de mot = 33 nm), avec l'illumination hexapolaire attendue dans un système EUV de 0.33 NA. Ici, une série de 25 instances différentes est représentée pour deux doses absorbées.
Aller à 0.55 NA ajoute le problème de la profondeur de champ fortement réduite. Une NA de 0.55 entraînerait une défocalisation de 15 nm entraînant un déphasage de > 50 degrés entre les ordres de diffraction les plus internes et les plus externes (Figure 4), ce qui réduit considérablement le contraste de l'image en raison de l'évanouissement [3].
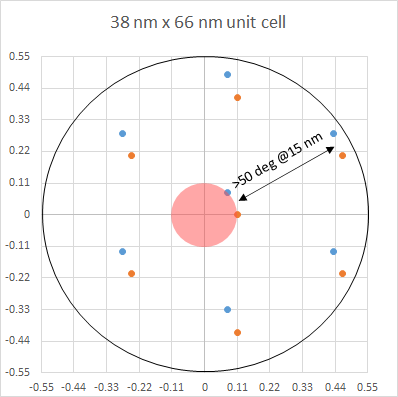
Figure 4. Une défocalisation de 15 nm sur un système EUV de 0.55 NA conduit à un déphasage > 50 degrés entre les ordres de diffraction les plus internes et les plus externes.
Ainsi, il est probable que le modèle de nœud de stockage doit être formé à partir de deux modèles de lignes croisées (Figure 5). Chaque motif de lignes croisées peut être formé par une exposition unique EUV ou par DUV SAQP (motif quadruple auto-aligné). Les deux options sont des processus à masque unique. Le processus SAQP est plus mature (ayant longtemps précédé l'EUV) et exempt des problèmes stochastiques d'électrons secondaires de l'EUV [4], il devrait donc être préféré. Néanmoins, pour le cas SAQP, les lignes d'espacement doivent être bien contrôlées à la fois en termes de placement et de rugosité de la largeur de ligne [5].

Figure 5. Le modèle de nœud de stockage peut être formé par l'intersection de deux modèles de lignes croisées.
Au lieu du SAQP de type ligne, un motif en nid d'abeille d'espacement 2D a également été démontré par Samsung [6], en utilisant un seul masque avec un motif en nid d'abeille de départ, au lieu de deux masques avec des motifs de ligne de départ.
Alors que le cas ci-dessus considère un pas de ligne de bit de 38 nm et un pas de ligne de mot de 33 nm, il s'applique également au cas où les pas sont permutés (pas de ligne de bit de 33 nm et pas de ligne de mot de 38 nm), en raison de la symétrie hexagonale.
Bibliographie
[1] W. Gao et al., Proc. SPIE11323, 113231L (2020).
[2] F. Chen, Relation trigonométrique entre les emplacements des cellules DRAM, https://www.youtube.com/watch?v=Oq6b-6iw6Zk
[3] JH. Franke, TA Brunner, E. Hendrickx, J. Micro/Nanopattern. Mater. Métrol. 21, 030501 (2022).
[4] F. Chen, Secondaire Electron Blur Randomness as the Origin of EUV Stochastic Defects, https://www.linkedin.com/pulse/secondaire-electron-blur-randomness-origin-euv-stochastic-chen/
[5] N.Bae et al., Proc. SPIE 11615, 116150B (2021).
[6] JM Park et al., IEDM 2015.
Cet article est apparu pour la première fois dans LinkedIn Pulse : Lithographie spécifique à l'application : motif de nœud de stockage DRAM inférieur à 0.0013 um2
Partagez cet article via:
- Contenu propulsé par le référencement et distribution de relations publiques. Soyez amplifié aujourd'hui.
- Platoblockchain. Intelligence métaverse Web3. Connaissance Amplifiée. Accéder ici.
- La source: https://semiwiki.com/lithography/323357-application-specific-lithography-sub-0-0013-um2-dram-storage-node-patterning/
- 1
- 2020
- 2021
- 2022
- 9
- a
- au dessus de
- infection
- ajoutée
- Ajoute
- déjà
- parmi
- ainsi que le
- paru
- Application
- spécifique à l'application
- une approche
- Réservé
- arrangé
- tableau
- article
- ci-dessous
- jusqu'à XNUMX fois
- Au-delà
- Bit
- tache
- maisons
- central
- globaux
- chen
- composants électriques
- Préoccupations
- considéré
- considérant
- contraste
- Franchi
- démontré
- Selon
- profondeur
- Conception
- déterminé
- différent
- direction
- chacun
- même
- Edge
- effet
- erreur
- Pourtant, la
- JAMAIS
- attendu
- Exposition
- Fonctionnalité
- Figure
- finale
- Prénom
- Focus
- formé
- Gratuit
- De
- GAO
- Go
- Grille
- ayant
- ici
- Horizontal
- HTTPS
- image
- in
- plutôt ;
- intersection
- aide
- IT
- Disposition
- conduire
- conduisant
- Conduit
- Probable
- Gamme
- lignes
- Location
- masque
- Masques
- mature
- largeur maximale
- PLUS
- Besoins
- nœud
- nœuds
- Bruit
- en cours
- Options
- passer commande
- Origine
- Autre
- Parc
- particulier
- Patron de Couture
- motifs
- phase
- Pilier
- Emplacement
- emplacements
- Platon
- Intelligence des données Platon
- PlatonDonnées
- Post
- préféré
- PROC
- processus
- les process
- produire
- projetée
- impulsion
- aléatoire
- atteint
- recommandé
- Prix Réduit
- réduit
- relation amoureuse
- Signalé
- résultat
- résultant
- Règle
- Samsung
- secondaire
- Série
- décalage
- devrait
- montrer
- montré
- significative
- unique
- Taille
- tailles
- faibles
- So
- groupe de neurones
- Commencez
- Encore
- storage
- Ces
- combustion propre
- conditions
- Les
- donc
- à
- sous
- unité
- utilisé
- Utilisant
- Valeurs
- via
- W
- que
- qui
- sera
- Word
- pourra
- X
- Youtube
- zéphyrnet









