Αναπτύσσονται νέες δομές πρόσκρουσης για να επιτρέψουν υψηλότερες πυκνότητες διασύνδεσης σε συσκευασίες με flip-chip, αλλά είναι πολύπλοκες, ακριβές και ολοένα και πιο δύσκολο να κατασκευαστούν.
Για προϊόντα με υψηλό αριθμό καρφίδων, flip-chip Τα πακέτα [1] ήταν από καιρό δημοφιλής επιλογή επειδή χρησιμοποιούν ολόκληρη την περιοχή καλουπιών για διασύνδεση. Η τεχνολογία χρησιμοποιείται από τη δεκαετία του 1970, ξεκινώντας με το C4 της IBM (σύνδεση ελεγχόμενου τσιπ κατάρρευσης), αλλά πραγματικά άρχισε να χρησιμοποιείται ευρέως τη δεκαετία του 1990.
Από τότε, η τεχνολογία bump έχει εξελιχθεί για να χειρίζεται την αυξανόμενη ισχύ και πυκνότητα σύνδεσης σήματος που απαιτείται από τη μνήμη, τους υπολογιστές υψηλής απόδοσης και τις φορητές υπολογιστικές συσκευές. Η ικανοποίηση αυτής της ζήτησης απαιτεί νέα τεχνολογία διασύνδεσης που επιτρέπει μικρότερα στάδια πρόσκρουσης, η οποία αυτή τη στιγμή είναι σε παραγωγή.
Με την πάροδο του χρόνου, ο οδικός χάρτης για τη διασύνδεση με flip-chip εξελίσσεται από εξογκώματα χωρίς μόλυβδο σε χάλκινες κολόνες και, στη συνέχεια, σε χάλκινες μικροπροβολές. Τα μεγέθη πίσσας συνεχίζουν να συρρικνώνονται, γεγονός που με τη σειρά του έχει δημιουργήσει κατασκευαστικές προκλήσεις για πρόσκρουση και συγκόλληση.


Εικ. 1: Εύρος βήματος τεχνολογίας Flip-chip. Πηγή: A. Meixner/Semiconductor Engineering
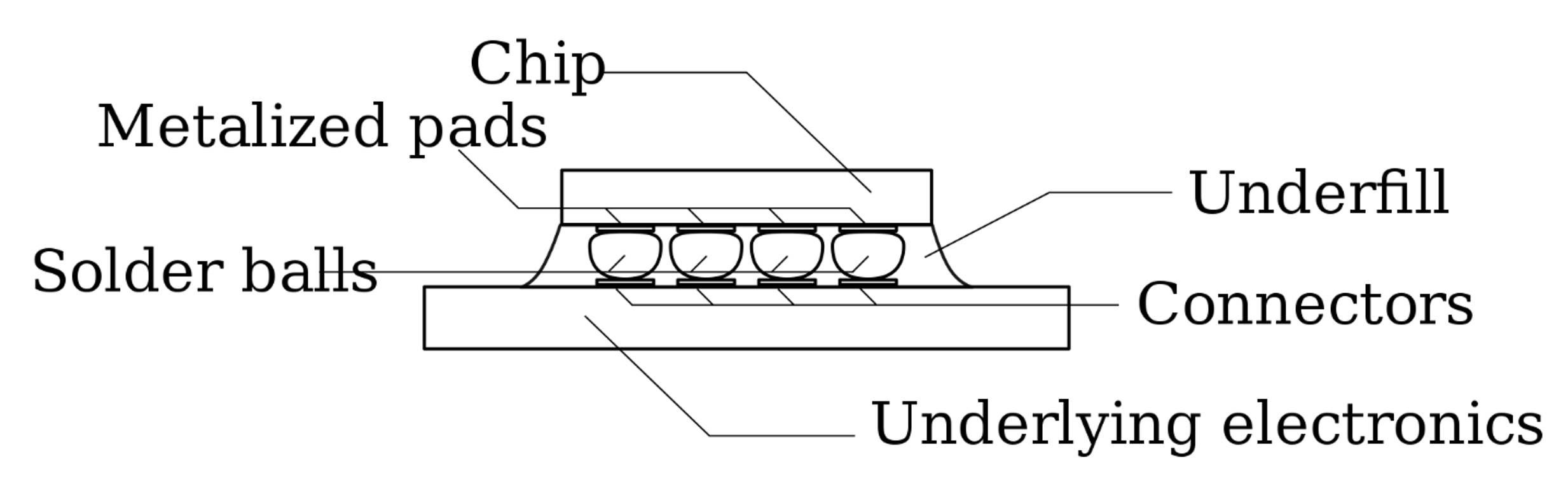
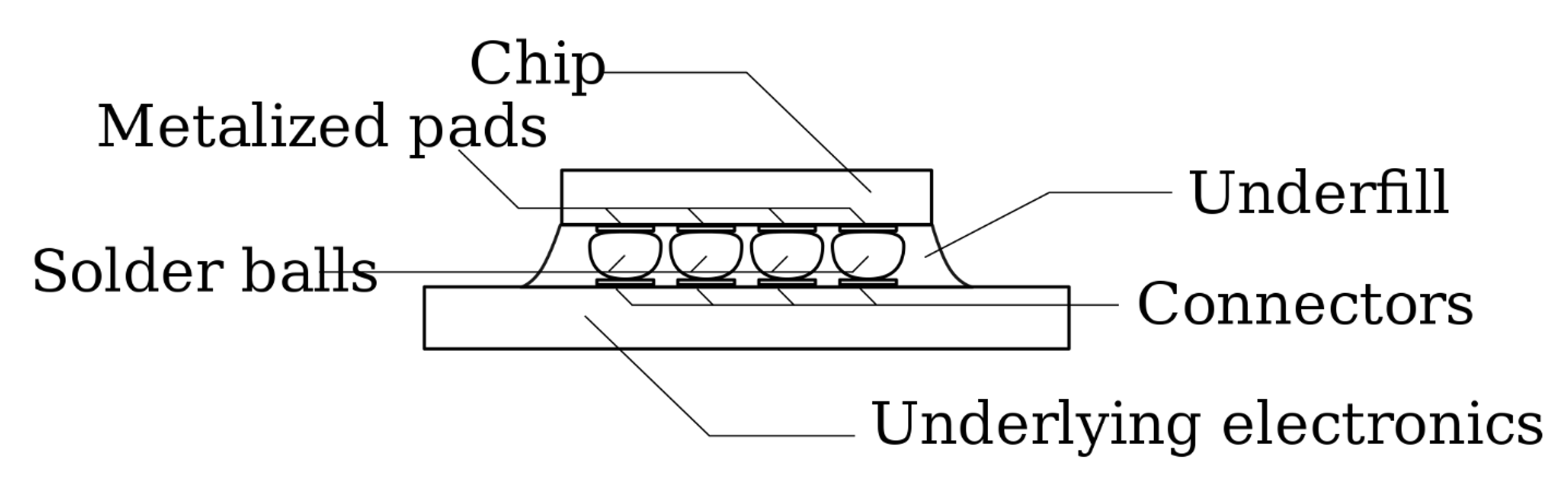
Εικ. 2: Εξαρτήματα αναδιπλούμενου τσιπ. Πηγή: Wikipedia
«Στην αρένα με τα flip-chip - 250 micron pitch και κάτω - αρχικά ήταν κασσίτερου μολύβδου και μια από τις μεγάλες κινήσεις ήταν η αμόλυβδη. Αλλά όταν αρχίσετε να φτάσετε τα 100 μικρά ή κάτω, αρχίζετε να βλέπετε περισσότερο έναν χάλκινο πυλώνα, αν και υπάρχει μια επικάλυψη καθώς βλέπουμε χάλκινους πυλώνες έως και 250 μικρά», δήλωσε ο Jeff Schaefer, ανώτερος μηχανικός διεργασιών στο Promex Industries. «Με το βήμα των 250 μικρών, βλέπουμε μεγέθη ανοιγμάτων 130 μικρών ή διαμέτρους χάλκινων πυλώνων. Μόλις φτάσουμε γύρω από το βήμα των 100 μικρών, έχει διάμετρο 80 μικρών. Το μικρότερο που έχω δει είναι ένα βήμα 62.5 micron με μια κολόνα 40 micron. Αναμένω να αρχίσω να βλέπω 50 micron pitch σύντομα.”
Η βασική διαδικασία flip-chip ξεκινά μετά την κατασκευή του κυκλώματος, όταν δημιουργούνται μεταλλικά μαξιλάρια στην επιφάνεια της μήτρας για να συνδεθούν με τα I/Os. Στη συνέχεια έρχεται το χτύπημα της γκοφρέτας, όπου μια σφαίρα συγκόλλησης εναποτίθεται σε κάθε μαξιλαράκι. Στη συνέχεια, η γκοφρέτα κόβεται σε κύβους και αυτές οι μήτρες αναστρέφονται και τοποθετούνται έτσι ώστε οι μπάλες συγκόλλησης να ευθυγραμμίζονται με τα τακάκια του υποστρώματος. Οι σφαίρες συγκόλλησης στη συνέχεια τήκονται/ξαναρέουν, συνήθως χρησιμοποιώντας ζεστό αέρα, και μια τοποθετημένη μήτρα δεν γεμίζει ελάχιστα με μια ηλεκτρικά μονωτική κόλλα, συνήθως χρησιμοποιώντας τριχοειδή δράση. [1]


Εικ. 3: Διαδικασία κατασκευής πτερυγίων. Πηγή: Wikipedia
Η μετάβαση σε μια χάλκινη κολόνα ή ένα μικροσκόπιο απαιτεί λιθογραφία για τη δημιουργία αυτών των δομών.
«Ο χάλκινος στύλος χρησιμοποιείται γενικά κάτω από 130μm βήμα, επειδή αντί να είναι ένα κυκλικό εξόγκωμα συγκόλλησης, ο χάλκινος στύλος είναι ως επί το πλείστον ένας στύλος Cu με συγκόλληση στην κορυφή», δήλωσε ο Doug Scott, ανώτερος αντιπρόεδρος συσκευασίας σε επίπεδο γκοφρέτας στο Τεχνολογία Amkor. "Αυτό επιτρέπει στα εξογκώματα των χάλκινων πυλώνων να τοποθετούνται πιο κοντά μεταξύ τους χωρίς κίνδυνο σύνδεσης της συγκόλλησης κατά τη διάρκεια της επαναροής της συναρμολόγησης - γενικά, ~40 μm Cu + ~25 μm."
Υπάρχουν παραλλαγές και στο θέμα. "Microbump, ο οποίος είναι ένας κοινός όρος που χρησιμοποιείται όταν έχετε μια διασύνδεση μεταξύ πυριτίου και πυριτίου, είναι ελαφρώς διαφορετικό επειδή ο CTE (συντελεστής θερμικής διαστολής) είναι γενικά ο ίδιος", δήλωσε ο Mark Gerber, ανώτερος διευθυντής μηχανικής/τεχνικού μάρκετινγκ. στο Όμιλος ΧΑ. «Ορισμένοι από τους γενικούς κανόνες σχεδιασμού που χρησιμοποιούνται για τη χάλκινη κολόνα είναι οι ίδιοι, αλλά η τοπογραφία της επίπεδης επιφάνειας και οι αρμοί χαμηλής τάσης επιτρέπουν την ευελιξία της υπογεμίσματος που χρησιμοποιείται. Αυτό μπορεί επίσης να οδηγήσει στο μεμονωμένο βήμα πρόσκρουσης. Σήμερα, ένα βήμα πλήρους συστοιχίας πρόσκρουσης 35 μm είναι δυνατό, λόγω των παραμέτρων δρομολόγησης που αναφέρθηκαν προηγουμένως, για τη δρομολόγηση σε επίπεδο wafer ή σε επίπεδο fab που χρησιμοποιείται.
Ο οδικός χάρτης ετερογενούς ολοκλήρωσης [2] περιγράφει όλες τις πτυχές της συσκευασίας, συμπεριλαμβανομένων των διασυνδέσεων μεταξύ μήτρας και υποστρώματος, που κυμαίνονται από δεσμούς σύρματος έως διόδους διέλευσης πυριτίου. Με πακέτα flip-chip, οι διασυνδέσεις από το υπόστρωμα στο υπόστρωμα, οι περιοχές ανακατανομής υποστρώματος και οι διασυνδέσεις από υπόστρωμα σε πλακέτα παίζουν ρόλο στα όρια κατασκευής.
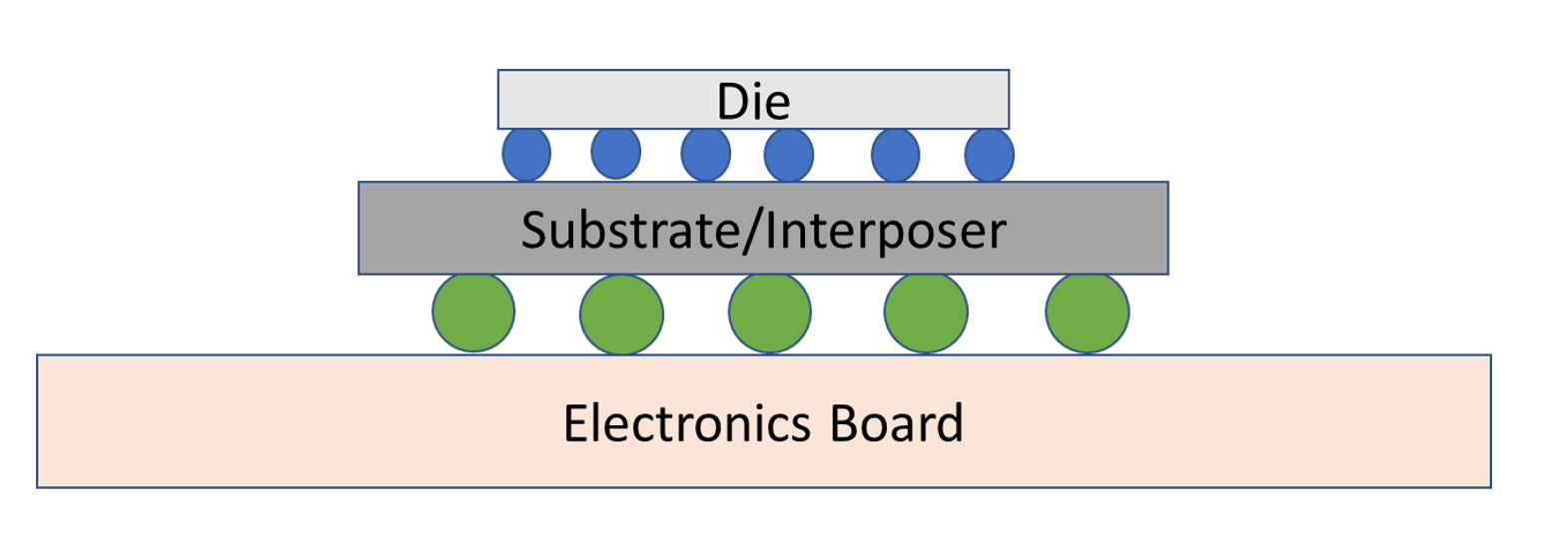
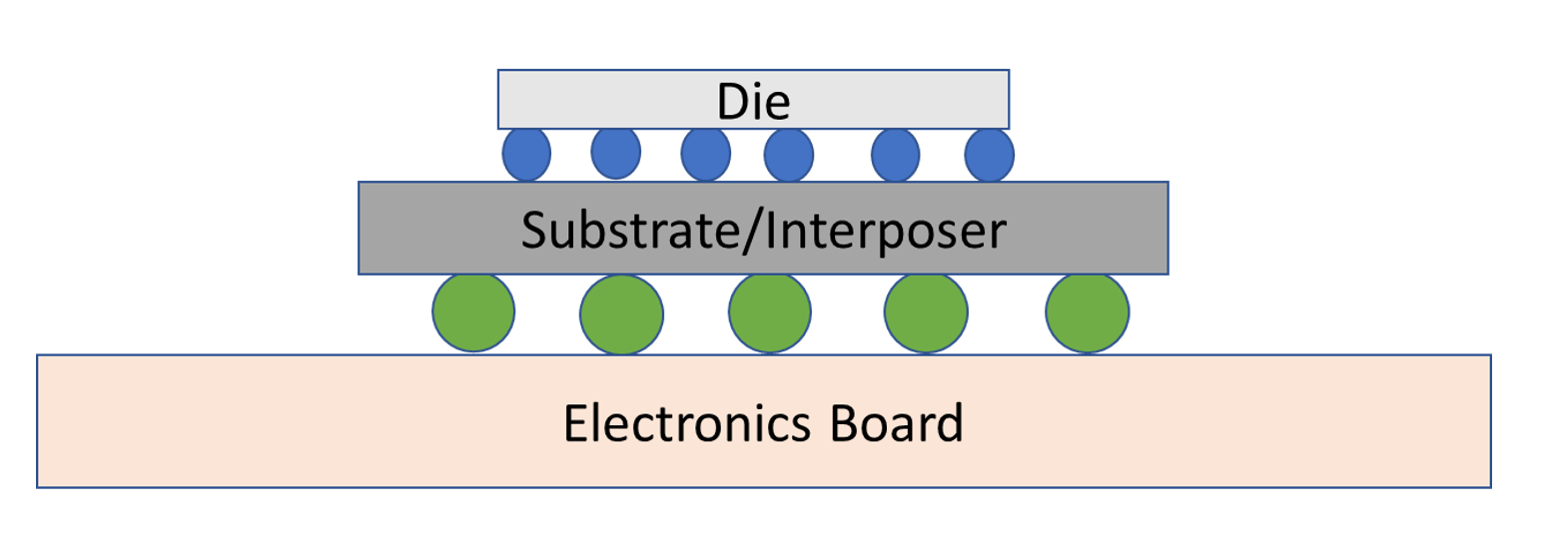
Εικ. 4: Εννοιολογικό διάγραμμα συσκευασίας flip-chip. Πηγή: A. Meixner/Semiconductor Engineering
Το Κεφάλαιο 8 του Οδικού Χάρτη Ετερογενούς Ολοκλήρωσης [3] τεκμηριώνει το τοπίο των υφιστάμενων και των προβλεπόμενων προτάσεων τεχνολογίας συσκευασίας. Το ελάχιστο βήμα κάθε τεχνολογίας διασύνδεσης flip-chip αποτυπώνεται στον Πίνακα 1 της υποενότητας 8.7 (σελίδα 41).
![Το Κεφάλαιο 8 του Οδικού Χάρτη Ετερογενούς Ολοκλήρωσης [3] τεκμηριώνει το τοπίο των υφιστάμενων και των προβλεπόμενων προτάσεων τεχνολογίας συσκευασίας. Το ελάχιστο βήμα κάθε τεχνολογίας διασύνδεσης flip-chip αποτυπώνεται στον Πίνακα 1 της υποενότητας 8.7 (σελίδα 41).](https://platoaistream.com/wp-content/uploads/2023/05/challenges-grow-for-creating-smaller-bumps-for-flip-chips-7.png)
![Το Κεφάλαιο 8 του Οδικού Χάρτη Ετερογενούς Ολοκλήρωσης [3] τεκμηριώνει το τοπίο των υφιστάμενων και των προβλεπόμενων προτάσεων τεχνολογίας συσκευασίας. Το ελάχιστο βήμα κάθε τεχνολογίας διασύνδεσης flip-chip αποτυπώνεται στον Πίνακα 1 της υποενότητας 8.7 (σελίδα 41).](https://platoaistream.com/wp-content/uploads/2023/05/challenges-grow-for-creating-smaller-bumps-for-flip-chips-8.png)
Ο αντίστοιχος πίνακας για τη διασύνδεση υποστρώματος (το τμήμα που συνδέει τη συσκευασία με την πλακέτα) βρίσκεται στην υποενότητα 8.8 (σελίδα 43).


Με κάθε αλλαγή στην τεχνολογία διασύνδεσης έρχονται νέες διαδικασίες και τα όριά τους, που οδηγούν στην καινοτομία, τη διαχείριση απόδοσης και την επιθεώρηση ελαττωμάτων.
Όρια τεχνολογίας πρόσκρουσης
Η τεχνολογία πρόσκρουσης μετριέται με βάση το βήμα, το μέγεθος, το ύψος και τις ηλεκτρικές και μηχανικές ιδιότητες. Οι θερμικές εκτιμήσεις ποικίλλουν ανάλογα με την αναντιστοιχία CTE του υλικού. Η στρέβλωση είναι μια ανησυχία για μεγαλύτερες μήτρες και γκοφρέτες, η οποία επιδεινώνεται από την οπίσθια λείανση μιας γκοφρέτας πριν την προσάρτηση της μήτρας.
«Υπάρχει ένας αριθμός οδηγών για περιορισμούς στο pitch για κάθε τύπο διασύνδεσης», δήλωσε ο Gerber του ASE. «Ξεκινώντας με την παραδοσιακή διασύνδεση του τσιπ με πρόσκρουση συγκόλλησης, η ικανότητα του βήματος καθορίζεται από το ύψος κατάρρευσης για υπογεμίσεις, το βήμα σύλληψης για δρομολόγηση ίχνους, το βήμα σύλληψης για βραχυπρόθεσμο κίνδυνο πρόσκρουσης σε πρόσκρουση και πολλές άλλες ευαισθησίες που σχετίζονται με το βήμα. Το προ-μονταρισμένο ύψος πρόσκρουσης έχει ένα καθορισμένο ύψος, αλλά όπως όρισε η IBM τον όρο C4 — Controlled Collapse Chip Connection — η διάμετρος του εξογκώματος συγκόλλησης και το μέγεθος του μαξιλαριού σύλληψης θα καθορίσουν την «κατάρρευση ή το τελικό ύψος» της διασύνδεσης. Αυτός είναι ο κύριος περιοριστικός παράγοντας για τη χρήση εξογκωμάτων συγκόλλησης που σχετίζονται με το βήμα."
Το ύψος του χτυπήματος καθορίζεται από το σχεδιασμό, αλλά και τις επιλογές επεξεργασίας.
"Για τυπικά επιμεταλλωμένα εξογκώματα συγκόλλησης και χάλκινα εξογκώματα κολόνας, τα ύψη ανοιγμάτων πριν από τη συναρμολόγηση είναι γενικά περίπου 70μm έως 75 μm, με αναδιπλωμένα ύψη εξογκώματος μετά τη συναρμολόγηση ~50 μm για να υπάρχει χώρος x,y,z για τη ροή υποπλήρωσης μεταξύ των εξογκωμάτων. Τα microbumps θα έχουν πολύ χαμηλότερα ύψη προσκρούσεων και θα περιλαμβάνουν πολύ λιγότερη συγκόλληση. Συγκεκριμένα, τα μικροεξογκώματα μπορεί να έχουν ύψος μικρότερο από 10 μm με μειωμένο Cu και ύψη συγκόλλησης ανάλογα με το βήμα και την τελική ανάγκη», δήλωσε ο Scott της Amkor. «Τα τυπικά επιμεταλλωμένα εξογκώματα συγκόλλησης χρησιμοποιούνται γενικά σε γήπεδα που κυμαίνονται από 130μm έως 250μm. Κάτω από 130 μm, δεν υπάρχει αρκετός χώρος x-y μεταξύ των προσκρούσεων όταν ξεκινάμε με ύψος 70 μm προ-συναρμολόγησης.
Η δημιουργία χάλκινων στύλων απαιτεί περισσότερα στάδια επεξεργασίας από τα εξογκώματα συγκόλλησης.
«Όταν μεταβήκαμε στον κόσμο του die-to-die, η τεχνολογία είναι διαφορετική γιατί τώρα έχεις να κάνεις με μια γκοφρέτα και οι πλανερίτες είναι τόσο καλοί σε σύγκριση με τη μήτρα σε υπόστρωμα. Πρώτα δημιουργείτε τη χάλκινη κολόνα, στην αρχική γκοφρέτα που πρόκειται να πάρει τη συγκόλληση ή τη χάλκινη κολόνα υπάρχει πρώτα ένα μέταλλο κάτω από πρόσκρουση (UBM). Είναι ένα μικρό καπάκι πάνω από το άνοιγμα που κατεβαίνει στο πυρίτιο. Στη συνέχεια φτιάχνουμε έναν χάλκινο πυρήνα από αυτό και στη συνέχεια βάζουμε ένα τσίγκινο καπάκι πάνω του. Έτσι, στη συνέχεια, η γκοφρέτα λήψης, μοιάζουν σαν να έχουν ένα μαξιλαράκι UBM εκεί και συνήθως έχει επιμετάλλωση τύπου νικελίου, έτσι ώστε να είναι ωραίο και παρθένο», εξήγησε ο Schaefer της Promex Industries. Έτσι, αντί να έχετε μια ελαφριά εσοχή όπως ένα πολυστρωματικό υπόστρωμα, έχετε μια ελαφριά εξώθηση. Διαπιστώσαμε ότι μπορούμε πραγματικά να τα κολλήσουμε υγρά χωρίς «κόλληση σε μαξιλαράκι». Έτσι είναι σχεδιασμένα και κατασκευασμένα. Λειτουργεί σχεδόν σαν συγκόλληση και μαξιλαράκι γιατί είναι ένας μικρός θόλος σε αντίθεση με την προσπάθεια να κατέβεις μέσα σε μια τρύπα.»
Τα βήματα φωτολιθογραφίας που απαιτούνται για το σχηματισμό κολώνων Cu συνοδεύονται από όρια καθώς και με κανόνες σχεδιασμού υποστρώματος.
«Για χάλκινη κολόνα, η οποία αποτελείται από έναν χάλκινο στύλο και ένα κάλυμμα συγκόλλησης στο άκρο, το ύψος του στύλου μπορεί να οριστεί στον περιορισμό ενός ή περισσότερων πάχους στρώματος φωτοανθεκτικού και καθώς μειώνετε το βήμα, ο λόγος διαστάσεων του Το cu post ύψος σε βήμα γίνεται ο περιορισμός μαζί με τις δυνατότητες φωτοαντίστασης υλικού και εργαλείου απεικόνισης», είπε ο Gerber. «Ένας δευτερεύων περιορισμός για τη διασύνδεση της χάλκινης κολόνας είναι οι κανόνες σχεδιασμού του υποστρώματος που χρησιμοποιούνται. Για λεπτό βήμα >110um pitch, χρησιμοποιούνται 2 κύριες μέθοδοι- BOT (Bond on Trace) ή ET – Embedded Trace, όπου το κάλυμμα συγκόλλησης της χάλκινης κολόνας τοποθετείται στην κορυφή του ίχνους αντί για ένα παραδοσιακό μαξιλαράκι σύλληψης. Το μέγεθος και το σχήμα της χάλκινης κολόνας, συμπεριλαμβανομένων των παραπάνω περιορισμών, μπορούν να παρέχουν ένα όριο στις δυνατότητες και τον οδικό χάρτη για τη συνέχιση της συρρίκνωσης των γηπέδων. Πολλοί από αυτούς τους περιορισμούς οφείλονται στην ικανότητα δρομολόγησης ιχνών μεταξύ των πυλώνων στην πλευρά του υποστρώματος. Καθώς είναι διαθέσιμες νέες τεχνολογίες, όπως το RDL σε επίπεδο πλακέτας, οι οδικοί χάρτες διασύνδεσης θα προωθηθούν περαιτέρω, αλλά με περιορισμούς γύρω από την αναλογία ύψους/διαστάσεων για διαδικασίες παραγωγής, όπως η υποπλήρωση.
Άλλοι συμφωνούν ότι η διαδικασία υποπλήρωσης συνοδεύεται από προκλήσεις. «Καθώς λαμβάνετε μικρότερα εξογκώματα, γίνονται μικρότερα. Τώρα γίνεται δύσκολο να βρεις υπογεμίσεις για να μπεις από κάτω. Οι υπογεμίσεις έχουν σχεδιαστεί ιστορικά για να πέφτουν κάτω από ένα κενό 5 mils, και τώρα μειώνονται στα 3 mils, δηλαδή 75 micron», είπε ο Schaefer. «Τώρα αρχίζουμε να βλέπουμε κενά 60 και 25 micron. Είμαι βέβαιος ότι οι άνθρωποι εργάζονται σε νέες υπογεμίσεις. Αλλά υπάρχουν πολλά πράγματα για να δουλέψετε. Πρώτον, καθώς παίρνετε λεπτότερα σωματίδια, γίνεται περισσότερο σαν λάσπη, γεγονός που καθιστά δυσκολότερη τη ροή. Αυτό είναι ένα οδόφραγμα που πρέπει να αφαιρεθεί».
Διαχείριση της απόδοσης
Καθώς η τεχνολογία πρόσκρουσης γίνεται μικρότερη, πρόσθετα βήματα επεξεργασίας - για παράδειγμα, λιθογραφία για τη δημιουργία χάλκινων στύλων - ανοίγουν νέες ευκαιρίες για ανιχνευτές απόδοσης. Για μια επιτυχημένη διαδικασία συγκόλλησης, τα σωματίδια, οι επιφανειακοί ρύποι και το κενό εξόγκωσης συγκόλλησης είναι προβληματικά όσον αφορά την απόδοση. Αυτά απαιτούν ελέγχους διαδικασίας, μετρολογία και επιθεώρηση.
Απαιτείται φυσικά έλεγχος της μόλυνσης. «Οι OSAT 1ης βαθμίδας επενδύουν για να μειώσουν το επίπεδο των πηγών μόλυνσης των εργοστασίων και επομένως να μειώσουν τα ποσοστά ελαττωματικών», δήλωσε ο Scott της Amkor. «Το pitch δεν συμβάλλει σε ελαττώματα. Παρόμοια επίπεδα ελαττωματικών υπάρχουν ανεξάρτητα από το βήμα."
Αλλά το γήπεδο προσθέτει μερικές από τις δικές του προκλήσεις. «Καθώς ο τόνος γίνεται μικρότερος και το μέγεθος του εξογκώματος μειώνεται, η διαχείριση της μόλυνσης από σωματίδια είναι πολύ σημαντική. Για άλλους τύπους διασυνδέσεων όπως η υβριδική συγκόλληση, όπου τα βήματα μειώνονται κάτω από 30 μm και η επαφή επιφάνειας-επιφάνειας είναι σημαντική, το περιβάλλον καθαρού δωματίου που βασίζεται σε γκοφρέτα είναι κρίσιμο για τις αποδόσεις», δήλωσε ο Gerber του ASE.
Η προετοιμασία για τη διαδικασία υπογεμίσματος δεν πρέπει επίσης να υποτιμάται.
«Γενικά με ένα laminate, πρόκειται να κάνετε ένα underfill αφού κάνετε το flip chip», είπε ο Schaefer της Promex. «Εμείς καθορίζουμε πού θα το τοποθετήσουμε και πώς θα το επαναφέρουμε. Το καθαρίζουμε για να βγει οποιοδήποτε υλικό ροής κάτω από το κενό μεταξύ της μήτρας και του υποστρώματος. Τότε θα υπογεμίσουμε με ένα εποξειδικό που ρέει. Είναι σχεδιασμένο να βρέχει και να μην αφήνει κενά και πράγματα αυτής της φύσης. Αλλά υπάρχει μια πρόκληση καθώς φτάνουμε σε πιο ωραία γήπεδα. Τα χτυπήματα γίνονται λίγο μικρότερα και όσο μικραίνουν το κενό μεταξύ του τσιπ και του υποστρώματος μικραίνει, επομένως είναι πιο δύσκολο να καθαριστεί. Φανταστείτε να κολλάτε δύο γυάλινες τσουλήθρες για να προσπαθήσετε να βγάλετε τη βρωμιά ανάμεσά τους».
Ανάγκες μετρολογίας και επιθεώρησης
Για τη διαχείριση του ελέγχου και της απόδοσης της διαδικασίας, η μετρολογία και τα εργαλεία επιθεώρησης διαδραματίζουν σημαντικό ρόλο. «Υπάρχουν διαθέσιμα εργαλεία στην αγορά που μπορούν να βοηθήσουν στην παροχή καθοδήγησης για την ακεραιότητα της διασύνδεσης, επιπλέον της διατομικής ανάλυσης κατά τη διαδικασία που χρησιμοποιείται κατά την εγκατάσταση και σε καθορισμένα διαστήματα παραγωγής», δήλωσε ο Gerber του ASE.
Η διαδικασία πρόσκρουσης και οι διαδικασίες συγκόλλησης έχουν η καθεμία συγκεκριμένα χαρακτηριστικά που πρέπει να παρακολουθούνται. Για τα χτυπήματα, η μετρολογία εστιάζει στη διάμετρο, το ύψος και την ομοεπίπεδη. Τα μικρότερα γήπεδα απαιτούν πιο αυστηρό έλεγχο της διαμέτρου και του ύψους του χτύπημα. Ομοίως, καθώς το ύψος του εξογκώματος συρρικνώνεται, το παράθυρο συνεπιπεδότητας γίνεται μικρότερο. Συνήθως, επιτρέπεται διαφοροποίηση 10%. Για παράδειγμα, ένα ύψος πρόσκρουσης 30 μm έχει ως αποτέλεσμα μια επιτρεπόμενη διακύμανση ±3 μm. Η υπέρβαση αυτού συμβάλλει σε ανεπιτυχή ή κακή σύνδεση.
«Η συγκόλληση γίνεται συνήθως με φούρνους μαζικής επαναροής», είπε ο Mike Kelly αντιπρόεδρος για την ενσωμάτωση προηγμένων πακέτων και τεχνολογίας στην Amkor. «Ο αρχικός χαρακτηρισμός της διαδικασίας επαναροής καθιερώνεται με τη χρήση shadow-moire για τον ποσοτικό προσδιορισμό της στρέβλωσης κατά την επαναροή και τη χαρτογράφηση θερμοκρασίας των φούρνων για να διασφαλιστεί ο συνεπής έλεγχος θερμοκρασίας του ίδιου του τμήματος flip-chip. Κατά τη διάρκεια της εγκατάστασης, η μηχανική ανύψωση μήτρας και η επιθεώρηση για να διασφαλιστεί η καλή διαβροχή της συγκόλλησης γίνεται. Επίσης, η ροή εφαρμόζεται συνήθως με μια «ροή βύθισης», όπου τα εξογκώματα μήτρας «βυθίζονται» σε λεπτές, αυστηρά ελεγχόμενες δεξαμενές ροής. Η οπτική επιθεώρηση αυτών των στοιχείων γίνεται σε δειγματοληπτική βάση.»
Η αυξανόμενη αυτοματοποίηση της οπτικής επιθεώρησης μειώνει την εξάρτηση από τους χειριστές για την προβολή μιας εικόνας και τη λήψη απόφασης. Η εκθετική αύξηση στις συνδέσεις πρόσκρουσης είναι ένας οδηγός. Οι αλλαγές στις διαδικασίες συγκόλλησης παρέχουν ένα άλλο. Μια αυτοευθυγραμμισμένη διαδικασία επαναροής συγκόλλησης είναι μια ώριμη τεχνολογία. Με τη συγκόλληση θερμικής συμπίεσης που χρησιμοποιείται συνήθως σε προηγμένες συσκευασίες, υπάρχουν μηχανισμοί αξιοπιστίας που περνούν τις ηλεκτρικές δοκιμές. Αυτό, με τη σειρά του, προτρέπει τη χρήση εργαλείων επιθεώρησης ακτίνων Χ και μετρολογίας για την προβολή των προσκρούσεων μετά τη συγκόλληση.
«Για τις συσκευασίες χαμηλής πολυπλοκότητας, οι εγκαταστάσεις θα μπορούσαν να ξεφύγουν από έναν χειριστή και να κάνουν χειροκίνητη επιθεώρηση. Για ένα εξάρτημα με 100 χτυπήματα αυτή η μέθοδος είναι εφικτή. Σε 1,000 προσκρούσεις, είναι σίγουρα ένα στέλεχος. Όταν ένα εξάρτημα έχει 10,000 χτυπήματα, δεν υπάρχει περίπτωση. Προχωράμε πέρα από αυτό το σημείο και πρέπει να προχωρήσουμε στην επόμενη μέθοδο», σημείωσε ο Frank Chen, διευθυντής εφαρμογών και διαχείρισης προϊόντων στο Bruker. «Η ποιότητα και η πολυπλοκότητα πάνε χέρι-χέρι, γιατί καθώς προσπαθείτε να κάνετε κάτι πιο σύνθετο, η απόδοσή σας θα επηρεαστεί και θα απαιτηθούν νέα εργαλεία. Και εργαλειομηχανή σημαίνει τόσο εργαλεία διεργασίας όσο και εργαλεία μετρολογίας, επομένως και τα δύο πρέπει να προχωρήσουν παράλληλα. Από τις δικές μας μελέτες, βλέπουμε ότι μόλις φτάσεις σε αυτές τις 1,000 προσκρούσεις, τότε είναι που πρέπει να αρχίσεις να σκέφτεσαι «Η χειροκίνητη τεχνική μου είναι ανεπαρκής και χρειάζομαι κάτι νέο».
Μια ποικιλία εργαλείων επιθεώρησης και μετρολογίας είναι διαθέσιμα για την υποστήριξη της κατασκευής συσκευασιών.
«Υπάρχουν αρκετές μέθοδοι που μπορούν ή πρέπει να χρησιμοποιηθούν για να επιτευχθεί ο έλεγχος της διαδικασίας. Πρώτον, η παραδοσιακή δισδιάστατη επιθεώρηση (AOI) για 2% επιθεώρηση επιφανειακών ελαττωμάτων ανά ροή διεργασίας (δηλαδή, IQC, OQA, φωτογραφία, καθαρισμός, επιμετάλλωση κ.λπ.) Στη συνέχεια, η μετρολογία 100D (AOI) μπορεί να χρησιμοποιηθεί για τον έλεγχο του μεγέθους και του μεγέθους της διαμέτρου έλεγχος. Επιπλέον, η τρισδιάστατη μετρολογία (AOI) μπορεί να χρησιμοποιηθεί για τη λήψη μετρολογικών πληροφοριών ύψους ανύψωσης/συνεπίπεδης δειγματοληψίας (αυτό γίνεται συνήθως με τεχνολογία που βασίζεται σε τριγωνισμό λέιζερ)», δήλωσε ο Nathan Peng, διευθυντής μάρκετινγκ προϊόντων στο Onto Καινοτομία. «Επιπλέον, η τρισδιάστατη μετρολογία μπορεί να στοχεύσει μεμονωμένα χαρακτηριστικά ύψους πρόσκρουσης, που συνήθως συλλέγονται με τεχνολογία συμβολόμετρου λευκού φωτός. Επίσης, υπάρχουν μέθοδοι για να ενεργοποιήσετε την ανίχνευση οργανικών υπολειμμάτων στο επάνω μέρος που μπορεί να οδηγήσει σε αστοχία με τη σύνδεση bump to pad.”
Συμπέρασμα
Τα προϊόντα που απαιτούν υψηλότερους αριθμούς διασύνδεσης συνεχίζουν να οδηγούν τον οδικό χάρτη διασύνδεσης. Κάθε τεχνολογία flip-chip έχει όρια κατασκευής που περιλαμβάνουν ιδιότητες υλικού, συρρίκνωση μεγεθών που προκαλούν τεχνολογίες υπογεμίσματος και αυξημένη χρήση λιθογραφίας για τη δημιουργία των δομών διασύνδεσης. Οποιαδήποτε αλλαγή στις διαδικασίες συγκόλλησης έχει ως αποτέλεσμα την αύξηση των βημάτων μετρολογίας και επιθεώρησης για την επίτευξη των στόχων απόδοσης και ποιότητας.
αναφορές
- https://en.wikipedia.org/wiki/Flip_chip
- https://eps.ieee.org/technology/heterogeneous-integration-roadmap/2021-edition.html
- HIR Κεφάλαιο 8 Ενσωμάτωση ενός τσιπ και πολλαπλών τσιπ, https://eps.ieee.org/images/files/HIR_2021/ch08_smcfinal.pdf
Σχετικές ιστορίες:
Προσκρούσεις Συνεπιπεδότητα και ασυνέπειες προκαλούν απόδοση, ζητήματα αξιοπιστίας
Οι προηγμένες προκλήσεις συσκευασίας αυξάνονται καθώς τα τσιπ και τα μεγέθη συσκευασίας συρρικνώνονται. διαφορετικός εξοπλισμός, τεχνολογίες αποκτούν έλξη.
Η αξιοπιστία του bump αμφισβητείται από λανθάνοντα ελαττώματα
Οι αυτοματοποιημένες λύσεις είναι στα σκαριά, αλλά θα χρειαστούν χρόνο για να αναπτυχθούν.
Μελλοντικές μεγάλες αλλαγές στην παροχή ενέργειας, τα υλικά και τις διασυνδέσεις
Πώς θα αλλάξει η κατασκευή και η συσκευασία τις επόμενες δύο δεκαετίες.
- SEO Powered Content & PR Distribution. Ενισχύστε σήμερα.
- PlatoAiStream. Web3 Data Intelligence. Ενισχύθηκε η γνώση. Πρόσβαση εδώ.
- Minting the Future με την Adryenn Ashley. Πρόσβαση εδώ.
- Αγορά και πώληση μετοχών σε εταιρείες PRE-IPO με το PREIPO®. Πρόσβαση εδώ.
- πηγή: https://semiengineering.com/challenges-grow-for-creating-smaller-bumps-for-flip-chips/
- :έχει
- :είναι
- :δεν
- :που
- $UP
- 000
- 1
- 10
- 100
- 250
- 2D
- 3d
- 40
- 7
- 8
- a
- ικανότητα
- Ικανός
- πάνω από
- Κατορθώνω
- απόκτηση
- Ενέργειες
- πράξεις
- πραγματικά
- Επιπλέον
- Πρόσθετος
- Προσθέτει
- εκ των προτέρων
- προηγμένες
- Μετά το
- εμπρός
- ΑΕΡΑ
- ευθυγράμμιση
- Όλα
- επιτρέπουν
- επιτρέπει
- κατά μήκος
- Επίσης
- an
- ανάλυση
- και
- Άλλος
- κάθε
- εφαρμογές
- εφαρμοσμένος
- ΕΙΝΑΙ
- ΠΕΡΙΟΧΗ
- περιοχές
- γύρω
- AS
- άποψη
- πτυχές
- Συνέλευση
- At
- αποδίδουν
- Αυτοματοποίηση
- διαθέσιμος
- μακριά
- πίσω
- μπάλα
- βασικός
- βάση
- BE
- επειδή
- γίνεται
- ήταν
- πριν
- είναι
- παρακάτω
- μεταξύ
- Πέρα
- Μεγάλος
- επιτροπή
- πήδημα
- Bot
- και οι δύο
- χτίζω
- χτισμένο
- αλλά
- by
- ήρθε
- CAN
- καπάκι
- δυνατότητες
- πιάνω
- Αιτία
- πρόκληση
- αμφισβητηθεί
- προκλήσεις
- ευκαιρία
- αλλαγή
- Αλλαγές
- Κεφάλαιο
- χαρακτηριστικά
- Chen
- τσιπ
- τσιπ
- επιλογή
- επιλογές
- πιο κοντά
- Κατάρρευση
- κατέρρευσε
- Ελάτε
- έρχεται
- Κοινός
- συνήθως
- σύγκριση
- συγκρότημα
- περίπλοκο
- εξαρτήματα
- χρήση υπολογιστή
- εννοιολογική
- Ανησυχία
- Connect
- Συνδετικός
- σύνδεση
- Διασυνδέσεις
- συνδέει
- θεωρήσεις
- συνεπής
- επικοινωνήστε μαζί μας
- ρύπους
- ΣΥΝΕΧΕΙΑ
- συνεχίζοντας
- συμβάλλει
- έλεγχος
- ελέγχεται
- τον έλεγχο
- ελέγχους
- Χαλκός
- πυρήνας
- Αντίστοιχος
- θα μπορούσε να
- Ζευγάρι
- δημιουργία
- δημιουργήθηκε
- δημιουργία
- κρίσιμης
- Ρεύμα
- Τη στιγμή
- ημερομηνία
- μοιρασιά
- δεκαετίες
- απόφαση
- ορίζεται
- οπωσδηποτε
- διανομή
- Ζήτηση
- πυκνότητα
- Σε συνάρτηση
- κατατεθεί
- Υπηρεσίες
- σχεδιασμένα
- Ανίχνευση
- Προσδιορίστε
- αποφασισμένος
- ανάπτυξη
- αναπτύχθηκε
- Συσκευές
- Καλούπι
- διαφορετικές
- δύσκολος
- Διευθυντής
- βρωμιά
- do
- έγγραφα
- κάνει
- γίνεται
- κάτω
- αυτοκίνητο
- οδηγός
- οδηγοί
- δυο
- κατά την διάρκεια
- e
- Ε & Τ
- κάθε
- είτε
- ενσωματωμένο
- ενεργοποιήσετε
- δίνει τη δυνατότητα
- τέλος
- μηχανικός
- Μηχανική
- αρκετά
- εξασφαλίζω
- Περιβάλλον
- εξοπλισμός
- εγκατεστημένος
- κ.λπ.
- Αιθέρας (ΕΤΗ)
- εξελίχθηκε
- παράδειγμα
- υπάρχουν
- επέκταση
- αναμένω
- ακριβά
- εξήγησε
- εκθετικός
- εγκαταστάσεις
- παράγοντας
- εργοστάσιο
- Αποτυχία
- Σύκο
- τελικός
- Εύρεση
- τέλος
- Όνομα
- ίσια
- Ευελιξία
- Αναρρίπτω
- ροή
- Ροές
- Ροή
- εστιάζει
- Για
- για απόδοση
- σχηματισμός
- Βρέθηκαν
- από
- περαιτέρω
- Επί πλέον
- Κέρδος
- χάσμα
- κενά
- General
- γενικά
- παίρνω
- να πάρει
- ποτήρι
- Go
- πηγαίνει
- μετάβαση
- Χρυσό
- καλός
- λείανση
- Grow
- καθοδήγηση
- λαβή
- Σκληρά
- Έχω
- που έχει
- ύψος
- ύψη
- βοήθεια
- Ψηλά
- υψηλή απόδοση
- υψηλότερο
- ιστορικά
- Τρύπα
- ΚΑΥΤΌ
- Πως
- Πώς να
- HTML
- HTTPS
- Υβριδικό
- i
- IBM
- IEEE
- εικόνα
- φαντάζομαι
- Απεικόνιση
- επηρεάζονται
- σημαντικό
- in
- Συμπεριλαμβανομένου
- Αυξάνουν
- αυξημένη
- αύξηση
- όλο και περισσότερο
- ατομικές
- πληροφορίες
- αρχικός
- Καινοτομία
- αντί
- ολοκλήρωση
- ακεραιότητα
- διασυνδέει
- σε
- Επενδύστε
- εμπλέκω
- IT
- αντικειμένων
- ΤΟΥ
- εαυτό
- τοπίο
- μεγαλύτερος
- λέιζερ
- στρώμα
- οδηγήσει
- Άδεια
- μείον
- Επίπεδο
- επίπεδα
- φως
- Μου αρέσει
- LIMIT
- περιορισμός
- περιορισμούς
- όρια
- λίγο
- Μακριά
- ματιά
- μοιάζει
- Παρτίδα
- Χαμηλός
- Κυρίως
- κάνω
- ΚΑΝΕΙ
- διαχείριση
- διευθυντής
- διαχείριση
- Ταχύτητες
- χειροκίνητα
- κατασκευής
- πολοί
- χαρτης
- σημάδι
- αγορά
- Μάρκετινγκ
- υλικό
- υλικά
- ώριμος
- max-width
- μέσα
- μηχανικός
- μηχανισμούς
- Γνωρίστε
- συνάντηση
- Μνήμη
- που αναφέρθηκαν
- μέταλλο
- μέθοδος
- μέθοδοι
- Μετρολογία
- μικρόν
- μικρόφωνο
- ελάχιστο
- Κινητό
- παρακολούθηση
- περισσότερο
- ως επί το πλείστον
- μετακινήσετε
- κινήσεις
- πολύ
- πολλαπλών
- Φύση
- Ανάγκη
- που απαιτούνται
- ανάγκες
- Νέα
- Νέες τεχνολογίες
- επόμενη
- όμορφη
- Νικέλιο
- Όχι.
- Σημειώνεται
- τώρα
- αριθμός
- στόχοι
- of
- on
- μια φορά
- ONE
- ανοίξτε
- άνοιγμα
- χειριστής
- φορείς
- Ευκαιρίες
- αντίθετος
- or
- οργανικές
- αρχικά
- ΑΛΛΑ
- δικός μας
- έξω
- επί
- δική
- πακέτο
- Packages
- συσκευασία
- μπλοκ
- σελίδα
- Παράλληλο
- μέρος
- σωματίδιο
- passieren
- People
- Κορμός
- Πίσσα
- γήπεδα
- Μέρος
- Πλάτων
- Πληροφορία δεδομένων Plato
- Πλάτωνα δεδομένα
- Δοκιμάστε να παίξετε
- Σημείο
- φτωχός
- Δημοφιλής
- δημοφιλής επιλογή
- τοποθετημένες
- δυνατός
- Θέση
- δύναμη
- πρόεδρος
- πρωταρχικός
- Πριν
- διαδικασια μας
- Διεργασίες
- μεταποίηση
- Προϊόν
- διαχείριση προϊόντων
- παραγωγή
- Προϊόντα
- προβλέπεται
- ιδιότητες
- παρέχουν
- πίεσε
- βάζω
- ποιότητα
- κυμαίνεται
- αναλογία
- φθάνοντας
- πραγματικά
- λήψη
- μείωση
- Μειωμένος
- μειώνει
- Ανεξάρτητα
- σχετίζεται με
- αξιοπιστία
- εξάρτηση
- Καταργήθηκε
- απαιτούν
- απαιτείται
- Απαιτεί
- Αποτελέσματα
- Κίνδυνος
- οδικός χάρτης
- οδικούς χάρτες
- Ρόλος
- Δωμάτιο
- Διαδρομή
- δρομολόγηση
- κανόνες
- Είπε
- ίδιο
- δευτερεύων
- δείτε
- βλέποντας
- δει
- ημιαγωγός
- αρχαιότερος
- setup
- διάφοροι
- Shape
- αλλαγή
- Κοντά
- θα πρέπει να
- πλευρά
- Σήμα
- Πυρίτιο
- παρόμοιες
- Ομοίως
- αφού
- ενιαίας
- Μέγεθος
- μεγέθη
- Διαφάνειες
- ελαφρώς διαφορετική
- μικρότερος
- So
- Λύσεις
- μερικοί
- κάτι
- Σύντομα
- Πηγή
- Πηγές
- Χώρος
- συγκεκριμένες
- ειδικά
- πρότυπο
- Εκκίνηση
- Ξεκινήστε
- Βήματα
- κολλάει
- Ακόμη
- ιστορίες
- στρες
- μελέτες
- επιτυχής
- τέτοιος
- υποστήριξη
- Επιφάνεια
- SVG
- τραπέζι
- Πάρτε
- στόχος
- Τεχνολογίες
- Τεχνολογία
- όρος
- Δοκιμές
- από
- ότι
- Η
- Το τοπίο
- τους
- Τους
- θέμα
- τότε
- Εκεί.
- επομένως
- θερμικός
- Αυτοί
- αυτοί
- πράγματα
- Σκέψη
- αυτό
- εκείνοι
- αν και?
- σφικτά
- ώρα
- τύπος
- προς την
- σήμερα
- μαζι
- εργαλείο
- εργαλεία
- κορυφή
- ίχνος
- έλξη
- παραδοσιακός
- προσπαθώ
- ΣΤΡΟΦΗ
- δύο
- τύπος
- τύποι
- συνήθως
- υπό
- επάνω σε
- χρήση
- μεταχειρισμένος
- χρησιμοποιώντας
- συνήθως
- χρησιμοποιώ
- ποικιλία
- πολύ
- Vice President
- Δες
- ακύρωση
- ήταν
- we
- ΛΟΙΠΌΝ
- πότε
- Ποιό
- άσπρο
- ολόκληρο
- διαδεδομένη
- Wikipedia
- θα
- με
- χωρίς
- Εργασία
- εργαζόμενος
- λειτουργεί
- κόσμος
- X
- ακτινογραφία
- Βελτιστοποίηση
- αποδόσεις
- εσείς
- Σας
- zephyrnet











